虽然在商用化学气相沉积设备中可以在一次运行中实现多片4H-SiC衬底的同质外延生长,但是必须将晶片装载到可旋转的大型基座上,这导致基座的直径随着数量或者外延晶片总面积的增加而增加。在这项工作中,我们展示了一种简便的方法,通过自制的常规单晶片化学气相沉积设备,在没有大型基座的情况下,在简单的支架上放置多片4H-SiC衬底。
本文中通过光学显微镜,AFM,SEM和拉曼光谱研究了在每个晶片上获得的4H-Si薄膜的结构性质。结果表明,在每个晶片的内部区域可以获得高质量的同质外延生长4H-SiC薄膜;而在外部区域,由于受到简单支架的机械部件影响,质量下降。最后,我们利用晶片支架进一步减少了不利的外部区域,展示出整个晶圆的同质外延生长,从而大大提高了生产效率,降低了能耗。
图1:(a)CVD室和(b)带有晶片的特定支架,(c)生长过程的示意图
我们在自制的低压化学气相沉积反应器中进行了4H-SiC同质外延生长。CVD反应器具有垂直的热壁室。 图1(a)显示了腔室的示意图。图1(b)显示了装有晶片的特定晶片夹持器。在图1(b)中,我们固定了三片4H-SiC衬底。槽之间的距离(d),典型值为1 cm,可根据实际情况定制。生长过程如图1(c)所示。在生长之前,将晶片在20kPa和1400℃下进行H2蚀刻处理30分钟,以消除污染和衬底表面损伤。外延生长在10kPa和1600℃下进行60分钟。SiH4和C2H4的流速分别为20sccm和12sccm。生长后,通过光学显微镜,AFM,SEM和拉曼光谱表征样品。
图2:(a)在20kPa和1400℃下蚀刻30分钟的衬底表面的光学图像,(b) - (d)分别在10kPa, 1600℃ 下生长60分钟外延晶片1,2和3的表面的光学图像。
4H-SiC薄膜内部区域的典型形态如图2所示。图2(a)显示了在外延之前用于比较的H2蚀刻的衬底的图像。图2(b) - (d)表明外延晶片1,2和3的表面都显示出明显的台阶。据报道,外延生长期间邻近的4H-SiC表面上的台阶形成是由表面动力学和能量学之间的相互作用引起的。我们可以看到图2(b)和(c)中的台阶宽度小于图2(d)中的台阶宽度。
图3:(a)晶片1,(b)晶片2和(c)晶片3的外延表面的AFM图像,(d)晶片3的表面台阶轮廓图,(e)表面台阶阶距示意图
外延层的表面形态也通过AFM进行了测量(图3)。 AFM图像进一步证实了图2中观察到的明显台阶。在4H-SiC薄膜中的存在两种调节。一种台阶小且均匀,密集地填充在外延晶片1和晶片2的表面上(图3(a)和(b))。 这是同质外延4H-SiC薄膜的典型形态。 另一种台阶是复合的,由所谓的双山谷结构组成(图3(c)和(d))。 该结构包括高巨台阶1和低巨台阶2(图3(e))。尽管AFM形态各不相同,但宏观台阶结构都是由于台阶阶距造成的。
图4:外延晶片上的生长速率分布。 左侧插图:晶片3的横截面SEM图,右侧插图:厚度测量的所选位置的示意图。
图4显示了外延晶片上的生长速率及其分布。选择每个晶片上的九个位置进行厚度测量。结果表明外延晶片1和2的生长速率与晶片3的生长速率很不相同。晶片1和晶片2的生长速率非常相似,约为14μm/ h,仅是晶片3的40%。图4左图显示了晶片3的横截面SEM图像。测量的厚度为约37μm。这主要是因为这两个晶片被限制在其顶部晶片而使晶片1和晶片2受到较少的气流。相比之下,装载在晶片夹持器顶部的晶片3受到充分气流的作用而没有任何限制。由此,晶片1和晶片2的中心区域的生长速率最慢,因为气流最不可能到达。
图5:在晶片3上生长的外延层的拉曼光谱
我们对晶片3上生长的外延层进行了拉曼光谱测试(图5)。图中显示的所有拉曼峰均为是4H-SiC的峰,这意味着在我们的外延生长中具有优异的4H单型体稳定性。此外,在低波数(<700 cm-1)的峰也有出现(图5插图),这进一步表明4H-SiC外延层是高质量结晶的。
-
SiC
+关注
关注
32文章
3504浏览量
68136 -
碳化硅
+关注
关注
25文章
3309浏览量
51715
发布评论请先 登录
半导体“化学气相沉积(CVD)碳化硅(Sic)”工艺技术详解;

基于传输线法TLM与隔离层优化的4H-SiC特定接触电阻SCR精准表征

【新启航】碳化硅外延片 TTV 厚度与生长工艺参数的关联性研究

应力消除外延生长装置及外延生长方法

提高SiC外延生长速率和品质的方法
钟罩式热壁碳化硅高温外延片生长装置






 基于简单的支架多片4H-SiC化学气相沉积同质外延生长
基于简单的支架多片4H-SiC化学气相沉积同质外延生长



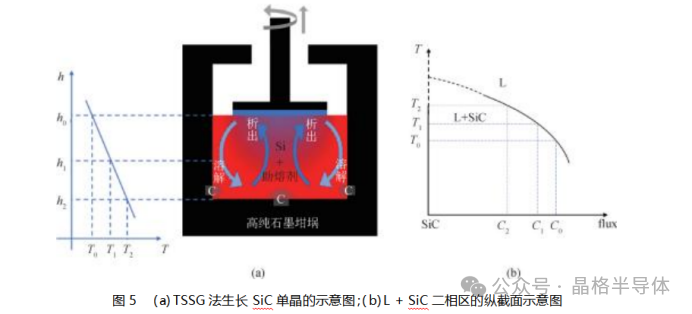











评论