在AI、HPC的催化下,先进封装拥有更小I/O间距和更高密度的RDL线间距。全球大厂无不更新迭代更先进的制造设备以实现更密集的I/O接口和更精密的电气连接,设计更高集成、更高性能和更低功耗的产品,从而锁定更多的市场份额。
2024-03-19 14:09:12 98
98 
任务要求:
了解微电子封装中的引线键合工艺,学习金丝引线键合原理,开发引线键合工艺仿真方法,通过数据统计分析和仿真结果,分析得出引线键合工序关键工艺参数和参数窗口,并给出工艺参数和键合质量之间的关系
2024-03-10 14:14:51
共读好书 王强翔 李文涛 苗国策 吴思宇 (南京国博电子股份有限公司) 摘要: 本文重点研究了金属陶瓷功率管胶黏剂封装工艺中胶黏剂的固化温度、时间、压力等主要工艺参数对黏结效果的影响。通过温度循环
2024-03-05 08:40:35 66
66 
RDL 技术是先进封装异质集成的基础,广泛应用扇出封装、扇出基板上芯片、扇出层叠封装、硅光子学和 2.5D/3D 集成方法,实现了更小、更快和更高效的芯片设计。
2024-03-01 13:59:05 362
362 
半导体工艺主要是应用微细加工技术、膜技术,把芯片及其他要素在各个区域中充分连接,如:基板、框架等区域中,有利于引出接线端子,通过可塑性绝缘介质后灌封固定,使其形成一个整体,以立体结构方式呈现,最终形成半导体封装工艺。
2024-03-01 10:30:17 130
130 
共读好书 张鎏 苑明星 杨小渝 (重庆市声光电有限公司) 摘 要: 对半导体封装工艺的研究,先探析半导体工艺概述,能对其工作原理有一定的了解与掌握;再考虑半导体封装工艺流程,目的是在作业阶段严谨
2024-02-25 11:58:10 275
275 
密性等。本文介绍了五种用于MEMS封装的封帽工艺技术,即平行缝焊、钎焊、激光焊接、超声焊接和胶粘封帽。总结了不同封帽工艺的特点以及不同MEMS器件对封帽工艺的选择。本文还介绍了几种常用的吸附剂类型,针对吸附剂易于饱和问题,给出了封帽工艺解决方案,探
2024-02-25 08:39:28 171
171 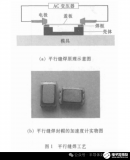
今天我们聊聊半导体产品的封装工艺,一提到“封装”,大家不难就会想到“包装”,但是,封装可不能简单的就认为等同于包装的哦
2024-02-23 14:42:34 437
437 
图1显示了半导体封装设计工艺的各项工作内容。首先,封装设计需要芯片设计部门提供关键信息,包括芯片焊盘(Chip Pad)坐标、芯片布局和封装互连数据。
2024-02-22 14:18:53 400
400 
level package),2.5D封装(interposer,RDL等),3D封装(TSV)等先进封装技术。 审核编辑 黄宇
2024-02-21 10:34:20 176
176 
LGA和BGA是两种常见的封装工艺,它们在集成电路封装中起着重要的作用。
2024-01-24 18:10:55 712
712 在本文中,我们将重点介绍半导体封装的另一种主要方法——晶圆级封装(WLP)。本文将探讨晶圆级封装的五项基本工艺,包括:光刻(Photolithography)工艺、溅射(Sputtering)工艺
2024-01-24 09:39:09 335
335 
共读好书 李志强 胡玉华 张岩 翟世杰 (中国电子科技集团公司第五十五研究所) 摘要: 选取了一种半烧结型银浆进行粘接工艺研究,通过剪切强度测试和空洞率检测确定了合适的点胶工艺参数,并进行了红外
2024-01-17 18:09:11 185
185 
半导体芯片在作为产品发布之前要经过测试以筛选出有缺陷的产品。每个芯片必须通过的 “封装”工艺才能成为完美的半导体产品。封装主要作用是电气连接和保护半导体芯片免受元件影响。
2024-01-17 10:28:47 250
250 
在晶圆制作完成后,会出货给封装厂,封装厂再将一粒粒的芯片封装起来。我这里所说的传统封装是指以打线为主的封装方式,比如DIP,QFP,SOP,QFN等,不包括倒装。这里就简单介绍一下传统封装的工艺流程及工艺特点。
2024-01-05 09:56:11 630
630 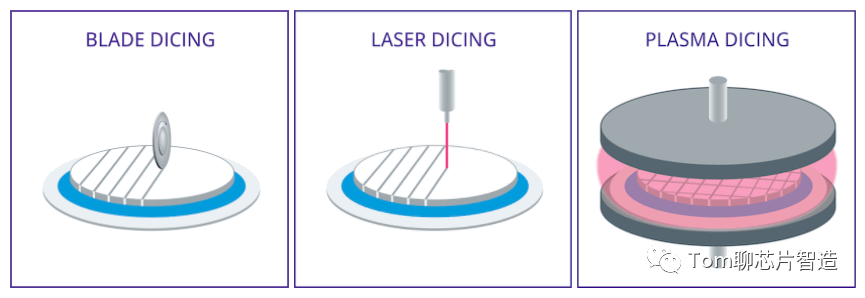
LED显示屏行业发展至今,已经出现过多种生产封装工艺,小间距市场目前以SMT贴片技术为主,在微间距市场,COB封装技术凭借更高像素密度,更精密的显示效果,越来越获得市场认可。
2023-12-27 09:46:21 828
828 为了让BGA焊料球固定在PCB上,PoP通常可以采用普通印刷工艺将锡膏转移到PCB上形成薄薄的锡膏点,然后再将底层封装的焊料球对应贴装到锡膏点上。在PCB上的BGA称为下层BGA,而连接上层与下层
2023-12-25 09:57:17 276
276 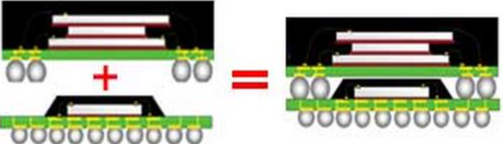
层、互连插座或柔性电路板与母板连结起来,形成三维立体封装,构成完整的整机系统,这一级封装应包括连接器、迭层组装和柔性电路板等相关材料、设计和组装技术。这一级也称系统级封装。所谓微电子封装是个整体的概念
2023-12-11 01:02:56
随着摩尔定律逐步达到极限,大量行业巨头暂停了 7 nm 以下工艺的研发,转而将目光投向先进封装领域。其中再布线先行( RDL-first ) 工艺作为先进封装技术的重要组成部分,因其具备
2023-12-07 11:33:44 723
723 
如之前的介绍用于 IC 封装的再分布层(RDL)技术及晶圆级封装中的窄间距RDL技术及应用]技术通常用于芯片封装中的信号和电源引脚映射,用于实现芯片与封装之间的连接。然而,对于高功率应用,尤其是需要传输大电流或高功率的电路,额外的考虑和技术措施是必要的。
2023-12-06 18:26:46 1266
1266 
上篇文章提到用于 IC 封装的再分布层(RDL)技术Redistribution layer, RDL 的基本概念是将 I/O 焊盘的位置分配到芯片的其他位置,即用RDL转接到锡球焊接的着陆焊盘位置。
2023-12-06 18:19:48 2746
2746 
Redistribution layer (再分布层,RDL),是添加到集成电路或微芯片中以重新分配电气连接的金属层。这种RDL技术是一种用于集成电路(IC)的先进封装解决方案,允许将多个芯片集成
2023-12-06 18:18:29 3806
3806 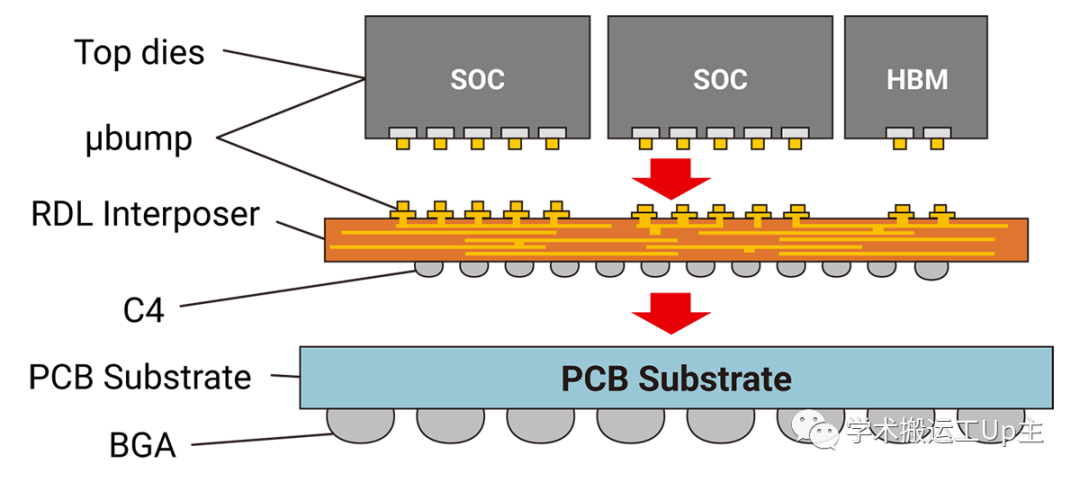
摘要:选取了一种半烧结型银浆进行粘接工艺研究,通过剪切强度测试和空洞率检测确定了合适的点胶工艺参数,并进行了红外热阻测试和可靠性测试。结果表明,该半烧结型银浆的工艺操作性好,烧结后胶层空洞
2023-12-04 08:09:57 446
446 
在邮寄易碎物品时,使用合适的包装材料尤为重要,因为它确保包裹能够完好无损地到达目的地。泡沫塑料、气泡膜和坚固的盒子都可以有效地保护包裹内的物品。同样地,封装是半导体制造工艺的关键环节,可以保护芯片
2023-12-02 08:10:57 347
347 
在晶圆生产工艺的结尾,有些晶圆需要被减薄(晶圆减薄)才能装进特定的封装体重,以及去除背面损伤或结;对于有将芯片用金-硅共晶封装中的芯片背面要求镀一层金(背面金属化,简称背金);
2023-11-29 12:31:26 203
203 
网线线缆直连线和交叉线的区别 网线线缆是计算机网络中连接设备的电缆,用于传输数据和信号。在网络中,有两种常见的网线线缆,即直连线和交叉线。直连线和交叉线在连接设备时有不同的用途和效果。在本文
2023-11-28 15:22:14 1824
1824 扇出型封装一般是指,晶圆级/面板级封装情境下,封装面积与die不一样,且不需要基板的封装,也就是我们常说的FOWLP/FOPLP。扇出型封装的核心要素就是芯片上的RDL重布线层(可参考下面图表说明
2023-11-27 16:02:01 2453
2453 
IGBT模块的封装技术难度高,高可靠性设计和封装工艺控制是其技术难点。
2023-11-21 15:49:45 673
673 
晶圆承载系统是指针对晶圆背面减薄进行进一步加工的系统,该工艺一般在背面研磨前使用。晶圆承载系统工序涉及两个步骤:首先是载片键合,需将被用于硅通孔封装的晶圆贴附于载片上;其次是载片脱粘,即在如晶圆背面凸点制作等流程完工后,将载片分离。
2023-11-13 14:02:49 1410
1410 
芯片的封装工艺始于将晶圆分离成单个的芯片。划片有两种方法:划片分离或锯片分离。
2023-11-09 14:15:38 462
462 在上篇文章中介绍了扇入型晶圆级芯片封装(Fan-In WLCSP)、扇出型晶圆级芯片封装(Fan-Out WLCSP)、重新分配层(RDL)封装、倒片(Flip Chip)封装,这篇文章着重介绍硅通孔(TSV)封装工艺。
2023-11-08 10:05:53 1826
1826 
)、重新分配层(RDL)封装、倒片(Flip Chip)封装、及硅通孔(TSV)封装。此外,本文还将介绍应用于这些晶圆级封装的各项工艺,包括光刻(Photolithography)工艺、溅射(Sputtering)工艺、电镀(Electroplating)工艺和湿法(Wet)工艺。
2023-11-08 09:20:19 2753
2753 
电子发烧友网站提供《太阳能电池晶体硅光伏组件封装浅析(工艺控制篇).doc》资料免费下载
2023-11-03 10:21:41 1
1 半导体产品在由二维向三维发展,从技术发展方向半导体产品出现了系统级封装(SiP)等新的封装方式,从技术实现方法出现了倒装(FlipChip),凸块(Bumping),晶圆级封装(Waferlevelpackage),2.5D封装(interposer,RDL等),3D封装(TSV)等先进封装技术。
2023-10-31 09:16:29 836
836 
AuSn焊料是一种常用于封装微电子器件的材料,其低温焊接特性使其在对敏感器件和高温敏感材料的封装中备受欢迎。本文旨在探讨AuSn焊料在低温真空封装工艺中的应用,以及该工艺的研究进展和应用前景。
2023-10-30 14:32:39 720
720 
SOM-3588-LGA 是一款基于Rockchip RK3588芯片平台,采用LGA(506pin)封装设计的一款极小尺寸的商规级核心板。现在核心板 SOM-3588-LGA(商业级
2023-10-23 11:50:30
各种电子元器件,所以这使得SMT组装贴片加工显得尤为重要。
电子产品各式各样,PCB板种类众多,SMT贴片加工也需不同的工艺流程,才能应对各种PCB板的组装,本篇为大家介绍各种PCB板SMT组装工艺
2023-10-20 10:33:59
各种电子元器件,所以这使得SMT组装贴片加工显得尤为重要。
电子产品各式各样,PCB板种类众多,SMT贴片加工也需不同的工艺流程,才能应对各种PCB板的组装,本篇为大家介绍各种PCB板SMT组装工艺
2023-10-20 10:31:48
由钛、铜和镍组成,则钛层作为黏附层,铜层作为载流层,镍层作为阻挡层。因此,UBM对确保倒片封装的质量及可靠性十分重要。在RDL和WLCSP等封装工艺中,金属层的作用主要是形成金属引线,因此通常由可提高粘性的黏附层及载流层构成。
2023-10-20 09:42:21 2737
2737 
晶圆级封装是指晶圆切割前的工艺。晶圆级封装分为扇入型晶圆级芯片封装(Fan-In WLCSP)和扇出型晶圆级芯片封装(Fan-Out WLCSP),其特点是在整个封装过程中,晶圆始终保持完整。
2023-10-18 09:31:05 1339
1339 
安装各种电子元器件,所以这使得SMT组装贴片加工显得尤为重要。
电子产品各式各样,PCB板种类众多,SMT贴片加工也需不同的工艺流程,才能应对各种PCB板的组装,本篇为大家介绍各种PCB板SMT组装工艺
2023-10-17 18:10:08
在上篇文章中我们讲述了传统封装方法组装工艺的其中四个步骤,这回继续介绍剩下的四个步骤吧~
2023-10-17 14:33:22 471
471 
图1显示了塑料封装的组装工艺,塑料封装是一种传统封装方法,分为引线框架封装(Leadframe Package)和基板封装(Substrate Package)。这两种封装工艺的前半部分流程相同,而后半部分流程则在引脚连接方式上存在差异。
2023-10-17 14:28:56 743
743 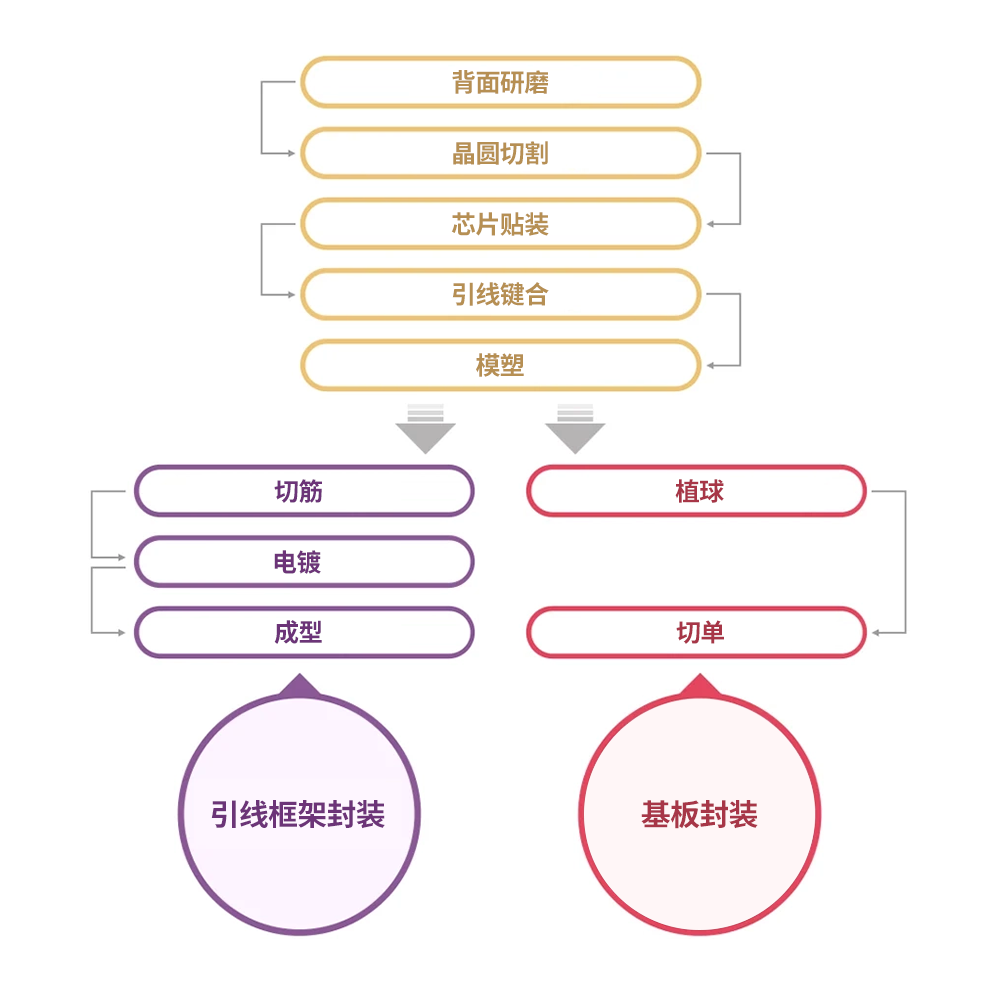
此时先进封装开始崭露头角,以苹果和台积电为代表,开启了一场新的革命,其主要分为两大类,一种是基于XY平面延伸的先进封装技术,主要通过RDL进行信号的延伸和互连;第二种则是基于Z轴延伸的先进封装技术,主要通过TSV进行信号延伸和互连。
2023-10-10 17:04:30 573
573 
半导体封装技术的发展一直都是电子行业持续创新的重要驱动力。随着集成电路技术的发展,半导体封装技术也经历了从基础的封装到高密度、高性能的封装的演变。本文将介绍半导体封装工艺的四个等级,以助读者更好地理解这一关键技术。
2023-10-09 09:31:55 933
933 
先进封装技术以SiP、WLP、2.5D/3D为三大发展重点。先进封装核心技术包括Bumping凸点、RDL重布线、硅中介层和TSV通孔等,依托这些技术的组合各厂商发展出了满足多样化需求的封装解决方案,SiP系统级封装、WLP晶圆级封装、2.5D/3D封装为三大发展重点。
2023-09-28 15:29:37 1613
1613 
扇出型晶圆级封装技术采取在芯片尺寸以外的区域做I/O接点的布线设计,提高I/O接点数量。采用RDL工艺让芯片可以使用的布线区域增加,充分利用到芯片的有效面积,达到降低成本的目的。扇出型封装技术完成芯片锡球连接后,不需要使用封装载板便可直接焊接在印刷线路板上,这样可以缩短信号传输距离,提高电学性能。
2023-09-25 09:38:05 756
756 
为什么电路带宽不能设计成无穷大? 电路带宽是指电路本身能够传输的最大频率范围。在现代通信和计算机应用领域,带宽是至关重要的,因为它直接影响着信息传输和处理的速度。然而,虽然我们通常希望电路带宽
2023-09-20 16:43:25 397
397 本技术笔记为采用 HLGA 表面贴装封装的 MEMS 传感器产品提供 PCB设计和焊接工艺的通用指南。
2023-09-13 08:03:50
有偿求RDL布线图
2023-09-10 09:42:42
近年来,半导体封装变得越发复杂,更加强调设计的重要性。半导体封装设计工艺需要各类工程师和业内人士的共同参与,以共享材料信息、开展可行性测试、并优化封装特性。
2023-09-01 10:38:39 274
274 
是指过孔焊盘盖上油墨,焊盘上面没有锡,大部分电路板采用此工艺。过孔盖油设计的孔径不建议大于0.5mm,孔径过大孔内集油墨有一定的品质隐患。过孔盖油在PCB设计文件转成Gerber光绘文件时,需取消过孔
2023-09-01 09:51:11
随着汽车工业向电动化、智能化方向发展,车载电子系统在汽车中的比重逐年增加,而芯片封装则是其中的关键环节。本文将带您深入了解汽车芯片的封装工艺,解析其背后的技术细节。
2023-08-28 09:16:48 984
984 
pcb连线寄生电容一般多少 随着电子产品制造技术的成熟和发展,随之而来的是布线技术的迅速发展。不同的 PCB 布线技术对于电路性能的影响不同,而其中最常见的问题之一就是 PCB 连线寄生电容。这种
2023-08-27 16:19:44 1604
1604 英集芯IP2189 全集成旅充协议芯片 民信微英集芯IP2189全集成旅充协议是市场上性价比最高的协议芯片,采用SOP8封装设计,全集成可任意搭配前级电源芯片即可,支持20WPD方案
2023-08-26 21:06:36
封装技术是一种将芯片与承载基板连接固定、引出管脚并将其塑封成整体功率器件或模块的工艺,主要起到电气连接、结构支持和保护、提供散热途径等作用[4]。封装作为模块集成的核心环节,封装材料、工艺和结构直接影响到功率模块的热、电和电磁干扰等特性。
2023-08-24 11:31:34 1050
1050 
级负载使用。此外,英集芯IP6832内置32-bit MCU和丰富的外设资源,可省去外置MCU,为产品开发提供方便。民信微该芯片采用QFN24(4mm*4mm)封
2023-08-22 21:08:22
(Waferlevelpackage),2.5D封装(interposer,RDL等),3D封装(TSV)等先进封装技术。免责声明:本文转自网络,版权归原作者所有,如涉及作品版权问题,
2023-08-14 09:59:24 457
457 
先进封装处于晶圆制造与封测的交叉区域 先进封装处于晶圆制造与封测制程中的交叉区域,涉及IDM、晶圆代工、封测厂商。先进封装要求在晶圆划片前融入封装工艺步骤,具体包括应用晶圆研磨薄化、重布线(RDL
2023-08-07 10:59:46 852
852 
level package),2.5D封装(interposer,RDL等),3D封装(TSV)等先进封装技术。
2023-08-05 09:54:29 398
398 
电子封装技术与器件的硬件结构有关。这些硬件结构包括有源元件1(如半导体)和无源元件2(如电阻器和电容器3)。因此,电子封装技术涵盖的范围较广,可分为0级封装到3级封装等四个不同等级。图1展示了半导体封装工艺的整个流程。
2023-08-01 16:45:03 576
576 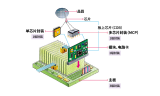
2D增强型(2.1D–2.5D)是晶圆级集成(也包括3D),采用有机基板,包括在有机中介层/再分配层(RDL)上集成管芯,并封装在一体化基板上;另一种是硅基,是在硅中介层或硅桥上集成管芯,并封装在一体化基板上。
2023-07-31 15:17:06 740
740 
进行底部填充、角部粘接(cornerbond)或边部粘接。相对于标准的CSP/BGA工艺,堆叠工艺由于需要对多层封装同时进行点胶操作,因此将面对更多的挑战。对于Po
2023-07-24 16:14:45 544
544 
电机的制造过程中,电机壳体封装是一个非常重要的环节,它不仅能够保护电机的内部部件,还能够提高电机的性能和使用寿命。因此,电机壳体封装工艺的研究对于电机制造业的发展具有重要的意义。目前,国内外关于电机壳体封装工艺的研究已经取得了一定的进展。
2023-07-21 17:15:32 439
439 is connected to substrate by RDL and Bump芯片通过RDL和凸点连接到基板
▼Bump material type: solder, gold凸点材料类型:焊料、金线
2023-07-15 11:09:52 1053
1053 
半导体后封装工艺及设备介绍
2023-07-13 11:43:20 8
8 对于MiniLED和MicroLED的封装技术,除了之前提到的COB、coG、coF、IMD和MiP工艺,还有一些新的封装技术,例如:0CRL(Oxide-BufferedCuInGaZn/Quar
2023-07-06 16:00:52 401
401 
从封装的角度来看,要提高带宽,需要考虑两个关键因素:I/O(输入/输出)总数和每个I/O的比特率。增加I/O总数需要在每个布线层/再分布层(RDL)中实现更精细的线宽/间距(L/S),并具有更高数量
2023-07-05 10:52:23 414
414 
随着三维集成技术的发展,如何将不同材料、结构、工艺、功能的芯片器件实现一体化、多功能集成化是未来系统集成发展的重点。基于TSV、再布线(RDL)、微凸点(Micro Bump)、倒装焊(FC)等关键工艺的硅转接基板集成技术是将处理器、存储器等多种芯片集成到同一个基板上,可提供高密度引脚的再分布。
2023-07-01 10:35:21 1396
1396 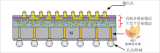
“封装工艺(Encapsulation Process)”用于进行包装密封,是指用某种材料包裹半导体芯片以保护其免受外部环境影响,这一步骤同时也是为保护物件所具有的“轻、薄、短、小”特征而设计。封装工艺
2023-06-26 09:24:36 4612
4612 
IGBT 功率模块基本的封装工艺详细讲解,可以作为工艺工程师的一个参考和指导。
丝网印刷目的:
将锡膏按设定图形印刷于DBC铜板表面,为自动贴片做好前期准备
设备:
BS1300半自动对位SMT锡浆丝印机
2023-06-19 17:06:41 0
0 【视频】紫光同创Logos系列PGL50H关键特性评估板@盘古50K开发板#小眼睛FPGA盘古系列开发板@集创赛官方定制 基于紫光同创40nm工艺的FPGA(Logos系列:PGL50H-6IFBG484)关键特性评估板~
2023-06-12 18:07:15
详解半导体封装测试工艺
2023-05-31 09:42:18 997
997 
自从Fan-Out封装问世以来,经过多年的技术发展,扇出式封装已经形成了多种封装流程、封装结构以适应不同产品需要,根据工艺流程,可以分为**先贴芯片后加工RDL的Chip First工艺
2023-05-19 09:39:15 773
773 
系统级封装 (System in Package, SiP)是指将单个或多个芯片与各类元件通过系统设计及特定的封装工艺集成于单一封装体或模块,从而实现具完整功能的电路集成,如图 7-115 所示
2023-05-10 16:54:32 826
826 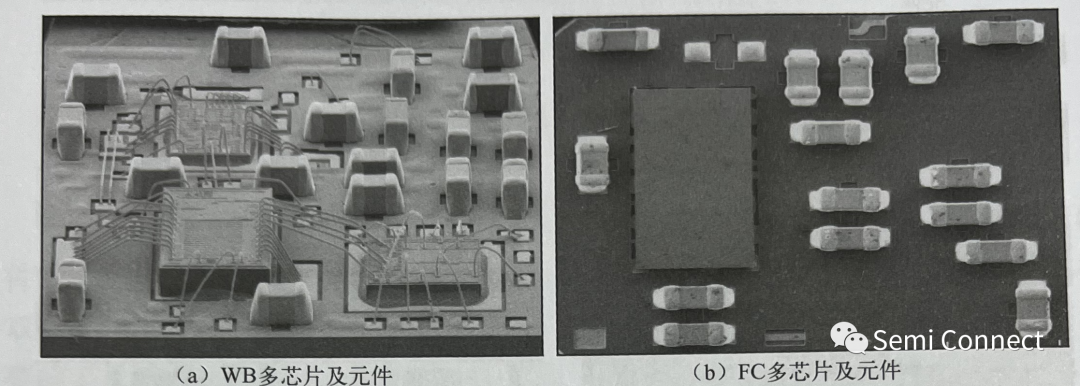
板级埋人式封装是一种在基板制造工艺的基础上融合芯片封装工艺及 SMT工艺的集成封装技术,既可以是单芯片封装、多芯片封装,也可以是模组封装、堆叠封装。与传统封装中在基板表面贴装芯片或元件不同,板级埋人式封装直接将芯片或元件嵌人基板中间,因此它具有更短的互连路径、更小的体积、更优的电热性能及更高的集成度。
2023-05-09 10:21:53 833
833 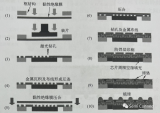
硅通孔(TSV) 是当前技术先进性最高的封装互连技术之一。基于 TSV 封装的核心工艺包括 TSV 制造、RDL/微凸点加工、衬底减薄、圆片键合与薄圆片拿持等。
2023-05-08 10:35:24 2024
2024 
MOS反相器的什么阻抗接近于无穷大呢?
2023-04-28 15:02:25
倒装芯片工艺是指通过在芯片的I/0 焊盘上直接沉积,或者通过 RDL 布线后沉积凸块(包括锡铅球、无铅锡球、铜桂凸点及金凸点等),然后将芯片翻转,进行加热,使熔融的焊料与基板或框架相结合,将芯片的 I/0 扇出成所需求的封装过程。倒装芯片封装产品示意图如图所示。
2023-04-28 09:51:34 3701
3701 
,设计师们必须保证所选用的器件封装形式能够 SMT 组装的工艺性要求相适应。
通常,制造商会对某些专用器件提供 BGA 印制板焊盘设计参数,于是设计师只能照搬使用没有完全成熟的技术。当 BGA
2023-04-25 18:13:15
一、PCB制造基本工艺及目前的制造水平
PCB设计最好不要超越目前厂家批量生产时所能达到的技术水平,否则无法加工或成本过高。
1.1层压多层板工艺
层压多层板工艺是目前广泛
2023-04-25 17:00:25
利。
工艺性设计要考虑:
a)自动化生产所需的传送边、定位孔、光学定位符号;
b)与生产效率有关的拼板;
c)与焊接合格率有关的元件封装选型、基板材质选择、组装方式、元件布局、焊盘设计、阻焊
2023-04-25 16:52:12
IBM 和三星开发了一种钌和气隙集成方案,解决了一个迫在眉睫的高互连线间距问题。
2023-04-25 11:15:01 1211
1211 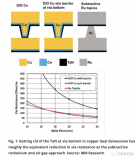
金属封装工艺是指采用金属外壳作为封装壳体或底座,在其内部安装芯片或基板并进行键合连接,外引线通过金属-玻璃(或陶瓷)组装工艺穿过金属外壳
2023-04-21 11:42:34 2376
2376 的工艺、技术、质量、成本优势。 2. 适用范围 本规范适用于所有电了产品的 PCB 工艺设计,运用于但不限于 PCB 的设计、 PCB 投板工艺审查、单板工艺审查等活动。 本规范之前的相关标准、规范
2023-04-20 10:39:35
微产品封装规格已近50种,品种超过7000个型号。在系统级封装领域,晶导微已攻克了不少核心技术,比如实现量产的反极性芯片制造工艺,掌握了高密度、低应力的IC框架设计以及专门针对多芯片引脚和PAD
2023-04-14 16:00:28
的发展和创新,为人类社会的科技进步和经济发展做出更大的贡献。 随着技术的进步,目前市场上出现了板级的封装,裸DIE通过凸点,直接通过TCB热压键合实现可靠性封装,是对BGA封装的一种升级,省去
2023-04-11 15:52:37
裸芯通过微凸点组装到Interposer上,如上图所示。其Interposer上堆叠了三颗裸芯。Interposer包括两种类型的互联:①由微凸点和Interposer顶部的RDL组成的水平互连,它连接各种裸芯②由微凸点、TSV簇和C4凸点组成的垂直互联,它将裸芯连接至封装。
2023-04-10 11:28:50 6410
6410 IP6862是一款英集芯全新推出的一芯双充无线充电方案,采用QFN32封装5*5MM可支持15W+15W/15W+5W版本,支持全新1芯双充无线充方案开发。科发鑫电子是英集芯一级代理商,提供全系列英
2023-04-07 18:45:16
网线接口在PCB板上该如何连线才使信号传输速度更快呢?
2023-04-07 17:35:45
DRAM栅工艺中,在多晶硅上使用钙金属硅化物以减少局部连线的电阻。这种金属硅化物和多晶硅的堆叠薄膜刻蚀需要增加一道工艺刻蚀W或WSi2,一般先使用氟元素刻蚀钧金属硅化合物层,然后再使用氯元素刻蚀多晶硅。
2023-04-07 09:48:16 2198
2198 划片工艺又称切割工艺,是指用不同的方法將单个芯片从圆片上分离出来,是封装中必不可少的工艺。
2023-04-04 16:15:58 2572
2572 集电级电流增大,负载电阻电压降增大,为何流过同样电流的E、C间电压降却要减小?
2023-03-30 11:32:42

 电子发烧友App
电子发烧友App















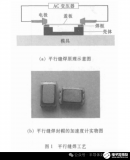






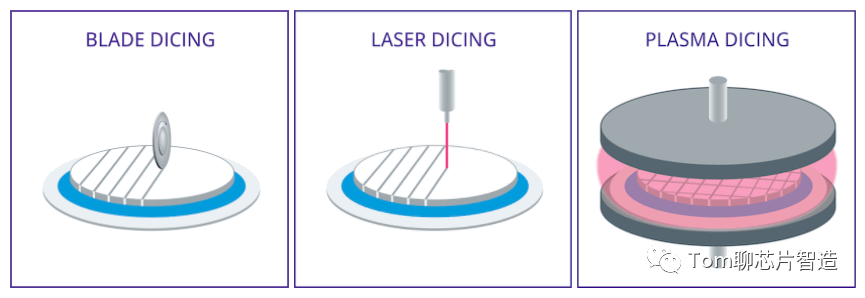
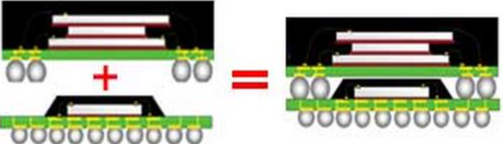



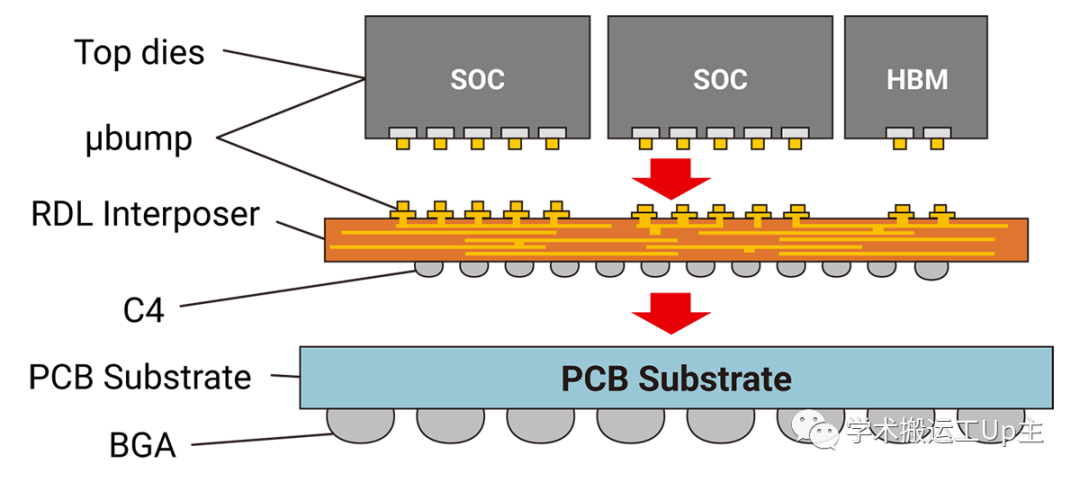














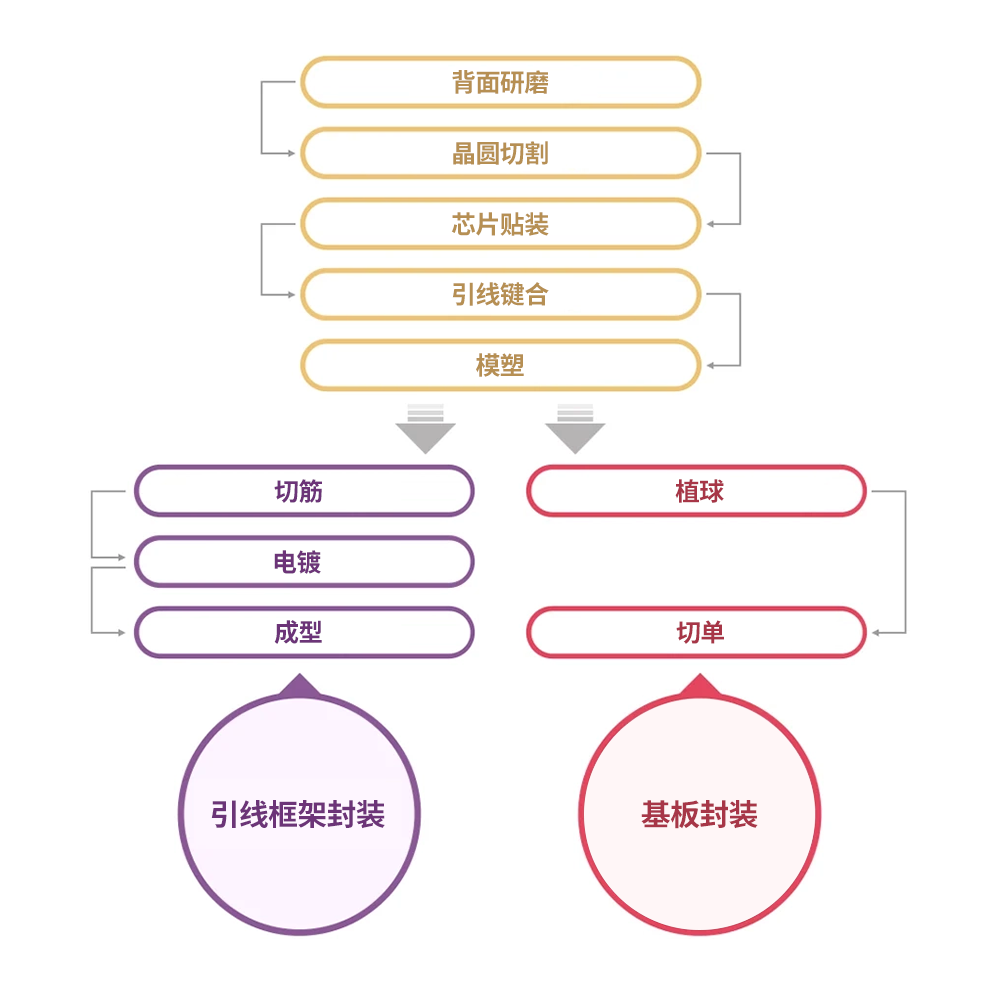










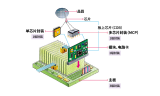





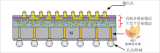




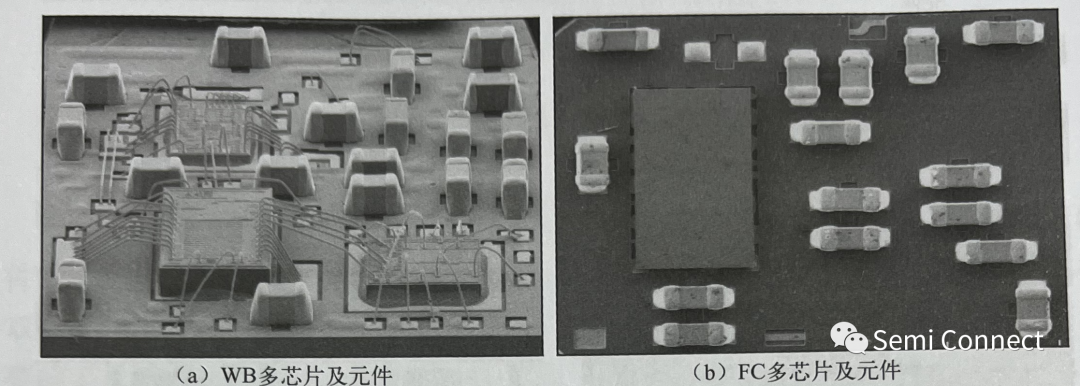
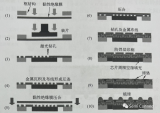


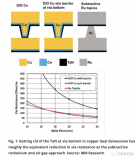










评论