2019年第一季全球晶圆代工总产值将较2018年同期衰退约16%,达146.2亿美元。其中市占率排名前三的分别为台积电、三星与格芯。尽管台积电市占率达48.1%,但第一季营收年成长率衰退近18%。
由于包含智能手机在内的大部分终端市场出现需求疲乏的现象,导致先进制程发展驱动力下滑,晶圆代工业者在2019年第一季就面临着相当严峻的挑战。

来源:拓墣产业研究院 单位:百万美元
2019年第一季晶圆代工业者排名与去年相比变化不大,仅力晶因12英寸代工需求下滑而面临被高塔半导体反超的风险。
观察前十大晶圆代工业者第一季的表现,包括台积电(TSMC)、三星(Samsung LSI)、格芯 (GLOBALFOUNDRIES)、联电(UMC)、中芯(SMIC)、力晶(Powerchip)等业者,因12英寸晶圆代工市场需求疲软,第一季营收表现较去年同期下滑幅度均来到两位数。
反观以8英寸晶圆代工为主要业务的高塔半导体(TowerJazz)、世界先进(Vanguard)、华虹半导体(Hua Hong)、东部高科(Dongbu HiTek)等业者,尽管8英寸晶圆代工产能供不应求的现象已渐舒缓,年成长率表现仍不如去年同期亮眼。但相较于以12英寸为主力的晶圆代工厂第一季两位数的衰退幅度,可以说其在半导体市场相对不景气的第一季中稳住阵脚。
市占率第一的台积电虽受到光阻液事件导致晶圆报废,重要智能手机客户销售不如预期以及加密货币热潮消退等影响,但在第一季依旧稳居晶圆代工产业的龙头宝座。
在2019年第一季度,三星电子在全球晶圆代工市场的份额增长了4个百分点,达到19.1%。
***台积电(TSMC)是半导体代工行业的领导者,今年第一季度的市场份额为48.1%。较去年下降2.7个百分点,是台积电自2012年45.6%以来的最低市场份额。另一方面,三星电子的市场份额在这三个月增加了4个百分点,达到19.1%。半导体市场正密切关注台积电(TSMC)的低迷。目前,三星电子(Samsung Electronics)正凭借其在极紫外(EUV)工艺方面的竞争优势,大力推进这一业务。
根据***市场研究公司TrendForce 3月27日的数据,这家***代工巨头在2019年第一季度的市场份额为48.1%,销售额为70亿美元。紧随其后的是三星电子(Samsung Electronics),收入28亿美元(19.1%),GlobalFoundries,收入12亿美元(8.4%),联华电子(UMC),收入11亿美元(7.2%),中芯国际(SMIC),收入6亿美元(4.5%)。由于智能手机行业的需求下降和加密货币市场的暴跌,排名较高的公司都遭遇了销售下滑,包括台积电(- 17.8%)和三星电子(- 14.4%)。
市场份额的变化是非常明显的。与去年年底相比,台积电的市场份额从50.8%降至48.1%,而三星电子的市场份额则从14.9%升至19.1%。2014年,台积电的市场份额为54%,2015年为52.7%,2016年为50.5%,2017年为49.7%,2018年为50.8%。除了2017年,该公司的市场份额在近几年一直保持在50%以上。尤其是2019年48.1%的市场份额是七年来最低的。
这一结果与三星电子(Samsung Electronics)加强非内存业务的积极举措有关。三星电子(Samsung Electronics)最近成功地向奥迪(Audi)供应了汽车用半导体,并向IBM供应了服务器用半导体。2017年,三星电子从系统大规模集成电路事业部剥离了晶圆代工业务团队。从那时起,它的客户开始多样化。
特别是7纳米(nm) EUV 被应用于供应给IBM的服务器芯片。三星电子和台积电目前都在使用浸入式氟化氩(ArF)设备生产7,8纳米产品。

半导体晶圆材料基本框架

硅晶圆尺寸与制程对应
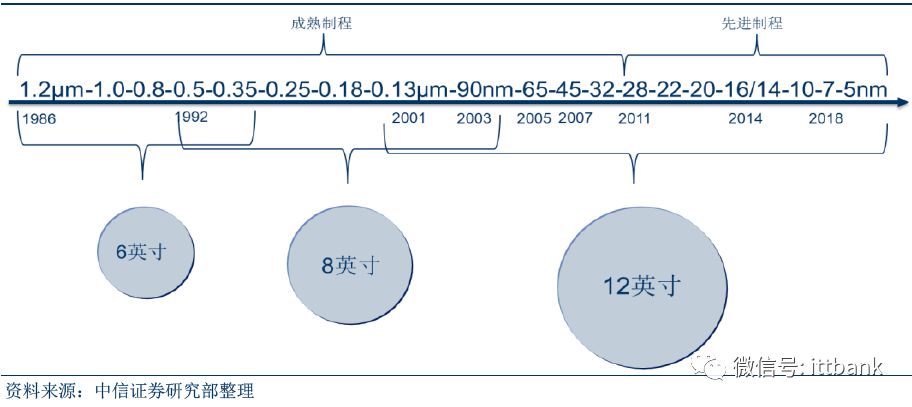
12 英寸、8 英寸、6 英寸晶圆需求结构

8 英寸晶圆需求结构

晶圆尺寸对应产品类型

制程-尺寸对应下游应用需求拆分

说明:12 英寸20nm 以下先进制程性能强劲,主要用于移动设备、高性能计算等领域,包括智能手机主芯片、计算机CPU、GPU、高性能FPGA、ASIC 等。14nm-32nm 先进制程应用于包括DRAM、NAND Flash 存储芯片、中低端处理器芯片、影像处理器、数字电视机顶盒等应用。12 英寸45-90nm 的成熟制程主要用于性能需求略低,对成本和生产效率要求高的领域,例如手机基带、WiFi、GPS、蓝牙、NFC、ZigBee、NORFlash 芯片、MCU 等。12 英寸或8 英寸90nm 至0.15μm 主要应用于MCU、指纹识别芯片、影像传感器、电源管理芯片、液晶驱动IC 等。8 英寸0.18μm-0.25μm 主要有非易失性存储如银行卡、sim 卡等,0.35μm 以上主要为MOSFET、IGBT 等功率器件。
晶圆材料演进
20 世纪50 年代,锗(Ge)是最早采用的半导体材料,最先用于分立器件中。集成电路的产生是半导体产业向前迈进的重要一步,1958 年7 月,在德克萨斯州达拉斯市的德州仪器公司,杰克·基尔比制造的第一块集成电路是采用一片锗半导体材料作为衬底制造的。
但是锗器件的耐高温和抗辐射性能存在短板,到60 年代后期逐渐被硅(Si)器件取代。硅储量极其丰富,提纯与结晶工艺成熟,并且氧化形成的二氧化硅(SiO2)薄膜绝缘性能好,使得器件的稳定性与可靠性大为提高,因而硅已经成为应用最广的一种半导体材料。
半导体器件产值来看,全球95%以上的半导体器件和99%以上的集成电路采用硅作为衬底材料。2017 年全球半导体市场规模约4122 亿美元,而化合物半导体市场规模约200亿美元,占比5%以内。从晶圆衬底市场规模看,2017 年硅衬底年销售额87 亿美元,GaAs衬底年销售额约8 亿美元。GaN 衬底年销售额约1 亿美元,SiC 衬底年销售额约3 亿美元。硅衬底销售额占比达85%+。在21 世纪,它的主导和核心地位仍不会动摇。但是Si 材料的物理性质限制了其在光电子和高频、高功率器件上的应用。
半导体市场份额(按材料)

资料来源:SIA,Yole,中信证券研究部测算
20 世纪90 年代以来,以砷化镓(GaAs)、磷化铟(InP)为代表的第二代半导体材料开始崭露头脚。GaAs、InP 等材料适用于制作高速、高频、大功率以及发光电子器件,是制作高性能微波、毫米波器件及发光器件的优良材料,广泛应用于卫星通讯、移动通讯、光通信、GPS 导航等领域。但是GaAs、InP 材料资源稀缺,价格昂贵,并且还有毒性,能污染环境,InP 甚至被认为是可疑致癌物质,这些缺点使得第二代半导体材料的应用具有很大的局限性。
第三代半导体材料主要包括SiC、GaN 等,因其禁带宽度(Eg)大于或等于2.3 电子伏特(eV),又被称为宽禁带半导体材料。和第一代、第二代半导体材料相比,第三代半导体材料具有高热导率、高击穿场强、高饱和电子漂移速率和高键合能等优点,可以满足现代电子技术对高温、高功率、高压、高频以及抗辐射等恶劣条件的新要求,是半导体材料领域最有前景的材料,在国防、航空、航天、石油勘探、光存储等领域有着重要应用前景,在宽带通讯、太阳能、汽车制造、半导体照明、智能电网等众多战略行业可以降低50%以上的能量损失,最高可以使装备体积减小75%以上,对人类科技的发展具有里程碑的意义。
晶圆材料性质比较
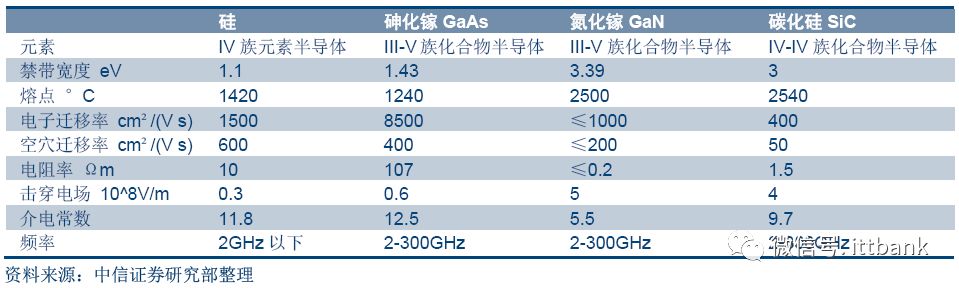
化合物半导体是指两种或两种以上元素形成的半导体材料,第二代、第三代半导体多属于这一类。按照元素数量可以分为二元化合物、三元化合物、四元化合物等等,二元化合物半导体按照组成元素在化学元素周期表中的位置还可分为III-V 族、IV-IV 族、II-VI 族等。以砷化镓(GaAs)、氮化镓(GaN)、碳化硅(SiC)为代表的化合物半导体材料已经成为继硅之后发展最快、应用最广、产量最大的半导体材料。化合物半导体材料具有优越的性能和能带结构:(1)高电子迁移率;(2)高频率特性;(3)宽幅频宽;(4)高线性度;(5)高功率;(6)材料选择多元性;(7)抗辐射。因而化合物半导体多用于射频器件、光电器件、功率器件等制造,具有很大发展潜力;硅器件则多用于逻辑器件、存储器等,相互之间具有不可替代性。
化合物半导体材料
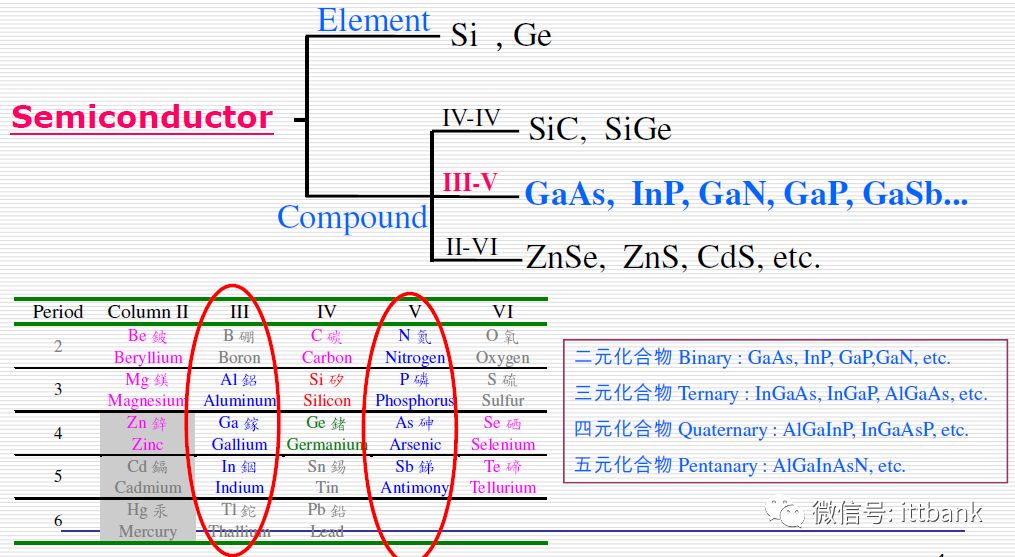
资料来源:全新光电,中信证券研究部
晶圆制备:衬底与外延工艺
晶圆制备包括衬底制备和外延工艺两大环节。衬底(substrate)是由半导体单晶材料制造而成的晶圆片,衬底可以直接进入晶圆制造环节生产半导体器件,也可以进行外延工艺加工生产外延片。外延(epitaxy)是指在单晶衬底上生长一层新单晶的过程,新单晶可以与衬底为同一材料,也可以是不同材料。外延可以生产种类更多的材料,使得器件设计有了更多选择。
衬底制备的基本步骤如下:半导体多晶材料首先经过提纯、掺杂和拉制等工序制得单晶材料,以硅为例,硅砂首先提炼还原为纯度约98%的冶金级粗硅,再经多次提纯,得到电子级高纯度多晶硅(纯度达99.9999999%以上,9~11 个9),经过熔炉拉制得到单晶硅棒。单晶材料经过机械加工、化学处理、表面抛光和质量检测,获得符合一定标准(厚度、晶向、平整度、平行度和损伤层)的单晶抛光薄片。抛光目的是进一步去除加工表面残留的损伤层,抛光片可直接用于制作器件,也可作为外延的衬底材料。
衬底制备的基本步骤

资料来源:中信证券研究部整理
外延生长工艺目前业界主要包括MOCVD(化学气相沉淀)技术以及MBE(分子束外延)技术两种。例如,全新光电采用MOCVD,英特磊采用MBE 技术。相比之下,MOCVD技术生长速率更快,更适合产业化大规模生产,而MBE 技术在部分情况如PHEMT 结构、Sb 化合物半导体的生产中更适合采用。HVPE(氢化物气相外延)技术主要应用于GaN 衬底生产。LPE(液相沉积)技术主要用于硅晶圆,目前已基本被气相沉积技术所取代。
外延晶圆片结构示意图

MBE 与MOCVD 技术对比
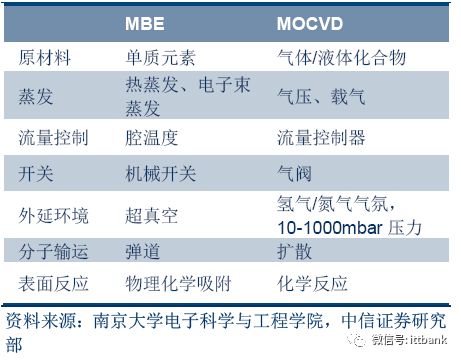
晶圆尺寸:技术发展进程不一
硅晶圆尺寸最大达12 寸,化合物半导体晶圆尺寸最大为6 英寸。硅晶圆衬底主流尺寸为12 英寸,约占全球硅晶圆产能65%,8 寸也是常用的成熟制程晶圆,全球产能占比25%。
GaAs 衬底主流尺寸为4 英寸及6 英寸;SiC 衬底主流供应尺寸为2 英寸及4 英寸;GaN 自支撑衬底以2 英寸为主。SiC 衬底目前尺寸已达6 英寸,8 英寸正在研发(II-VI 公司已制造出样品)。而实际上主流采用的仍为4 英寸晶圆。主要原因是(1)目前6 英寸SiC 晶圆大概是4 英寸成本的2.25倍,到2020 年大概为2 倍,在成本缩减上并没有大的进步,并且更换设备机台需要额外的资本支出,6 英寸目前优势仅在生产效率上;(2)6 英寸SiC 晶圆相较于4 英寸晶圆在品质上偏低,因而目前6 英寸主要用于制造二极管,在较低质量晶圆上制造二极管比造MOSFET 更为简单。
GaN 材料在自然界中缺少单晶材料,因而长期在蓝宝石、SiC、Si 等异质衬底上进行外延。现今通过氢化物气相外延(HVPE)、氨热法可以生产2 英寸、3 英寸、4 英寸的GaN自支撑衬底。目前商业应用中仍以异质衬底上的GaN 外延为主,GaN 自支撑衬底在激光器上具有最大应用,可获得更高的发光效率及发光品质。
衬底晶圆材料对应尺寸

外延生长对应wafer 尺寸
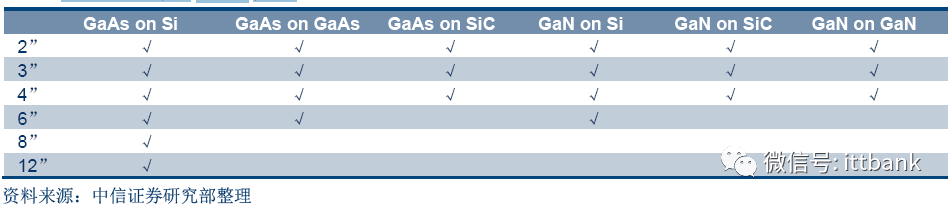
不同晶圆尺寸发展历程

化合物半导体材料(第二、三代半导体材料)
化合物半导体产业链
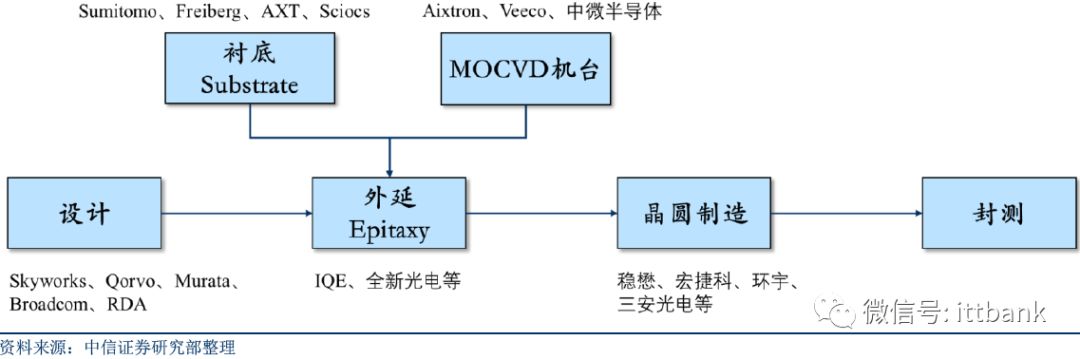
化合物半导体晶圆供给厂商格局:日美德主导,寡占格局
衬底市场:高技术门槛导致化合物半导体衬底市场寡占,日本、美国、德国厂商主导。GaAs 衬底目前已日本住友电工、德国Freiberg、美国AXT、日本住友化学四家占据,四家份额超90%。住友化学于2011 年收购日立电缆(日立金属)的化合物半导体业务,并于2016年划至子公司Sciocs。GaN 自支撑衬底目前主要由日本三家企业住友电工、三菱化学、住友化学垄断,占比合计超85%。SiC 衬底龙头为美国Cree(Wolfspeed 部门),市场占比超三分之一,其次为德国SiCrystal、美国II-VI、美国Dow Corning,四家合计份额超90%。近几年中国也出现了具备一定量产能力的SiC 衬底制造商,如天科合达蓝光。
化合物半导体供应商竞争力

外延生长市场中,英国IQE 市场占比超60%为绝对龙头。英国IQE 及中国***全新光电两家份额合计达80%。外延生长主要包括MOCVD(化学气相沉淀)技术以及MBE(分子束外延)技术两种。例如,IQE、全新光电均采用MOCVD,英特磊采用MBE 技术。HVPE(氢化物气相外延)技术主要应用于GaN 衬底的生产。
化合物半导体外延厂商竞争力

化合物半导体晶圆下游应用拆分:性能独特,自成体系
化合物半导体下游具体应用主要可分为两大类:光学器件和电子设备。光学器件包括
LED 发光二极管、LD 激光二极管、PD 光接收器等。电子器件包括PA 功率放大器、LNA低噪声放大器、射频开关、数模转换、微波单片IC、功率半导体器件、霍尔元件等。对于GaAs 材料而言,SC GaAs(单晶砷化镓)主要应用于光学器件,SI GaAs(半绝缘砷化镓)主要应用于电子器件。
化合物半导体晶圆对应下游应用

光学器件中,LED 为占比最大一项,LD/PD、VCSEL 成长空间大。Cree 大约70%收入来自LED,其余来自功率、射频、SiC 晶圆。SiC 衬底80%的市场来自二极管,在所有宽禁带半导体衬底中,SiC 材料是最为成熟的。不同化合物半导体材料制造的LED 对应不同波长光线:GaAs LED 发红光、绿光,GaP 发绿光,SiC 发黄光,GaN 发蓝光,应用GaN蓝光LED 激发黄色荧光材料可以制造白光LED。此外GaAs 可制造红外光LED,常见的应用于遥控器红外发射,GaN 则可以制造紫外光LED。GaAs、GaN 分别制造的红光、蓝光激光发射器可以应用于CD、DVD、蓝光光盘的读取。
电子器件中,主要为射频和功率应用。GaN on SiC、GaN 自支撑衬底、GaAs 衬底、GaAs on Si 主要应用于射频半导体(射频前端PA 等);而GaN on Si 以及SiC 衬底主要应用于功率半导体(汽车电子等)。
GaN 由于功率密度高,在基站大功率器件领域具有独特优势。相对于硅衬底来说,SiC衬底具有更好的热传导特性,目前业界超过95%的GaN 射频器件采用SiC 衬底,如Qorvo采用的正是基于SiC 衬底的工艺,而硅基GaN 器件可在8 英寸晶圆制造,更具成本优势。在功率半导体领域,SiC 衬底与GaN on Silicon 只在很小一部分领域有竞争。GaN 市场大多是低压领域,而SiC 在高压领域应用。它们的边界大约是600V。
各种材料工艺对应输出功率及频率
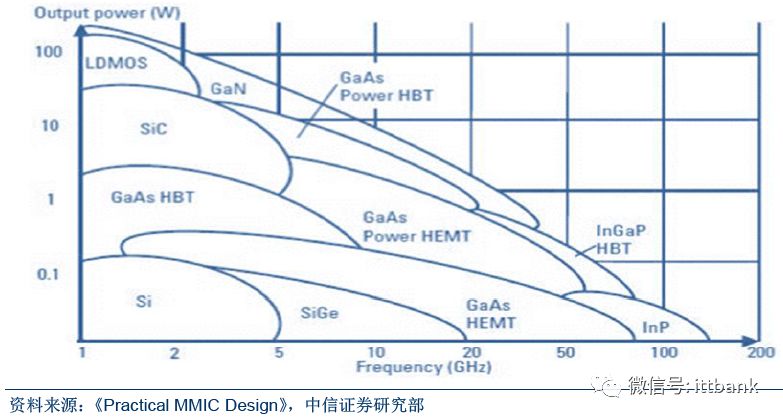
GaN 与SiC 功率器件应用范围对比
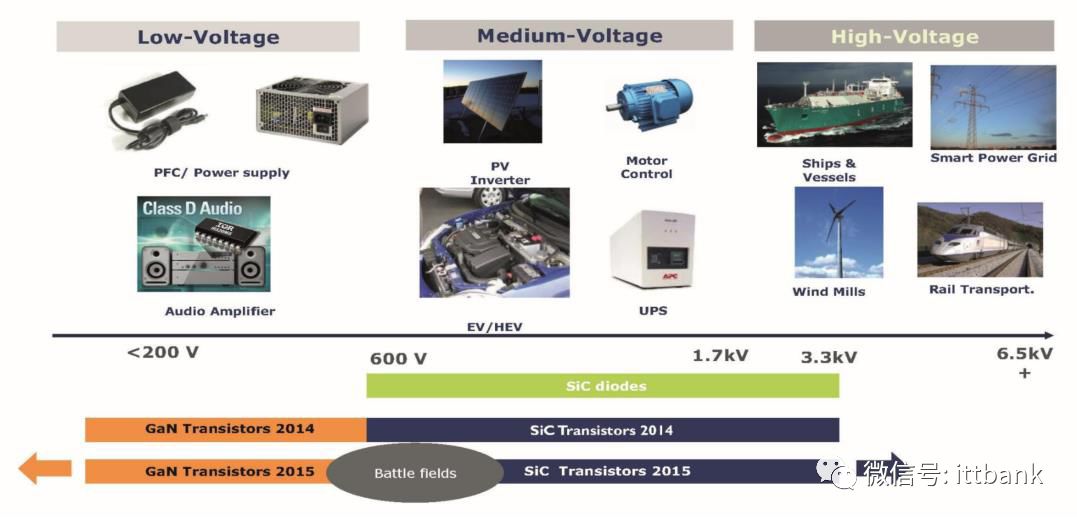
资料来源:Yole,中信证券研究部
智能手机:IC 设计率先追赶,代工、材料尚待突破
智能手机核心芯片涉及先进制程及化合物半导体材料,国产率低。以目前国产化芯片已采用较多的华为手机为例可大致看出国产芯片的“上限”。
智能手机内部芯片对应工艺-华为P20

智能手机内部芯片对应工艺- iPhone X

通信基站:大功率射频芯片对美依赖性极高
通信基站对国外芯片依赖程度极高,且以美国芯片企业为主。美国厂商垄断大功率射频器件。
基站通信设备主要芯片

汽车电子:产业技术日趋成熟,部分已实现国产化
汽车电子对于半导体器件需求以MCU、NOR Flash、IGBT 等为主。
汽车内部芯片

AI 与矿机芯片:成长新动力,国内设计厂商实现突破
AI 芯片与矿机芯片属于高性能计算,对于先进制程要求较高。
AI 核心芯片简要梳理

主流矿机芯片对比

在AI 及区块链场景下,传统CPU 算力不足,新架构芯片成为发展趋势。当前主要有延续传统架构的GPU、FPGA、ASIC(TPU、NPU 等)芯片路径,以及彻底颠覆传统计算架构,采用模拟人脑神经元结构来提升计算能力的芯片路径。云端领域GPU 生态领先,而终端场景专用化是未来趋势。根据NVIDIA 与AMD 公布的技术路线图,2018 年GPU 将进入12nm/7nm 制程。而目AI、矿机相关的FPGA 及ASIC 芯片也均采用了10~28nm 的先进制程。国内厂商涌现了寒武纪、深鉴科技、地平线、比特大陆等优秀的IC 设计厂商率先实现突破,而制造则主要依靠台积电等先进制程代工厂商。
-
智能手机
+关注
关注
66文章
18041浏览量
177012 -
晶圆代工
+关注
关注
6文章
797浏览量
48335 -
服务器芯片
+关注
关注
2文章
119浏览量
19175
原文标题:全全全!2019前十晶圆代工营收排行(附详细的半导体晶圆材料产业链)
文章出处:【微信号:icunion,微信公众号:半导体行业联盟】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
佰维存储:2024年第一季度预期营收增长,自亏转盈
Mobileye警告第一季度客户订单大幅下滑

工业物联网解决方案
电堆测试面临着怎样的行业痛点

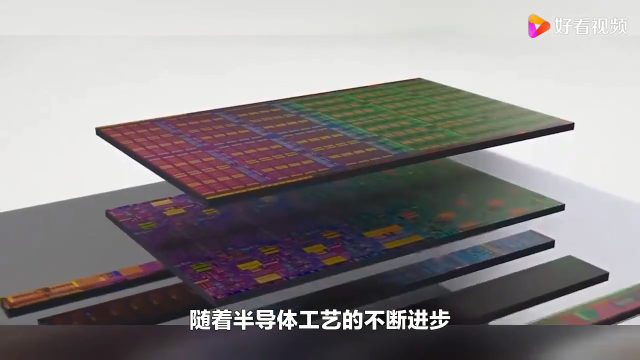
第一季度前十大晶圆代工营收季跌幅达到18.6%
NodeMCU构建项目总是面临着随机重启和失去连接的问题如何解决?
瑞萨电子公布2023年第一季度财报





 晶圆代工业者在2019年第一季就面临着相当严峻的挑战
晶圆代工业者在2019年第一季就面临着相当严峻的挑战

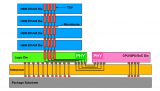










评论