瑞典的研究人员在碳化硅(SiC)上生长出更薄的IIIA族氮化物结构,以期实现高功率和高频薄层高电子迁移率晶体管(T-HEMT)和其他器件。
从图1可以看出,新结构采用高质量的60nm无晶界氮化铝(AlN)成核层,而不是大约1-2μm厚的氮化镓(GaN)缓冲层,以避免大面积扩展缺陷。成核层允许高质量的GaN在0.2μm的厚度内生长。
图1:(a)常规和(b)低TBR AlN成核,沿GaN / AlN / SiC界面沿[11-20]方向的横截面TEM图像。(c)GaN /低TBR AlN NL / SiC的HRTEM图像。(d)GaN /低TBR AlN NL界面处的HRTEM。(e)低TBR AlN NL / SiC界面处HRTEM图像。
正常厚度的缓冲层用于转变和降低由于GaN和SiC之间3.5%晶格失配所引起的缺陷。需注意的是GaN与蓝宝石和硅等其他衬底的失配率要高得多。这样的缓冲层会为高功率和高频器件带来许多问题。这些层通常会掺杂碳或铁以增加电阻,目的是将电流限制在沟道区域,避免寄生传导的泄漏效应。这些掺杂无会产生电荷俘获状态,这可能导致其对性能的负面影响,例如射频操作中的电流崩溃。
另外,较薄的器件还应具有较低的热阻,从而改善热管理。来自SweGaN AB,查尔姆斯理工大学和林雪平大学的团队评论说:“GaN / AlN / SiC界面产生的空洞和位错等结构缺陷会引入热边界电阻(TBR),导致HEMT中通道温度升高30-40%。”
降低昂贵材料的需求量是该项工作的另一个亮点。据研究人员估计,包括前体和气体在内的原材料需求量将降低90%,同时由于所需的生长时间缩短,处理成本也随之降低。
新的AlN成核工艺避免了导致柱状生长的颗粒状形态的产生——造成的这种缺陷会被带入覆盖的GaN中。通常情况下,颗粒形态的产生是由于生长表面上铝原子的低迁移率造成的。
IIIA氮化物材料在硅面4H-SiC上生长。热壁金属有机化学气相沉积法(MOCVD)用于制造具有60nm AlN成核,200nm GaN沟道,高达1.5nm的AlN中间层,10-14nm AlGaN势垒(~30%Al)的外延结构,和2nm GaN盖帽层。采用低热边界电阻(低TBR)技术生产的60nm AlN可由热壁生长实现。
尽管结构厚度更薄,但在低108 /cm-2范围内的穿透位错密度比具有相同厚度的典型GaN层低两个数量级,研究人员如此估计。在具有2nm GaN帽和14nm Al0.29Ga0.71N势垒的结构上的非接触式霍尔测量得到9.8×1012/cm2的二维电子气(2DEG)密度和2050cm2 / V-s迁移率。薄层电阻为315Ω/m2。
测试T-HEMT是在具有2nm GaN帽,10nm Al0.3Ga0.7N势垒和1nm AlN中间层的材料上制备的。基于钽的触点用于源极/漏极,接触电阻为0.3Ω-mm。

图2:(a)直流漏极电流 - 电压(IDS-VDS)特性,(b)传输特性以及10V漏极偏置(VDS)下的栅极和漏极电流与栅极电压(VGS)的函数关系,(c)跨导(gm)作为栅极电位的函数,和(d)作为T-HEMT的VDSQ的函数的射频输出功率密度。(e)没有顶部活性层的异质结构的垂直和侧向击穿特性。
该器件实现了1.1A / mm的高导通电流密度和1.3Ω-mm的低归一化导通电阻。(图2)饱和电流可维持高达30V的漏极偏压。采用10V漏极偏压时,夹断很明显,跨导达到500mS / mm。阈值摆幅取决于栅极长度:0.1μm为250mV / decade,0.2μm为130mV / decade。对于0.1μm和0.2μm的栅极,击穿电压分别为70V和140V。
研究人员表明“击穿电压和栅极长度之间的线性关系表明,由于栅极长度和栅极 - 漏极间距的限制,击穿是横向发生的。”
栅极 - 漏极间距为2μm,远远低于通常用于GaN HEMT的通常10-20μm,目的是为了提高功率性能。而传统的GaN功率HEMT具有微米级的栅极长度。
30GHz时的负载牵引测量在40V漏极 - 源极静态偏置(VDSQ)下产生5.8W / mm的峰值射频功率密度。
在没有上AlN / AlGaN层的外延叠层上的击穿测量在横向和垂直方向上产生高达1.5kV击穿电压。该团队说:“在这两种情况下,击穿是由于触点的不良划定。因此,预期堆叠的实际击穿电压会更高。也就是说,击穿受表面限制,并证实没有界面载体。”
-
SiC
+关注
关注
27文章
2431浏览量
61398 -
GaN
+关注
关注
19文章
1761浏览量
67839
原文标题:用于高频和功率电子器件的GaN-SiC混合材料
文章出处:【微信号:iawbs2016,微信公众号:宽禁带半导体技术创新联盟】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
CMPA1D1E025 Ku波段功率放大器CREE
CGHV96050F1卫星通信氮化镓高电子迁移率晶体管CREE
三安宣布进军美洲市场,为市场提供SiC和GaN功率半导体产品
同是功率器件,为什么SiC主要是MOSFET,GaN却是HEMT
功率电子器件从硅(Si)到碳化硅(SiC)的过渡
CGHV96130F X波段功率放大器CREE
GaN和SiC在电动汽车中的应用

提高SiC功率模块的功率循环能力
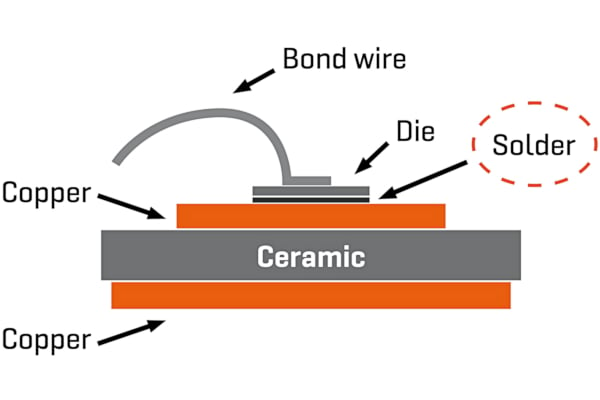
Si基GaN功率器件制备技术与集成

GaN与SiC功率器件的特点 GaN和SiC的技术挑战

GaN器件在Class D上的应用优势
SJ MOSFET的应用及与SiC和GaN的比较
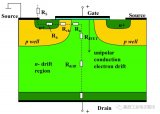




 GaN-SiC混合材料更薄和更高功率
GaN-SiC混合材料更薄和更高功率


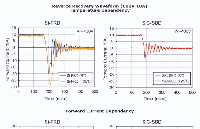










评论