英国斯旺西大学和塞尔维亚尼斯大学的研究人员声称他们首次制造出氮化镓(GaN)磁性高电子迁移率晶体管(MagHEMT)。[S Faramehr et al, Semicond. Sci. Technol., vol33, p095015, 2018]
由图一可以看出器件采用的是分流式漏极,这可以评估由于与磁场相互作用引起的电子路径偏差。这些器件的相对灵敏度由漏极端子之间的电流差相对于特斯拉(T)中磁场上的总漏极电流给出。
图一:GaN MagHEMT(分流电流传感器)示意图(显示出相对灵敏度优化后的几何参数)
这种磁性传感器广泛应用于工程系统中的控制,涵盖航空,汽车和工业领域。
器件采用HEMT异质外延结构制备,Al0.25Ga0.75N作为阻挡层,利用阶梯渐变AlGaN从硅衬底过渡。器件的长度(L)和宽度(W)分别为35μm和20μm,源极(LS)和漏极(LD)的长度均为5.5μm,栅极长度(LG)为1.0μm,栅 - 源距离(LGS)为1μm,两个漏极触点(WD)的宽度各为7.5μm。同时该器件用10nm氮化硅钝化。
当栅极为0且漏极偏压为0.5V时,灵敏度为11.98%/ T——这高于之前报道的硅双漏极分流磁传感器的值。
图二:模拟相对灵敏度以及优化的GaN Mag HEMT与模拟原始GaN Mag HEMT的电流差曲线
研究人员使用实验结果来校准一系列旨在优化性能的模拟。通过图二可以看出在器件参数变化的情况下——L =65μm,W =20μm,LS =5.5μm,WS =5.0μm,WDD =5μm,LG =5.0μm,LGD =10μm,可以在0栅极电位和0.5V漏极偏压下实现将灵敏度提高到23.29%/ T。
这其中最重要的一个变化就是器件长度的增加(65μm)和源宽度的降低(5.0μm)。降低的源极接触会降低总电流,并增加对电流偏转效应的敏感度。而较长的长度也增加了源极到漏极的电阻,再次降低了总电流。模拟还表明在-4V栅极电位附近存在一个数量级灵敏度的增强。
研究人员进一步在500K的温度下进行了模拟,结果表明在恶劣环境下,GaN磁传感器也能够进行操作。但是,器件结构的灵敏度会降低到4.91%/ T。
-
传感器
+关注
关注
2522文章
47978浏览量
739673 -
晶体管
+关注
关注
76文章
9027浏览量
135058 -
GaN
+关注
关注
19文章
1759浏览量
67691
原文标题:高电子迁移率的磁感应氮化镓晶体管
文章出处:【微信号:iawbs2016,微信公众号:宽禁带半导体技术创新联盟】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
在特殊类型晶体管的时候如何分析?
CGHV96050F1卫星通信氮化镓高电子迁移率晶体管CREE
CGHV40180 L波段功率放大器CREE
CGHV96130F X波段功率放大器CREE
基于VIPerGaN50和STUSB4761的45W QR USB PD适配器参考设计
不同类型的晶体管及其功能
CGHV1F006S氮化镓高电子迁移率晶体管规格书
未来智能城市的动力引擎:润新微电子的650V GaN功率晶体管(FET)
MXene范德华接触在氮化镓高电子迁移率晶体管中的应用
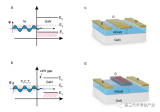




 应用于工程系统控制的GaN磁性高电子迁移率晶体管
应用于工程系统控制的GaN磁性高电子迁移率晶体管

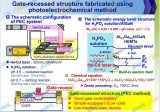
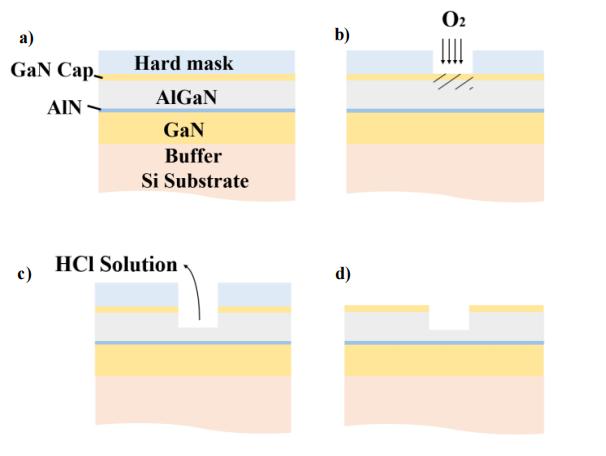

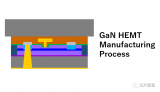
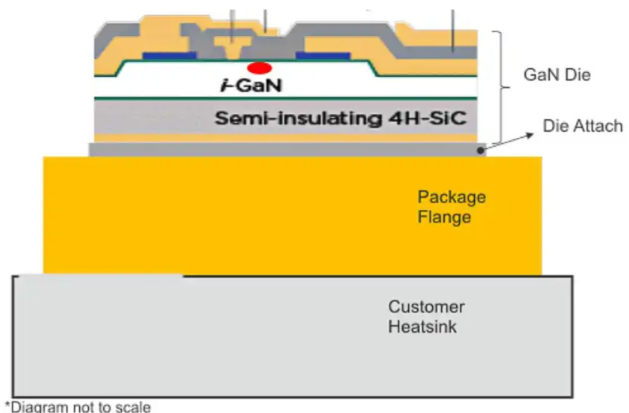










评论