作为世界领先的湿制程生产设备商之一,Manz亚智科技宣布推出面板级扇出型封装(FOPLP;Fan-out Panel Level Packaging)湿制程解决方案,透过独家的专利技术,克服翘曲问题,使面板在制程槽体间的运输过程可以维持平整,并减少面板于生产过程的破片率。Manz亚智科技目前已为中国及***的客户提供FOPLP的湿制程解决方案,并成功用于量产线。
除湿制程设备外,Manz亚智科技整合集团内的核心技术,还能为FOPLP封装技术提供自动化、精密涂布及雷射等制程设备,配合客户需求与客户共同开发设计最适合的制程设备,协助客户缩短产品开发时程,并建立专属制程参数,使产品能快速进入量产。
FOPLP市场发展与关键技术
有鉴于智能型手机的市场需求,追求轻薄短小的同时,仍旧希望在功能及效能上有显著提升,因此必须同时做到增加可支援的I/O数量并降低厚度,而过往采用覆晶堆栈封装技术(Flip Chip Package on package)进行芯片堆栈,一旦改采扇出型封装技术,整体封装厚度预期可节省20%以上,因此从2015年开始,扇出型封装产值便快速成长。目前FOWLP(Fan-out Wafer-level packaging,FOPLP)的成本仍居高不下,故许多大厂纷纷将重点技术由FOWLP转向以面积更大的方型载板,如玻璃基板等…的FOPLP封装制程,可望提升面积使用率及*3-5倍生产能力,进而降低成本。*市场预估FOPLP销售额在2023年将达到2.793亿美元,这促使了技术开发已有相当基础的封装厂、PCB载板厂及面板厂皆积极布局。Manz亚智科技凭借着优异的印刷电路板及显示器生产设备开发团队、逾30年丰富的业界经验及超过7,500台的湿制程设备总销售佳绩,掌握FOPLP先进封装的关键黄光制程、电镀等设备,能够实现高密度重布线层(RDL),满足客户多元的需求,提供专业且全面的设备及技术支援。
完整一站式跨领域设备整合,协助不同领域顾客进入半导体市场
半导体过往大多致力于将制程技术细微化及缩小裸晶尺寸,如今则强调一贯性制程,演变成封装技术的革命,Manz亚智科技提供的FOPLP解决方案,能够协助顾客整合前后段的一次性封装技术。不仅如此,还能整合集团内的其他核心技术,包涵自动化、雷射及涂布,协助规划整厂生产线。优势包含下列几点:
跨领域设备整合:凭借着丰富的业界经验,能够协助客户整合前后段的封装技术,满足封装、载板以及面板厂商的不同需求,协助制造商快速进入FOPLP制程领域并有效降低开发成本。
与客户共同研发:有鉴于FOPLP为业界的新需求,无论是面板尺寸、制程条件等都尚未有共同标准,但Manz亚智科技的专业团队可以配合不同客户的制程需求提供客制化设备服务,或是与客户共同研发解决方案。
自动化整合:透过机械手臂或是自动化升降平台,自动传输面板进出制程槽,达到全自动化生产流程。
批次式(Batch)及在线式(In-Line)系统设计:可搭配客户制程及需求,弹性规划设备及产线设计,以达到最佳生产配置。
专利设计:透过Manz亚智科技独家的专利设计,克服FOPLP产生的面板翘曲问题,让面板在制程槽体间的传输过程得以维持平整,达到制程结果。
「30多年来,Manz亚智科技凭借着优异的湿制程技术、多元技术的整合能力及卓越的客户服务,在业界深获许多客户信赖。我们与半导体产业密切合作,对FOPLP的发展也深入研究,这项新的应用对于熟稔面板及PCB生产制程设备的我们而言,有着极大的优势。我们的研发团队在短短的时间内即与客户共同开发及打造FOPLP湿制程设备。」Manz亚智科技总经理林峻生表示,「透过我们在湿制程生产设备及其他技术丰富的整合经验,跨领域提供设备并积极整合,能与不同领域的客户一同开展FOPLP封装技术,与客户共同达程开发时程缩短、生产效率提升并有效降低成本。以此,加快整体供应链更迭换代,驱动更轻薄小且具备价格竞争力的产品上市,带动市场成长。」
Manz亚智科技将于国际半导体展(Semcon Taiwan 2018)展出此项解决方案,摊位代号:K2980。
2018 YOLE 市场报告
Manz集团 – 热情成就高效能
Manz AG 为活跃全球的高科技设备制造商,总公司位于德国罗伊特林根,是高成长市场上创新产品的先驱。1987 年成立的Manz 公司,专精于五种技术领域,包含自动化、测试与检测技术、雷射制程、化学湿制程、及卷对卷技术,这些核心技术将应用于Manz 在“电子装置及零组件”、“太阳能”及“储能”三大策略领域的技术扩展,并将在未来持续向前发展。
Manz 集团于2006 年在德国公开上市,Manz 集团在德国、斯洛伐克、匈牙利、意大利、中国大陆及***皆设有自己的生产据点;而Manz 集团的业务销售及服务网路遍布全球,包括美国和印度。Manz 集团在全球拥有约1,700名员工,其中在亚洲约有750名。在过去的营业年度中,公司销售额超过3.25亿欧元。在公司宣言“热情成就高效能”的推动下,Manz 承诺未来会为各种重点产业的客户,提供更高效能的生产系统解决方案。凭借Manz集团在开发新生产技术以及所需设备方面的全面专业知识,Manz 为其全球众多客户降低终端产品的生产成本作出了巨大贡献。
-
半导体
+关注
关注
327文章
24412浏览量
201768 -
面板
+关注
关注
13文章
1595浏览量
53417 -
Manz
+关注
关注
0文章
16浏览量
8265
原文标题:【企业动态】Manz亚智科技推出面板级扇出型封装(FOPLP)湿制程解决方案
文章出处:【微信号:TPCA_PCB,微信公众号:PCB资讯家】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
英伟达AI芯片2026年将应用面板级扇出型封装,推动市场供应
消息称群创拿下恩智浦面板级扇出型封装大单
易飞扬推出几款特色扇出型光模块
扇出型晶圆级封装技术的优势分析

基于扇出型封装结构的芯片失效位置定位方法

一文详解扇出型晶圆级封装技术

华海诚科:颗粒状环氧塑封料等自研产品可用于扇出型晶圆级封装
什么是BGA扇出 典型BGA 封装的内部结构
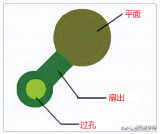
Manz亚智科技FOPLP封装技术再突破
扇出型圆片级封装工艺流程与技术

激光解键合在扇出晶圆级封装中的应用





 Manz亚智科技推出面板级扇出型封装
Manz亚智科技推出面板级扇出型封装














评论