特瑞仕半导体株式会社,于2018年7月举行了冷却柱形新型封装组件DFN3030-10B的首次出厂仪式。
本封装组件是与株式会社加藤电器制作所共同开发的封装组件(DFN3030-10B),采用从封装组件的顶面贯穿底面的铜柱形结构、能把线圈的热量直接发散到实装电路板(印制板)的小型、高散热性封装组件。由于线圈在封装组件的外部,对应微模块的产品规格、能选择绕组(铁氧体,金属合金)、叠片等线圈,耐高压和大电流化有利于微模块向小型化进步。
此外,本封装组件在管理和保管产品(防潮管理)方面优越,实现了MSL-1。
在株式会社加藤电器制作所举行的出厂仪式
DFN3030-10B封装组件的特长
通过贯穿电路板的铜柱把从线圈发出的热量发散到电路板。因为对线圈的种类没有要求,能对应耐高压、大电流化的微模块。
"microDC/DC" 封装
铜柱的散热特性
当线圈中流入1400mA的电流时,线圈整体温度上升状况
(1)有铜柱(Ta=25℃) (2)没有铜柱(Ta=25℃)
-
半导体
+关注
关注
327文章
24494浏览量
202058 -
封装
+关注
关注
123文章
7271浏览量
141080
原文标题:小型、高散热性冷却柱形封装组件DFN3030-10B
文章出处:【微信号:gh_454737165c13,微信公众号:Torex产品资讯】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
20W-50W厚膜无感电阻TO-220封装技术规格&散热说明
AOS推出新款100V MOSFET AONA66916
AOS推出创新型双面散热 DFN 5x6 封装

SiC功率模块的液冷散热设计与节能分析
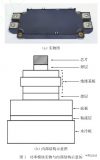
高速电主轴发热时需要如何冷却?|深圳市恒兴隆机电有限公司a
华为公布倒装芯片封装最新专利:改善散热 CPU、GPU等都能用

倒装芯片封装技术起源于哪里 倒装芯片封装技术的优缺点有哪些

4A额定电流,Vishay汽车级Power DFN系列整流器

封装设计中的热性能考量
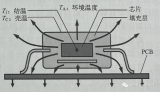




 新型封装组件DFN3030-10B冷却柱形,具有高散热性
新型封装组件DFN3030-10B冷却柱形,具有高散热性













评论