超越摩尔,三星的异构集成之路
在近期举办的2021年SamsungFoundry论坛上,三星透露了2/3nm制程工艺的新进展,并公开发布了全新的17nm工艺。三星市场战略副总裁MoonSoo Kang也面向产业合作伙伴,公布了三星在异构集成上的计划,如何为摩尔定律再度添加一个“维度”。

旗舰GPU与移动芯片的面积变化对比 / 三星
几十年间,半导体产业一直在不懈地推动摩尔定律,以更先进的制程做到更多的晶体管数目,这就是我们常说的“延续摩尔”方案,也是当前计算与电路领域持续创新最大的推动力。
尽管摩尔定律的延续,芯片面积仍在扩大,比如一直在追求算力的GPU,已经快要逼近光罩尺寸的限度了。再加上晶体管数目的增加,使得芯片设计成本和生产成本无休止地增加。在不少人看来,单靠“延续摩尔”不再是一个技术与成本上可持续的方案。
与此同时,更多的功能与特性集成在单个芯片上,却又没有单个制程可以满足所有不同功能的需求,比如模拟、射频、高压等,即便可以满足也无法达到优秀的性能与成本平衡。“延续摩尔”的方案在这类挑战面前束手无策,因此才出现了异构集成这种“扩展摩尔”的方案。通过两种方案的互补,共同做到“超越摩尔”。
Chiplet:降低成本提高良率的救星
随着单个芯片加入更多特性,即便摩尔定律延续下去,其芯片面积仍在增加,为所有不同功能的设计区块使用同一个制程节点成了抵消的选择,好在如今有了Chiplet这一救星的出现。将一大块裸片分成较小的chiplet,并为每个chiplet使用最优的制程,可以显著提高整个芯片的良率,同时减少生产成本。例如某些特定的接口IP并不会因为采用先进制程而获得面积或性能上的优化,对这些IP使用成熟制程和专用定制制程,可以做到更低的成本以及更优的性能。
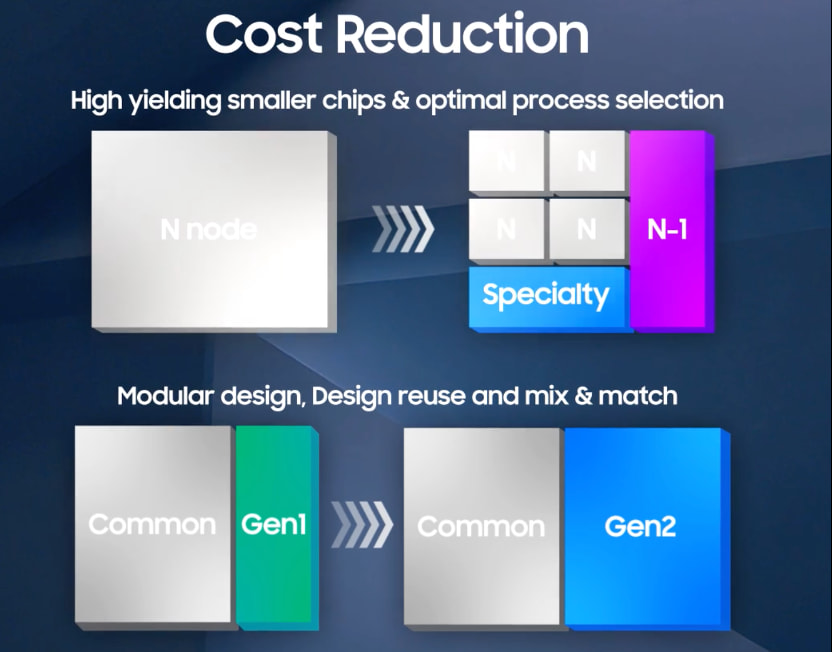
Chiplet方案 / 三星
另一个可行方案就是模组化的设计与制造,也就是重复使用相同的组件chiplet。不少IP模组都可以作为chiplet重复使用,只有芯片的其他部分需要重新设计和生产,此举显著减少了设计、开发与生产的成本,芯片厂商可以借此更快实现产品迭代。
X-Cube:垂直3D集成
异构集成不只是为了成本和良率考虑,也能进一步提升芯片性能。传统的2D设计中,信号路径有几毫米长。而在3D集成下,芯片的堆叠可以将信号路径减少至几微米,大大改进了芯片延迟。除此之外,3D集成中更出色的内联间距可以实现更高的带宽,进一步提高芯片性能。
早在2014年,三星就首次实现了将宽IO内存与移动应用处理器的3D堆叠,也就是三星的Widcon技术。随后,3D芯片堆叠技术继续发展,诞生了一系列HBM内存产品。HBM就是由DRAM与逻辑堆叠,并由微凸块和TSV相连而成的。也正是因为3D堆叠技术,三星得以开发出了3层的CMOS图像传感器,由图像传感器、逻辑与DRAM三种不同的裸片堆叠在一起而成。
2020年,三星推出了X-Cube技术,这项技术使得两个逻辑单元裸片可以垂直堆叠在一起,形成一个单独的3D芯片,由微凸块与TSV连接。X-Cube分为两种形式,两个裸片由微凸块连接或是直接铜键合。
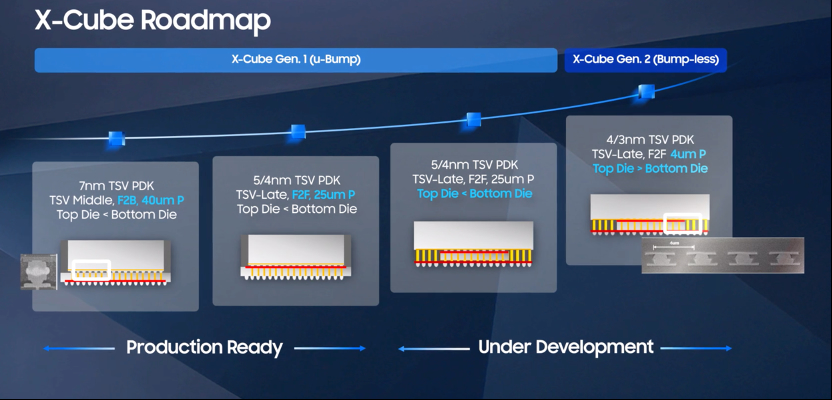
X-Cube路线图 / 三星
第一代X-Cube技术(u-Bump)主要依靠微凸块连接,三星已经发布了针对7nm逻辑制程的TSV PDK,采用F2B结构,凸块间距为40um。面向4/5nm的TSV PDK也已经发布,改用F2F的结构,凸块间距降低至25um。尚在开发中的第二代X-Cube技术(Bump-less)则采用了直接铜键合技术,间距降低至4um。
值得一提的是,英特尔的Foveros3D堆叠技术路线与三星X-Cube大致相同。第一代Foveros的凸块间距在36um至50um之间,而下一代FoverosOmni技术同样可以做到25um的凸块间距。尚在开发的Foveros Direct也采用了直接铜键合的方式,宣称凸块间距降低至10um以下。
过去的X-Cube架构中,底部裸片的面积要大于顶部裸片,然而为了更好了满足客户对芯片分区和散热等不同要求,三星也将在后续提供顶部裸片大于底部裸片的结构。目前三星已经完成了3D堆叠SRAM的验证,在7nm的制程下,可以做到48.6GB/s的带宽,以及7.2ns的读取延迟与2.6ns的写入延迟。
除此之外,三星还提供了一项差异化技术,ISC(集成堆叠电容)。这一电容应用了已经在三星DRAM产品中获得验证的硅电容结构、材料和工艺,具有1100nF/mm2的电容密度,可以有效提高电源完整性。三星的ISC还提供了多种不同的配置,比如分立型、硅中介层型和多晶圆堆叠型,以满足客户不同的结构需求,ISC预计将在2022年进入量产阶段。
I-Cube:横向2.5D组合
另一方面,为了从横向组合芯片,三星开发了所谓的2.5D技术I-Cube,将逻辑单元与多个HBM集成在同一硅中介层上。目前三星已经成功实现了一个逻辑裸片+两个HBM的I-Cube2量产,成品之一就是百度的昆仑AI芯片。百度的昆仑AI芯片不仅使用了三星的14nm制程,也运用了三星的I-CUBE 2技术。
I-Cube使用了预筛选的技术,在封装的中间阶段进行运算测试,从而提高良率。该技术还采用了无封胶的结构,做到更好的散热性能,据三星强调,与传统的2.5D方案相比,I-Cube的散热效率高上4.5%。此外,与其他代工厂商相比,三星的I-Cube技术还有一些优势,比如与三星内存合作,率先用上最新的内存方案

I-Cube4示意图 / 三星
目前三星已经在计划集成4HBM3模组的I-Cube4量产工作,而6 HBM的I-Cube6也已经做好量产准备,前者预计2022年进入大批量产阶段。三星更是准备了两个逻辑裸片+8个HBM的I-Cube8方案,目前尚处于开发阶段,预计2022年末将正式上线。
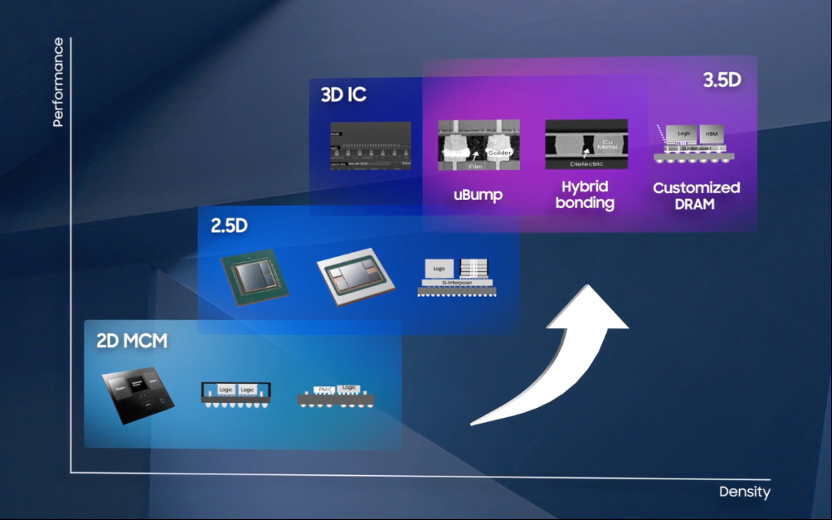
2D至3.5D的封装方案 / 三星
除了2D、2.5D与3D的IC技术之外,三星还在开发全新的3.5D封装技术,这种系统级封装内还将加入堆叠的定制DRAM或SRAM裸片,实现更高的性能与密度。
小结
在开发2.5D/3D集成的多芯片或多Chiplet系统级芯片时,设计者往往还会遇到在传统单芯片设计上罕见的技术障碍,比如多出来的接口IP或潜在的功耗增加。这时候,三星、台积电和刚进入IDM 2.0的英特尔等代工厂商还会提供异构设计的方法和工具,帮助设计者克服这些挑战。在异构集成的大势之下,代工厂也将提供更多的服务模式,增加封装、测试以及一站式的设计服务。
在近期举办的2021年SamsungFoundry论坛上,三星透露了2/3nm制程工艺的新进展,并公开发布了全新的17nm工艺。三星市场战略副总裁MoonSoo Kang也面向产业合作伙伴,公布了三星在异构集成上的计划,如何为摩尔定律再度添加一个“维度”。

旗舰GPU与移动芯片的面积变化对比 / 三星
几十年间,半导体产业一直在不懈地推动摩尔定律,以更先进的制程做到更多的晶体管数目,这就是我们常说的“延续摩尔”方案,也是当前计算与电路领域持续创新最大的推动力。
尽管摩尔定律的延续,芯片面积仍在扩大,比如一直在追求算力的GPU,已经快要逼近光罩尺寸的限度了。再加上晶体管数目的增加,使得芯片设计成本和生产成本无休止地增加。在不少人看来,单靠“延续摩尔”不再是一个技术与成本上可持续的方案。
与此同时,更多的功能与特性集成在单个芯片上,却又没有单个制程可以满足所有不同功能的需求,比如模拟、射频、高压等,即便可以满足也无法达到优秀的性能与成本平衡。“延续摩尔”的方案在这类挑战面前束手无策,因此才出现了异构集成这种“扩展摩尔”的方案。通过两种方案的互补,共同做到“超越摩尔”。
Chiplet:降低成本提高良率的救星
随着单个芯片加入更多特性,即便摩尔定律延续下去,其芯片面积仍在增加,为所有不同功能的设计区块使用同一个制程节点成了抵消的选择,好在如今有了Chiplet这一救星的出现。将一大块裸片分成较小的chiplet,并为每个chiplet使用最优的制程,可以显著提高整个芯片的良率,同时减少生产成本。例如某些特定的接口IP并不会因为采用先进制程而获得面积或性能上的优化,对这些IP使用成熟制程和专用定制制程,可以做到更低的成本以及更优的性能。
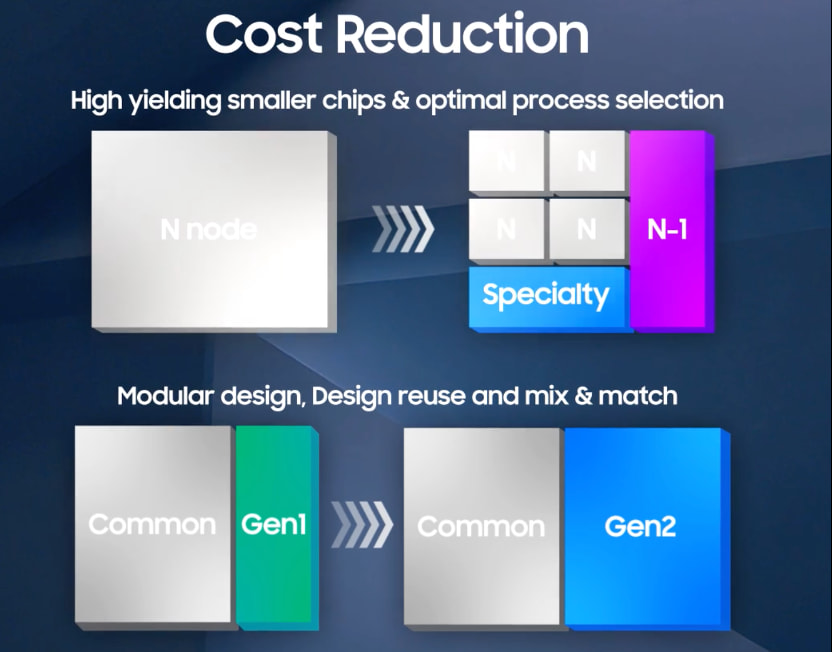
Chiplet方案 / 三星
另一个可行方案就是模组化的设计与制造,也就是重复使用相同的组件chiplet。不少IP模组都可以作为chiplet重复使用,只有芯片的其他部分需要重新设计和生产,此举显著减少了设计、开发与生产的成本,芯片厂商可以借此更快实现产品迭代。
X-Cube:垂直3D集成
异构集成不只是为了成本和良率考虑,也能进一步提升芯片性能。传统的2D设计中,信号路径有几毫米长。而在3D集成下,芯片的堆叠可以将信号路径减少至几微米,大大改进了芯片延迟。除此之外,3D集成中更出色的内联间距可以实现更高的带宽,进一步提高芯片性能。
早在2014年,三星就首次实现了将宽IO内存与移动应用处理器的3D堆叠,也就是三星的Widcon技术。随后,3D芯片堆叠技术继续发展,诞生了一系列HBM内存产品。HBM就是由DRAM与逻辑堆叠,并由微凸块和TSV相连而成的。也正是因为3D堆叠技术,三星得以开发出了3层的CMOS图像传感器,由图像传感器、逻辑与DRAM三种不同的裸片堆叠在一起而成。
2020年,三星推出了X-Cube技术,这项技术使得两个逻辑单元裸片可以垂直堆叠在一起,形成一个单独的3D芯片,由微凸块与TSV连接。X-Cube分为两种形式,两个裸片由微凸块连接或是直接铜键合。
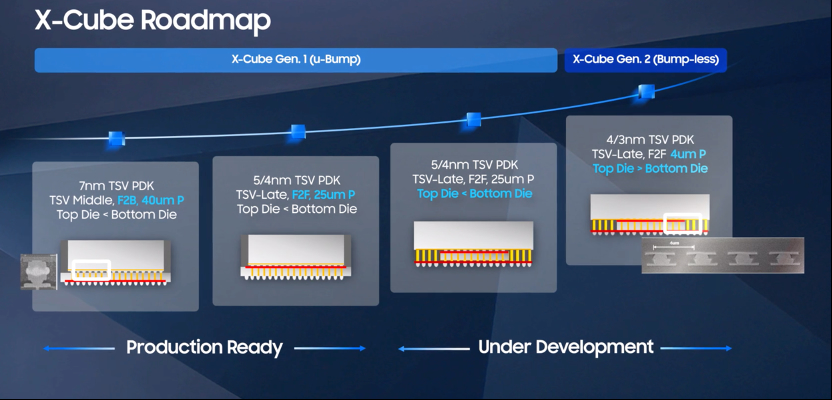
X-Cube路线图 / 三星
第一代X-Cube技术(u-Bump)主要依靠微凸块连接,三星已经发布了针对7nm逻辑制程的TSV PDK,采用F2B结构,凸块间距为40um。面向4/5nm的TSV PDK也已经发布,改用F2F的结构,凸块间距降低至25um。尚在开发中的第二代X-Cube技术(Bump-less)则采用了直接铜键合技术,间距降低至4um。
值得一提的是,英特尔的Foveros3D堆叠技术路线与三星X-Cube大致相同。第一代Foveros的凸块间距在36um至50um之间,而下一代FoverosOmni技术同样可以做到25um的凸块间距。尚在开发的Foveros Direct也采用了直接铜键合的方式,宣称凸块间距降低至10um以下。
过去的X-Cube架构中,底部裸片的面积要大于顶部裸片,然而为了更好了满足客户对芯片分区和散热等不同要求,三星也将在后续提供顶部裸片大于底部裸片的结构。目前三星已经完成了3D堆叠SRAM的验证,在7nm的制程下,可以做到48.6GB/s的带宽,以及7.2ns的读取延迟与2.6ns的写入延迟。
除此之外,三星还提供了一项差异化技术,ISC(集成堆叠电容)。这一电容应用了已经在三星DRAM产品中获得验证的硅电容结构、材料和工艺,具有1100nF/mm2的电容密度,可以有效提高电源完整性。三星的ISC还提供了多种不同的配置,比如分立型、硅中介层型和多晶圆堆叠型,以满足客户不同的结构需求,ISC预计将在2022年进入量产阶段。
I-Cube:横向2.5D组合
另一方面,为了从横向组合芯片,三星开发了所谓的2.5D技术I-Cube,将逻辑单元与多个HBM集成在同一硅中介层上。目前三星已经成功实现了一个逻辑裸片+两个HBM的I-Cube2量产,成品之一就是百度的昆仑AI芯片。百度的昆仑AI芯片不仅使用了三星的14nm制程,也运用了三星的I-CUBE 2技术。
I-Cube使用了预筛选的技术,在封装的中间阶段进行运算测试,从而提高良率。该技术还采用了无封胶的结构,做到更好的散热性能,据三星强调,与传统的2.5D方案相比,I-Cube的散热效率高上4.5%。此外,与其他代工厂商相比,三星的I-Cube技术还有一些优势,比如与三星内存合作,率先用上最新的内存方案

I-Cube4示意图 / 三星
目前三星已经在计划集成4HBM3模组的I-Cube4量产工作,而6 HBM的I-Cube6也已经做好量产准备,前者预计2022年进入大批量产阶段。三星更是准备了两个逻辑裸片+8个HBM的I-Cube8方案,目前尚处于开发阶段,预计2022年末将正式上线。
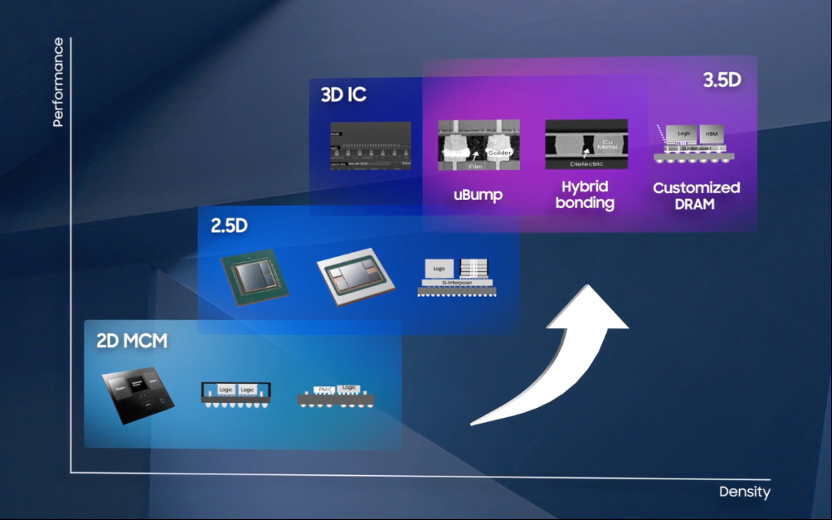
2D至3.5D的封装方案 / 三星
除了2D、2.5D与3D的IC技术之外,三星还在开发全新的3.5D封装技术,这种系统级封装内还将加入堆叠的定制DRAM或SRAM裸片,实现更高的性能与密度。
小结
在开发2.5D/3D集成的多芯片或多Chiplet系统级芯片时,设计者往往还会遇到在传统单芯片设计上罕见的技术障碍,比如多出来的接口IP或潜在的功耗增加。这时候,三星、台积电和刚进入IDM 2.0的英特尔等代工厂商还会提供异构设计的方法和工具,帮助设计者克服这些挑战。在异构集成的大势之下,代工厂也将提供更多的服务模式,增加封装、测试以及一站式的设计服务。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
三星电子
+关注
关注
34文章
15603浏览量
180115 -
异构
+关注
关注
0文章
35浏览量
12958 -
异构集成
+关注
关注
0文章
32浏览量
1773
发布评论请先 登录
相关推荐
华芯邦科技开创异构集成新纪元,Chiplet异构集成技术衍生HIM异构集成模块赋能孔科微电子新赛道
华芯邦科技将chiplet技术应用于HIM异构集成模块中伴随着集成电路和微电子技术不断升级,行业也进入了新的发展周期。HIM异构集成模块化-

晶圆厂拼的不只是先进逻辑工艺节点,异构集成技术不可小觑
,绝大多数厂商会选择异构集成的方式,借助先进封装技术实现“超越摩尔”。诸如台积电、英特尔等厂商,也都纷纷推出了3DFabric、Foveros之类的技术,而
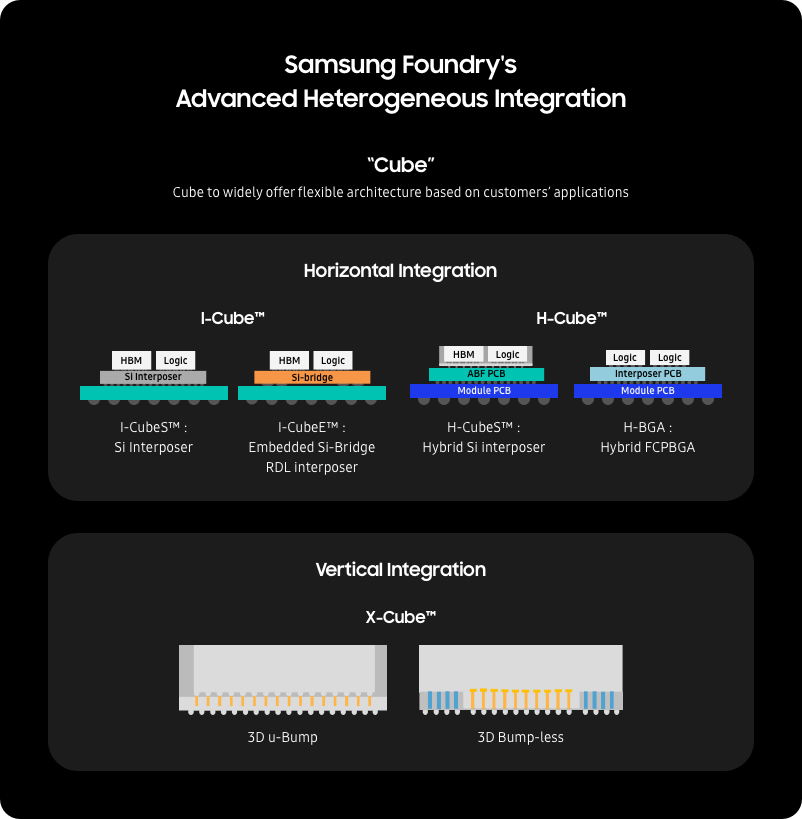
超越摩尔定律,下一代芯片如何创新?
摩尔定律是指集成电路上可容纳的晶体管数目,约每隔18-24个月便会增加一倍,而成本却减半。这个定律描述了信息产业的发展速度和方向,但是随着芯片的制造工艺接近物理极限,摩尔定律也面临着瓶颈。为了



异构计算场景下构建可信执行环境
OpenHarmony技术峰会上提出了几点思考。
金意儿首先从摩尔定律放缓现象作为切入点。摩尔定律自1975年起至2020年得到了快速的发展,使得芯片中集成晶体管的密度大幅提升,推动了半导体商业模式
发表于 08-15 17:35






 超越摩尔,三星的异构集成之路
超越摩尔,三星的异构集成之路
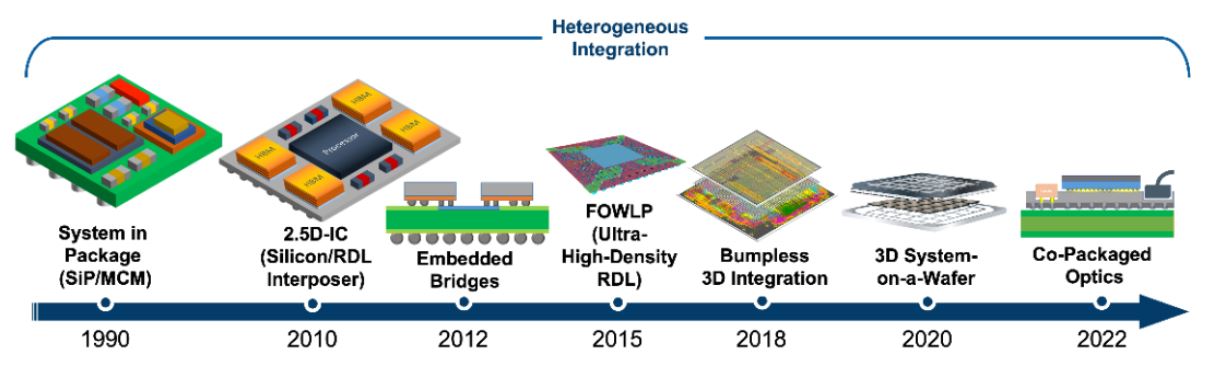

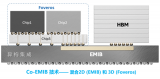

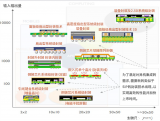
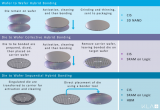










评论