3DIC架构并非新事物,但因其在性能、成本方面的优势及其将异构技术和节点整合到单一封装中的能力,这种架构越来越受欢迎。随着开发者希望突破传统二维平面IC架构的复杂度和密度限制,3D集成提供了引入更多功能和增强性能的机会,同时可满足尺寸限制与成本要求。
3D结构有许多优点,例如性能通常由访问内存所需的时间和功耗决定。通过3D集成,存储器和逻辑电路可以集成到单个3D堆栈中。这种方法通过微间距互连大大增加了内存总线的宽度,同时通过缩短互连线路减少了传播延迟。这种连接可以使3D设计的内存访问带宽达到几十Tbps,而领先的2D设计带宽仅能达到数百Gbps。
从成本角度讲,配有不同部件的大型系统在芯片实现方面有多种优点。异构集成并不是将整个芯片放置在最复杂或最昂贵的技术节点上,而是针对系统的不同部分使用“恰当”节点。例如,先进节点仅用于系统的关键部分,而成本较低的节点则用于不太关键的部分。
增加垂直维度改变了集成电路设计策略
由于设计必须从3D角度考虑,而不是仅考虑典型2D平面设计的x、y,因此,必须增加z维度进行全面管理——从架构设计到逻辑验证和路由连接——包括凸块和通硅孔(TSV)、热量和电源分配网络(PDN)的新权衡(例如基于中介层与3D堆栈、逻辑内存与内存逻辑,以及混合键合与凸块),优化PPA仍然是一个关键指导因素。然而,由于3DIC的出现实现了立方毫米优化,因为不仅仅考虑两个方向,而且在所有的权衡决策中还必须考虑垂直维度。
更为复杂的是,3DIC的集成度更高,传统电路板和手工封装技术已经不合时宜,例如高速互连的凸块布局和定制布局,这导致了额外的瓶颈出现。最重要的是,以前不同学科之间的相互依赖性现在则需要在联合设计方法(人员和工具)中予以考虑,这涉及到设计IP、芯片封装、架构、实现和系统分析等所有阶段。
采取芯片优先的方法
尽管采用与印刷电路板(PCB)设计类似的方式考虑3D架构似乎是一种显而易见的选择,但3DIC最好采用芯片优先的方法——即优化(整个芯片的)设计IP并共同设计芯片系统和封装方法。在3DIC方法中,新思科技正在将IC设计的关键概念和创新成果引入3DIC领域。这需要考察3DIC的各个方面,例如架构设计、将高度自动化能力引入手动任务中、扩展解决方案以支持高级封装的高集成度,以及将签核分析集成到设计流程中。
3DIC将封装(过去采用类似PCB的工具进行管理)与芯片集成在一起。PCB工具没有连接在一起,无法适应规模和工艺的复杂性。典型的PCB中可能有10,000个接点。但在复杂的3DIC中,接点数量很快会达到数十亿,规模远远超出了过去以PCB为中心的方法所能管理的范围。对于以IP优化方式堆叠的裸晶,现有的PCB工具无法提供帮助。此外,PCB工具不能利用RTL或系统设计决策。现实情况是,单一的设计工具不可能处理3DIC的所有方面(IP、芯片、中介层、封装),这对完整堆栈的组装和可视化提出了迫切的需求。
新思科技3DIC Compiler作为一个为3DIC系统集成和优化而构建的平台可以做到这些。该解决方案专注于多芯片系统,如硅片上芯片中介层(2.5D)、晶片上芯片、晶片上晶片、芯片上芯片和3D SoC。
PPA三要素
通常,在想到大型的复杂SoC时,首先考虑优化的是面积。芯片开发者希望在芯片中集成尽可能多的功能,并提供尽可能高的性能。但随后,所需的功耗和热量始终要符合要求,特别是在移动、可穿戴AR和物联网等应用领域(在数据中心的高性能计算等领域也越来越重要,因为总体能耗也是优先考虑的事项)。实现3D结构使开发者能够持续增加产品的功能,而不会超过占位面积和高度的限制,同时还降低芯片成本。
但是,单独的工具只能解决设计3DIC时的部分复杂挑战。这就形成了巨大的设计反馈回路,无法及时将这些反馈整合在一起,形成每立方毫米最佳PPA的最佳解决方案。在多裸晶环境中,必须对整个系统进行分析和优化。孤立地对单个裸晶进行功耗和热量分析是不够的。更有效的解决方案是采用统一的平台,将整个系统的信号、功耗和热量分析整合到单个紧密耦合的解决方案中。
这正是3DIC Compiler的用武之地——通过一套完整的功耗和热量分析能力实现早期分析。该解决方案通过全面的自动化功能减少了迭代次数,同时提供功耗完整性、热量和噪声感知优化。这有助于开发者更好地了解系统性能,并围绕系统架构、在何处插入TSV以及最高效的裸晶堆叠方法进行探索。另外,它还有助于更有效地了解如何将各种设计要素组合在一起,甚至以某些方式将设计工程师与传统的2D设计技术联系起来。
3DIC是实现每立方毫米最佳PPA的理想平台
通过将硅片垂直堆叠到单个封装器件中,3DIC不断证明其在性能、功耗和面积方面能够持续支持摩尔定律。
尽管使用集成设计平台设计3D架构时会出现新的细微差异,但以最低功耗实现最高性能的可能性使3D架构成为极具吸引力的选择。随着芯片开发者努力实现每立方毫米的最佳PPA,3DIC必将得到更广泛的应用。
编辑:jq
-
芯片
+关注
关注
446文章
47769浏览量
409068 -
存储器
+关注
关注
38文章
7144浏览量
161978 -
3DIC
+关注
关注
3文章
82浏览量
19281 -
PPA
+关注
关注
0文章
20浏览量
7438
原文标题:3DIC为后摩尔时代追求最佳PPA提供理想平台
文章出处:【微信号:Synopsys_CN,微信公众号:新思科技】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
高精度纳米级压电位移平台“PIEZOCONCEPT”!

奇异摩尔与智原科技联合发布 2.5D/3DIC整体解决方案
大算力时代下,跨越多工艺、多IP供应商的3DIC也需要EDA支持
极速智能,创见未来——2023芯和半导体用户大会顺利召开

后摩尔时代,新思科技如何应对IC设计的5大挑战

新思科技3DIC Compiler获得三星多裸晶芯集成工艺流程的认证
PPA分析概述
新思科技携手力积电,以3DIC解决方案将AI推向新高
UCIe为后摩尔时代带来什么?
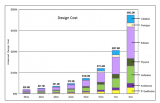
后摩尔时代,从有源相控阵天线走向天线阵列微系统





 3DIC提供理想平台为后摩尔时代追求最佳PPA
3DIC提供理想平台为后摩尔时代追求最佳PPA















评论