当前,电子设备的主要失效形式之一就是热失效。据统计,电子设备的失效有55%是温度超过规定值引起的,随着温度的增加,其失效率呈指数增长。对于很多电子设备,即使是温度降低1℃,也将使设备的失效率降低一个可观的量值。因此,电子设备的热设计越来越受到重视,采用合理的热设计,提高散热系统的性能成为保证电子产品整体可靠性的关键技术之一。
针对封装散热结构优化问题中存在的难点,本文提出了一种基于近似模型和随机模拟的快速全局优化方法。建立封装散热结构的高精度近似模型,能够有效地控制优化设计中仿真分析的重复次数,协调计算成本和计算精度这一对矛盾。随机模拟能够很好地解决混合离散变量优化问题,并且鲁棒性好、全局寻优能力强。最后以方形扁平封装器件(QFP)为例,应用该方法实现了封装散热结构的优化。
1 近似模型
1.1 近似模型的产生
所谓近似模型是指计算量小,但计算结果与仿真程序相近的分析模型。在优化过程中,用近似模型替代仿真程序能够克服计算量过大的问题。构造近似模型需要三个步骤:①根据试验设计生成若干样本点;②用仿真程序(如CFD、FEA等)对样本点进行分析,获得输入/输出数据;③在输入/输出数据的基础上构造出近似模型,如图1所示。为了控制仿真分析的重复次数,本文将建立封装散热结构的高精度近似模型,具体思路是将Kriging建模技术与CVT试验设计相结合。

1.2 Kriging近似模型

式中,F是由样本点处f(x)的值构成的矩阵;R为相关矩阵,即R(i,j)=R(si,sj)。在求解式(3)之前,需要先求出相关函数中的相关参数θ,对它的求解可以转化为如下的优化问题

式中,r(x)为相关向量。与其他模型相比,Kriging模型有以下优势:没有对未知函数的形式作任何限制性假定;能自适应地调整各个样本点上分配的权值;考虑了回归误差项的空间相关性。对Kriging方法更详尽的论述可参阅文献[2-3]。
1.3 CVT试验设计
试验设计是安排仿真试验的方法,它决定了构造近似模型所需的样本点。最近发现,CVT设计的某些性能(样本点分布均匀度、所构造模型的精度)优于流行的拉丁超立方设计。图2对二者进行了比较,为便于观察,以每个样本点为圆心作圆,并且设法保证该圆与以最邻近样本点为圆心的圆外切。图2(b)中各圆半径相差不大,并能覆盖住绝大部分区域,具有很均匀的空间分布特性;而图2(a)中样本点的空间分布特性是很不稳定的。本文采用CVT设计来构造近似模型。
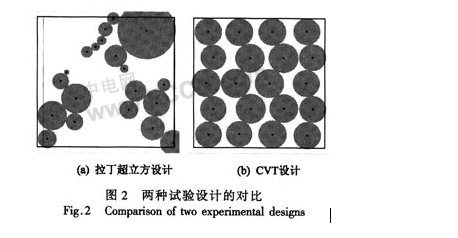
1.4数值算例
根据Jones的建议,以等高线图来评价近似模型的性能。图3(a)为Branin函数,图3(b)为Kriging模型,同时示出CWT样本点。在图3(a)与图3(b)中,等高线的形状和最优点的位置都很接近。图3(c)中的多项式回归模型有严重的形状失真,而且几乎完全遗漏了最优点的位置。图3(d)为RBF神经网络,它稍优于多项式回归模型,但还是不如Kriging模型。因此,在三种模型中Kriging的重构能力最强。
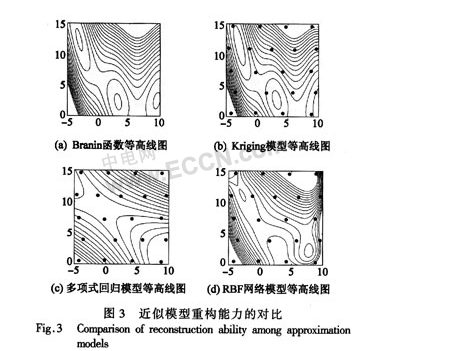
2基于随机模拟的优化方法
随机模拟是目前几种主要的约束非线性离散优化方法之一。它通用性强,对目标函数、约束条件以及离散变量的个数没有特殊要求,并且容易获得全局最优解。但其缺点也很突出,需要成千上万次地求解目标函数,容易造成计算开销过大,该问题可以通过使用近似模型加以解决。近似模型与随机模拟相结合不仅解决了计算量大的问题,而且使它们各自的优势得到了最大程度的发挥,本文采用这一方法来对封装散热结构进行优化。
随机模拟还需要避免重复抽样。重复的试验样本占用了计算时间却不提供有效信息,严重地影响着寻优效率。为解决这一问题,本文在随机模拟中采用了Quasi-Monte Cado法。与经典Monte Carlo法不同,Quasi-Monte Carlo法的抽样过程具有“记忆”特性,它的试验样本是按照拟随机序列选取的,其生成算法保证了试验样本之间总是“尽可能地相互回避”。在抽样的任何阶段,相继的试验样本都“知道”前面的空隙在哪里,从而避免了重复抽样,提高了寻优的效率。
3 应用实例
本文以包含散热系统的方形扁平封装器件为研究对象(图4)。该模型作了如下假设和简化:根据对称性取1/4结构进行分析;对引线和焊点的形态进行了简化;外部的对流换热只以自然对流的方式进行。
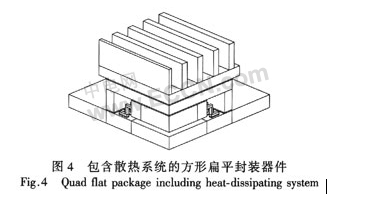
在文献[6]的基础上,本文采用参数化设计语言APDL组织和管理有限元分析命令,使温度场仿真过程实现了完全的参数化,根据几何实体间的相对位置关系来选定需要进行操作的实体。结构的有限元模型如图5所示。

芯片发出的热量在结构中以热传导的形式进行传递,到达外表面后以对流和辐射的形式进行散热。通过温度场仿真,发现作为热源的芯片温度最高,沿着热量传输的路径温度呈下降分布,最高温度出现在芯片的中心,为44.044℃,如图6所示。为了提高芯片的可靠性,充分挖掘散热系统的潜力,本文试图通过改进封装散热结构的设计来降低芯片温度。
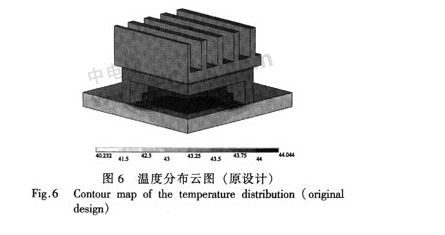
考虑如下设计变量:散热片数量、散热片高度、散热片厚度、热扩展面厚度和热沉基座厚度,其原设计值和参数变化范围如表1所示。以芯片中心温度为优化目标,并施加约束条件,封装总高度不得超过原高度的101%。
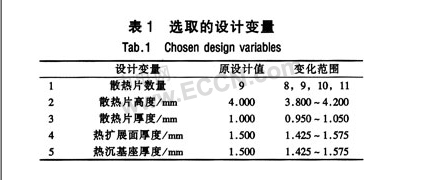
根据Jones的“10倍准则”,调用Researchsampling software工具箱,采用CVT试验设计选取59个样本点,并按照指定格式将其编写成自定义重分析文件。然后ANSYS就可以根据该文件和前面建好的参数化分析流程自动进行重分析,获得相应的输入/输出数据。在这组数据的基础上,调用DACE工具箱,根据Kriging方法构造出封装散热结构温度场仿真的近似模型。
接下来利用随机模拟进行寻优计算。根据Quasi-Monte Carlo法,首先借助Research samplingsoftware工具箱生成5维的拟随机序列,再将其映射到设计空间。然后根据所施加的约束条件,从中挑选出可行解,构成可行试验样本序列。最后,在可行试验样本序列和前面建好的近似模型的基础上进行随机模拟。经过103 884次模拟,得到了优化结果:散热片数量为11,散热片高度为4.20 mm,散热片厚度为1.04 mm,热扩展面厚度为1.44 mm,热沉基座厚度为1.49 mm,此时芯片中心温度的Kriging预测结果为42.319℃。
将上述设计参数代入ANSYS的APDL分析文件,经过温度场仿真,发现芯片中心温度的有限元计算结果为42.324℃(图7),与预测结果十分接近,仅相差0.005℃,这说明所建立的近似模型具有很高的精度。尽管如此,对该模型进行求解所需的时间却很短,超过10万次的求解只需十几秒钟,而在同一PC上进行一次有限元温度场仿真却需要将近4 min。因此使用近似模型代替仿真程序能够大大提高随机模拟优化的计算效率。
优化后封装总高度比原来增加了0.96%,已经基本达到了可行域的边界。优化后的芯片中心温度为42.324℃,相对于原先的44.044℃有了明显的降低。如果需要进一步降低芯片工作温度,可以考虑使用强迫对流换热。
为了进一步验证Kriging近似模型的有效性,从可行试验样本序列中随机选取70个样本作为测试样本,然后分别用有限元程序和Kriging模型对测试样本进行分析,并计算出Kriging预测结果与有限元分析结果之间的差值,该差值就是Kriging近似模型的预测误差。Kriging模型在这70个测试样本上所产生的预测误差Ep如图8所示。

可以看出,Kriging模型在测试样本集合上所产生的最大预测误差也只为0.01~0.012℃,完全能够满足优化设计的需要。
4结论
针对封装散热结构优化问题中存在的难点,提出了一种基于近似模型和随机模拟的快速全局优化方法。建立封装散热结构的近似模型,能够有效地控制优化设计中仿真分析的重复次数。所采用的Kriging模型具有很高的预测精度,数值算例的分析结果表明,它对未知目标函数的重构能力明显高于多项式回归模型和RBF神经网络;同时,具有良好空间均匀性的CVT试验设计使Kriging模型的泛化能力达到了最大程度的发挥。
基于随机模拟的优化解决了设计变量中含有离散变量的问题,在随机模拟中采用了Quasi-Monte Carlo法,有效地提高了寻优的效率。最后以方形扁平封装器件为例,以芯片的中心温度为优化目标,应用该方法实现了封装散热结构的优化,获得了令人满意的结果。近似模型方法很好地协调了优化设计中计算成本和计算精度这一对矛盾,显著地提高了随机模拟优化的计算效率,具有推广应用价值。
编辑:jq
-
芯片
+关注
关注
446文章
47728浏览量
409019 -
电子
+关注
关注
32文章
1728浏览量
88388 -
散热设计
+关注
关注
3文章
40浏览量
17389 -
CVT
+关注
关注
0文章
28浏览量
13184
发布评论请先 登录
相关推荐
关于EAK平面功率电阻的散热?
倒装焊器件封装结构设计

电子封装高散热铜/金刚石热沉材料电镀技术研究

如何优化电源适配器的散热设计?
如何选择符合应用散热要求的半导体封装
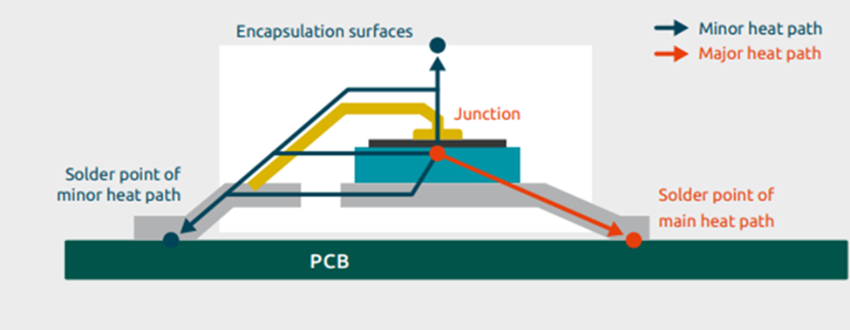
安世|如何选择符合应用散热要求的半导体封装
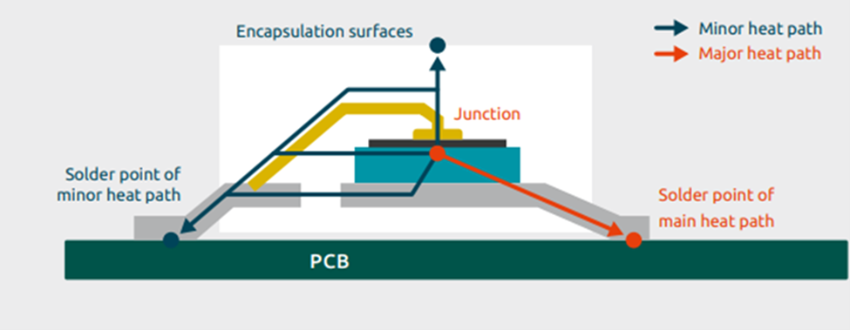
Nexperia(安世半导体):如何选择符合应用散热要求的半导体封装
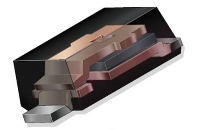
如何解决芯片封装散热问题
插件封装技术VS顶部散热封装技术
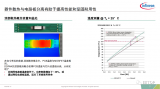
功率器件封装结构散热设计原则
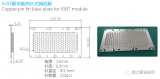




 关于近似模型的电子封装散热结构优化设计
关于近似模型的电子封装散热结构优化设计
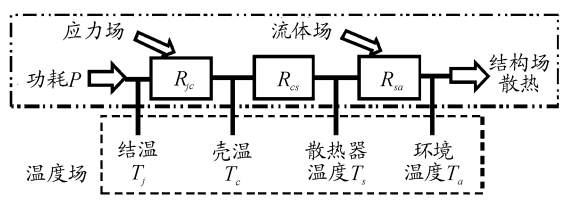
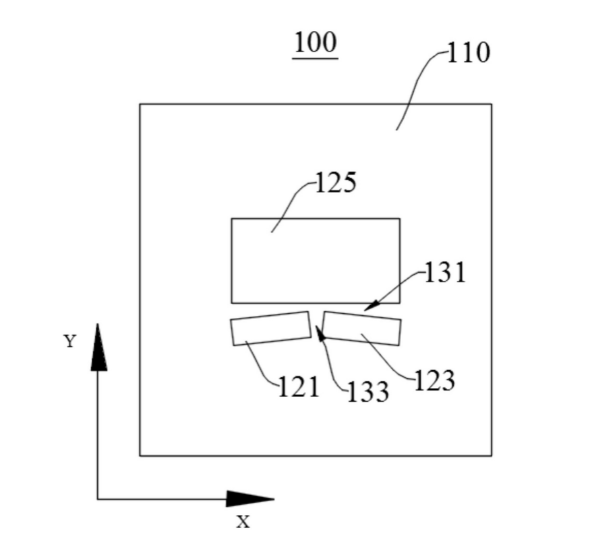

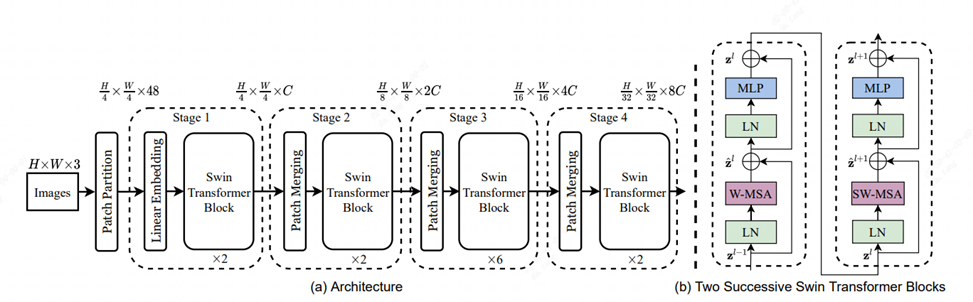











评论