封装技术已从单芯片封装开始,发展到多芯片封装/模块、三维封装等阶段,目前正在经历系统级封装与三维集成的发展阶段。
随着摩尔定律放缓,系统级封装和三维集成通过功能集成的手段摆脱尺寸依赖的传统发展路线,成为拓展摩尔定律的关键,是集成电路技术发展的重要创新方向。
对于三维集成,首先其系统需求要满足高性能、高可靠性、可升级应用的产品,在未来3-5年出现小批量、多品种的需求以及可控的产业链,从而实现系统性能目标,它会涉及到性能指标,包括数据传输速率,时延、插入损耗、功率、标准接口、电性能、可靠性、可用性等。
目前,先进封装与系统集成的核心技术还面临着三大挑战。其一是功能集成提出面向复杂系统级封装的设计与制造;其二是互连密度提升对三维集成和高密度封装基板提出新的要求;其三是前沿基础问题的研究,包括新型层间互连和新型热管理方法等。
在整个产业中,台积电(TSMC)非常重视三维集成技术,将CoWoS、InFO、SolC整合为3D Fabric的工艺平台。蔡坚表示,“从功能提升、成本降低以及工艺兼容来看,台积电之所以有这么多三维集成的工艺出现,在于其对三维集成进行了特别深刻的研究。”
早在10年之前,行业就出现基于硅通孔(TSV)的三维集成。2011年Xilinx采用2.5D Interposer实现FPGA。随后Samsung 、AMD、 Intel、AMD等公司也加速布局。不过,TSV并非三维集成/异质集成的唯一选择。
蔡坚认为,“高深宽比硅通孔(TSV)技术和层间互连方法是三维集成中的关键技术。采用化学镀及ALD等方法,实现高深宽比TSV中的薄膜均匀沉积。并通过脉冲电镀、优化添加剂体系等方法,实现TSV孔沉积速率翻转,保证电镀中的深孔填充。”
在层间互连方法方面,由于高密度集成导致层间互连节距减少。蔡坚教授团队采取窄节距Cu-Sn-Cu扩散键合,对打散机理与微观组织演化的研究,提出了形成稳定界面设计规则,可实现多层/多次键合。
关于技术成果转化,蔡坚表示,我的愿景是成为国内顶尖、国际一流的封装设计与系统级封装一站式服务技术平台,具有完善的封装设计与制作基本能力、集成产品的分析能力,支撑产业链中不同类型企业的需求。
为了更好的转化技术成果,蔡坚教授团队于2020年9月设立公司“清芯集成”,并于10月开始实际运营,其布局领域包括高复杂度处理器、光电封装、量子封装、探测器封装等;2021年计划建成基本架构、完成超净间装修、实现基本封装工艺能力、开展小批量业务。
责任编辑:tzh
-
FPGA
+关注
关注
1602文章
21302浏览量
593101 -
芯片
+关注
关注
446文章
47746浏览量
409031 -
封装
+关注
关注
123文章
7264浏览量
141077
发布评论请先 登录
相关推荐
芯问科技太赫兹芯片集成封装技术通过验收
盛合晶微J2B厂房交付 首批全国产设备助力多芯片集成封装项目扩张
LTCC封装技术研究现状与发展趋势






 蔡坚:封装技术正在经历系统级封装与三维集成的发展阶段
蔡坚:封装技术正在经历系统级封装与三维集成的发展阶段


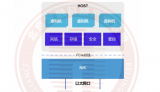
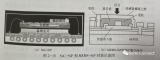





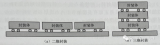










评论