台积电处于芯片加工技术的前沿。他制造了苹果、AMD、英伟达和其他重要的全球芯片品牌,最近有报道称,台积电已开始大规模生产第六代CoWoS晶圆级芯片封装技术,可集成到192GB的内部芯片中。
CoWoS的全名是将芯片和基板封装在一起,可以降低制造难度和成本。这一技术经常用于HBM高带宽存储器的集成封装,而以前的AMD Radeon VII显卡、NVIDIA V100计算卡使用这种封装技术。目前,这一技术仅由台积电掌握,技术细节属于商业机密。
由于这是一个商业秘密,台积电不披露第六代CoWoS的细节,只知道多达12个HBM内存可以集成在一个软件包中。
而最新SK海力士的HBM2E内存利用TSV硅穿孔技术垂直堆叠八颗2GB芯片,从而做到单颗容量16GB,理论上更是可以做到十二颗堆叠、单颗容量24GB。也就说,台积电实际可做到将192GB高速内存封装在芯片内,理论上限是封装288GB内存。
在芯片封装技术方面,产业链人士透露,台积电的第六代CoWoS封装技术有望在2023年大规模投入生产。
责任编辑:YYX
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
台积电
+关注
关注
43文章
5266浏览量
164786 -
晶圆
+关注
关注
52文章
4522浏览量
126416 -
芯片封装
+关注
关注
10文章
397浏览量
30147
发布评论请先 登录
相关推荐

英特尔实现3D先进封装技术的大规模量产
近日,英特尔宣布已经实现了基于业界领先的半导体封装解决方案的大规模生产,其中包括其突破性的3D封装技术Foveros。这项
英特尔实现大规模生产3D封装技术Foveros
英特尔最近宣布,他们已经实现了基于业界领先的半导体封装解决方案的大规模生产,其中包括具有划时代意义的3D封装技术Foveros。
英特尔3D封装技术实现大规模量产
近日,英特尔(Intel)宣布,其已成功实现基于业界领先的半导体封装解决方案的大规模生产,其中包括突破性的3D封装技术Foveros。这一
英特尔实现3D先进封装技术的大规模量产
英特尔宣布已实现基于业界领先的半导体封装解决方案的大规模生产,其中包括英特尔突破性的3D封装技术Foveros,该


化学机械抛光(CMP) 技术的发展应用及存在问题
纳米级[1] 。传统的平面化技术如基于淀积技术的选择淀积、溅射玻璃 SOG、低压 CVD、等离子体增强 CVD、偏压溅射和属于结构的溅射后回
发表于 09-19 07:23
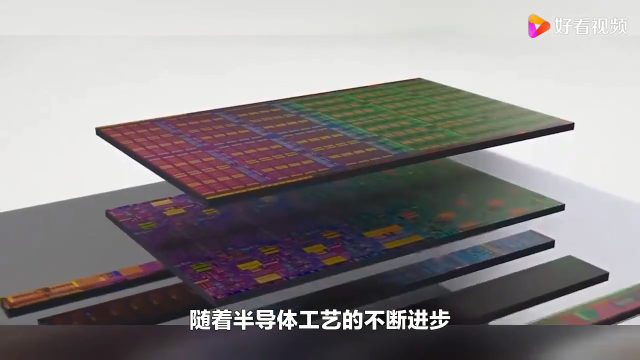
MLCC龙头涨价;车厂砍单芯片;台积电28nm设备订单全部取消!
%。西安二厂预计将生产13.5万片,比之前的14.5万片减少了约7%。业界观察人士认为,三星选择砍掉部分NAND产能,因为当前内存市场形势惨淡。
【台积电28nm设备订单全部取消!】
发表于 05-10 10:54
2023年最强半导体品牌Top 10!第一名太强大了!
,成立于1987年,是当时全球的第一家专业积体电路(集成电路/芯片)制造与服务兼硅晶圆片代工的大型跨国企业。
台积
发表于 04-27 10:09




 台积电已大规模生产第六代晶圆级芯片封装技术
台积电已大规模生产第六代晶圆级芯片封装技术











评论