随着5G新兴市场的发展,对于半导体封装在智能手机,物联网领域的应用提出了很高的要求,对于功能传输效率,噪声,体积,重量和成本等方面要求越来越高。不但尺寸越来越小,厚度越来越薄,还要集成更多的功能和更高的性能。作为先进封装的系统级封装(SIP)是理想的解决方案。系统级封装(SIP)由于可以同时集成很多半导体器件,包括有源器件,控制器,内存等,和无源器件,电阻,电容等,形成具有多功能,高性能的控制系统。随着封装密度的增加,构成SIP封装的半导体元器件尺寸也越来越小,相应的焊盘尺寸和焊盘间距也变得更小。
而在焊接这些元器件时,由于器件的极小尺寸和精密间距,对焊接锡膏提出了很高的要求,尤其是构成锡膏的焊粉,既实现高质量的焊接,改善空洞,减少飞溅。锡珠等带来的短路等焊接缺陷。贺利氏电子推出的基于Welco焊粉制备技术的AP5112 T7 锡膏,不但很好解决了上述技术问题,而且简化了SIP印刷制程,带来一体化解决方案,并且降低封装制程成本和材料成本,提高了良率。
一、SMD和倒装(FC)芯片的一体化印刷方案 传统SIP封装流程如图1所示,印刷完锡膏后,先粘贴无源器件,再通过倒装芯片的铜柱蘸取助焊剂,进行第二次贴装,然后过回流。而使用AP5112 T7,可以简化工艺流程,如图2所示,印刷完锡膏后,可以一次性贴装无源器件和倒装芯片,减少了倒装芯片蘸取助焊剂进行二次贴装的工序;工艺步骤的减少,伴随着良率的大幅提升和封装成本的降低。基板的翘曲和铜柱的高度的共面性差异都会带来焊接的缺陷,通过使用AP5112 T7会很好解决这些问题,提高焊接良率。
图1 传统SIP印刷焊接流程
图2 基于AP5112 T7的一体化SIP焊接流程
二、用于倒装焊接的芯片铜柱去焊锡帽技术 倒装芯片的铜柱技术的发展,相对于植球技术,推动了封装密度的提升和封装的小型化。常规的铜柱技术要在铜柱的顶端进行锡-银的处理,提高了成本和带来共面性问题,如图3所示,使用AP5112 T7 可以省去锡帽的工序,直接引述锡膏进行倒装焊接。同样可以避免基板的翘曲和铜柱的高度的共面性差异等带来的焊接缺陷,因空洞率改善,可以带来4倍良率的提升;因为锡帽工序的省略,可以带来成本15%的降低。
图3 基于AP5112 T7的一体化SIP焊接流程 上述不论是在SIP封装良率的提升、成本的降低和工序的简化,都和构成AP5112 T7的焊粉和锡膏的特性分不开的。 三、AP5112T7锡膏的特点1、Welco焊粉技术 焊粉的品质在锡膏的特性中起着至关重要的作用,不论是在作业性,还是飞溅、锡珠、空洞率的管控和多次回流的表现。图4列出了AP5112 T7焊粉Welco技术相对于传统焊粉的不同,通过熔融金属液体和油的表面张力的差异和工艺参数的调整,得到不同粒径的粉体,极窄的粒径分布,光滑的表面,无表面损伤和氧化。
图4 独特的Welco焊粉制作技术 2、AP5112 T7锡膏特点 形成锡膏后,锡膏的良好物性稳定,带来稳定的印刷作业性,如图5,图6.
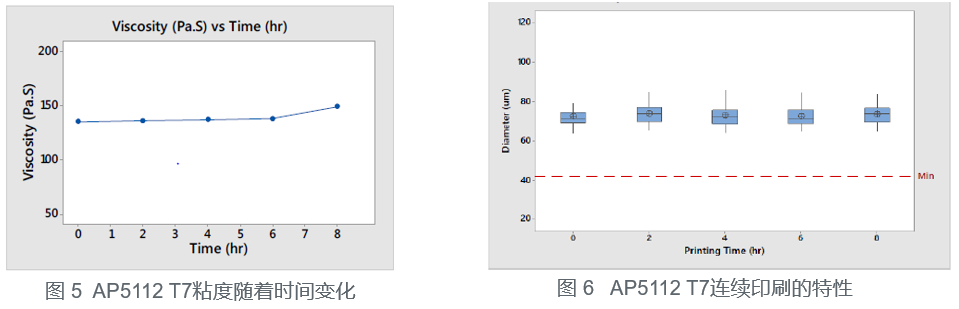
在不同基板表面,ENIG, OSP和浸锡表面,都有很好的润湿性,不论是在T0和8小时后。
图7AP5112 T7 在不同基板表面的润湿情况 两次回流后,空洞型对于其他型号具有很好的表现。

图8 多次回流后空洞表现
图9和图10是倒装芯片和008004刷完锡膏后,贴片前的表现,可以看到印刷的一致性,没有连桥和印刷不完整的缺陷。
图11和图12是倒装铜柱和008004回流后的表现;倒装芯片铜柱和焊盘准确的对准,无偏移和良好的共面性;008004没有飞溅,立碑和焊盘终端的高度一致性。
图13和图14是回流后的x-ray照片,空洞率小于1%。 四、AP5112 T7的应用 进入5G时代,智能手机中的RF数量大幅增加,在手机轻薄化趋势下,SIP获得广泛使用;射频前端模组在使用复杂的SIP的架构,单个封装中包含10-15个器件(开关,滤波器,功率放大器)和几种类型的互联技术(引线键合,倒装芯片,铜柱),高密度,高集成化,以实现最小化信号路径和低损耗的控制。
图15是手机射频前端结构示意图和典型SIP封装结构图。接收路径的低噪声放大器(LNA)和发送路径的功率放大器(PA)经由双工器(Duplexer)连接到天线,双工器分开两个信号,并防止相对强大的PA输出使灵敏的LNA输入过载。
目前AP5112 T7已经被国内外数十个顶级品牌新出品的5G手机应用在射频前端SIP封装中。
责任编辑:xj
原文标题:应用于先进封装印刷工艺的贺利氏一体化解决方案
文章出处:【微信公众号:电子发烧友网】欢迎添加关注!文章转载请注明出处。
-
封装
+关注
关注
123文章
7264浏览量
141077 -
焊接
+关注
关注
38文章
2746浏览量
58194 -
sip封装
+关注
关注
4文章
62浏览量
15397
原文标题:应用于先进封装印刷工艺的贺利氏一体化解决方案
文章出处:【微信号:elecfans,微信公众号:电子发烧友网】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐

鸿蒙原生应用/元服务开发-新版本端云一体化模板体验反馈
物联网应用之智慧档案馆八防十防一体化平台










 SMD和倒装(FC)芯片的一体化印刷方案
SMD和倒装(FC)芯片的一体化印刷方案












评论