来源:半导体行业观察
在过去十年中,晶圆级封装(Wafer level packaging:WLP)引起了人们的极大兴趣和关注,因为半导体行业继续推动以移动和消费领域为主导的一代又一代的更高性能,但由于摩尔定律在7纳米以下变得越来越困难而继续放慢速度,因此后端封装工艺对于满足对低延迟,更高带宽和具有成本效益的半导体器件的需求变得越来越重要。
本文探讨了WLCSP和扇出封装的当前市场动态,研究了WLCSP和扇出市场所涉及的供应链和主要参与者,并试图提供晶圆级封装的未来增长方案,尤其是扇出封装。它还描述了面板级别封装的驱动动力以及关键参与者之间面板级别制造的当前状态。本文还将探讨诸如chiplets 之类的新趋势。与此同时,包括英特尔和台积电(TSMC)在内的IDM如何在未来几年内继续使用扇出工艺作为异构解决方案的推动者,不断突破新的界限。
FO和WLCSP封装
FO(扇出)封装始于几年前,其应用受到限制,但作为成熟,可靠的封装技术,它已经在高端封装领域中发挥了关键作用和应有的地位。实际上,随着苹果公司采用InFO-PoP方法推出A10,台积电(TSMC)的InFO外形在2015/2016年使FO技术达到了新的高度。FO封装主要用于移动和消费类产品,在汽车雷达中也有一定的应用。FO封装预计将在未来几年内随着5G,AI和自动驾驶飞行的普及而获得广泛采用,FO封装带来的收入预计到2025年将达到25亿美元。WLCSP封装市场还发现了一个新的“ M系列”该产品可提供6侧模具保护,并具有卓越的板级可靠性(BLR)性能。
WLCSP扇入式封装市场动态
WLCSP封装在2019年创造了创纪录的收入,达到20亿美元,预计未来五年的复合年增长率为5%(图1)。智能手机OEM厂商继续为许多芯片(例如PMIC,音频编解码器模块,RF收发器,NFC控制器,连接模块和许多其他应用)使用WLCSP封装。WLCSP市场由ASE,Amkor,JCET,SPIL等顶级OSAT占据主导,其次是台积电,三星,中国OSAT等代工厂商,以及少数IDM厂商。由于物联网需求的增长以及智能手机生态系统中采用更多WLCSP封装的推动,顶级OSAT会继续在2020年投资更多的WLCSP和不断发展的基础设施。

图1. 2015-2019年扇出包和WLCSP收入。
随着新采用WLCSP尺寸规格已在所有智能手机中得到广泛采用,2020-2025年,这个市场的前景仍然保持强劲。到2025年,WLCSP市场预计将增长到30亿美元的规模。封装供应商将继续享受各种设备对8英寸和12英寸WLCSP的强劲需求。WLCSP已成为移动/消费应用的主流“主力”封装技术,与基于基板的封装相比,它提供了成本最低的解决方案。与引线键合配置相比,在未来五年中,RF组件也可能过渡到WLCSP类型的平台,因为通过基板优化,它可以总体上降低模块成本。
扇出封装市场动态
FOWLP封装在2019年产生了13亿美元的收入,因为半导体行业在2019年的2H复苏,这就带来了非常强劲的OSAT需求(图1)。与2018年相比,2019年的FO(Fan-out)封装收入略有下降,但是,TSMC继续通过InFO封装和InFO-AiP封装来支持Apple应用处理器,并在2020年2月上市,以支持5G苹果手机。
2020-2025年的扇出式配套前景仍然健康(图2)。在未来五年中,扇出封装的复合年增长率预计将达到11%,这主要是由台积电将InFO提供给iOS生态系统所推动的,以及未来几年除苹果之外,其他顶级手机OEM厂商将更多采用HDFO(High-Density Fan Out:高密度扇出)设计。扇出封装市场预计到2025年将增长到25亿美元。扇出封装配置继续与更传统的基于fcCSP的设计竞争,因为后者提供了更可靠,成本更低的解决方案。扇出仍然是一项利基技术,只有诸如台积电,三星,ASE,JCET和PTI等主要参与者(图3)。
5G mmWave的采用可能有助于增加扇出封装的数量,特别是对于OSAT细分市场(RF细分市场)。核心FO增长缓慢,并有望保持稳定,因为扇入式WLCSP和更可靠的fcCSP配置可以满足许多设备要求。随着越来越多的手机OEM厂商希望为应用处理器采用HDFO平台,扇出资本支出预计将增长,台积电资本支出预计还将激增

图2. 2019-2025年扇出市场的演变

图3.每个市场的扇出封装市场动态。
面板级市场动态
FO-PLP技术主要由Semco,三星电子,PTI和ASE / Deca Technologies驱动,约有3%的封装将于2019年在面板生产线生产,预计到2025年将增长到7.5%,而Semco在2019年中将其FO PLP生产线出售给三星电子。
三星将优化最近购买的Semco生产线,以在扇出配置上增加其他封装产品线,并可能在2020年出现拐点。随着日月光采用600×600的高品质面板生产线,OSAT行业正在缩小面板尺寸的过程。三星电子通过PLP平台支持其Galaxy手表,并有可能将其扩展到移动平台设备,并与台积电竞争提供后端解决方案。
三星将继续充分利用从Semco购买的面板产品线,并计划在2021年及以后使用扇出设备,并不再使用Semco面板产品线,而将重点放在中端智能手机APU上。PTI承诺在2020年实现重大的资本支出,以更加分散的多芯片集成为重点,扩大基于扇出的封装的面板制造。
台积电“all-in”
台积电(TSMC)在2020于高级封装业务方面投入空前的15亿美元 CapEx投资,专门面向SoIC,InFO变体和CoWoS产品线,估计InFO(PoP / AiP / OS / MS)产品线的价值约为3亿美元。台积电于2016年开始在InFO平台上生产Apple APU,这打破了供应链的固有平衡,因为基板供应商和OSAT将该Apple APU业务输给了台积电。台积电继续凭借其InFO产品线,“涉足”苹果APU PoP组装的传统OSAT业务以及5G苹果手机的天线封装模块。英特尔最近推出了使用“小芯片”型面对面互连方案的Co-EMIB架构,该架构将用于移动和高性能应用。
晶圆级封装的供应链
WLCSP封装市场由ASE,Amkor,JCET和SPIL等顶级OSAT主导(图4)。8英寸WLCSP继续保持高产量,因为许多器件不需要高度先进的硅节点。WLCSP服务包括凸块和冲模处理服务,并且可以将测试作为一揽子业务包括在内。大多数WLCSP封装使用1L RDL结构,而很少使用2L RDL配置。在未来五年中,随着更多功能设备在智能手机生态系统中转换为WLCSP平台以及物联网基础设施的快速增长,顶级OSAT将对WLCSP封装产生更高的需求。

图4.每个玩家的WLSCP和扇出封装市场动态。
相反,扇出级封装的供应链仍然很复杂(图4)。台积电在提供高密度解决方案(例如用于Apple AP解决方案的InFO-PoP)方面继续享有其优越的地位,并不断完善其工艺和代代相传的封装产品。在这方面,台积电正在为苹果AP设备以及计划于今年晚些时候在苹果5G手机中使用的内置天线(AiP)设备占据OSAT和基板供应商的市场份额。
台积电在提供“一站式”服务对基板和OSAT参与者的业务产生影响方面的进步表明,晶圆厂和OSAT之间的界线继续变得模糊。三星仍然是另一家高密度扇出技术玩家,该公司最近收购了Semco的PLP系列,并且极有可能被用于为其智能手机领域生产更多扇出高集成度封装。
ASE和JCET仍然是扇出封装解决方案的强大OSAT参与者,提供多芯片SiP型封装和ASE针对高端应用的FoCoS产品阵容。随着越来越多的手机OEM计划在未来几年内采用该平台,PTI将继续投资其PLP系列产品,以期进入高密度应用领域。图5显示了领先的半导体公司选择的扇出式封装平台及其主要功能。

图5.领先的半导体公司选择的扇出封装平台和主要功能。
新型扇出封装展望
在过去的几年和未来几年中,我们期望新颖的扇出封装外形,例如具有6S(6面)保护设计的Deca M系列(图6)将因其卓越的BLR(板级可靠性)而广受欢迎。台积电的InFO产品系列还将包括InFO-PoP,InFO-MS和InFO-OS,以及InFO-AiP封装。台积电先进的封装路线图提供了对未来的了解,因为它计划将SoIC(集成芯片系统)用作针对移动和高端应用的下一个集成解决方案。
图6. ASE / Deca M系列扇出技术用于侧壁保护。
台积电于2016年至2019年在InFO-PoP平台上成功制造了APU。未来几年,随着小芯片设计方法和异构集成趋势的发展,台积电计划在各种移动和高端应用上实施SoIC(集成芯片系统),以实现5G计算和HPC新应用所需的性能。台积电SoIC设计有潜力使其他业务从OSAT吞噬掉,用于FO-SiP应用。
除了通过InFO封装增加iOS生态系统内容外,随着小型化和更高带宽的竞争,台积电还可能通过扇出平台为APU模块采用更多的手机OEM客户。总之,凭借其成熟的InFO产品阵容,以及在未来3-5年内随着小芯片范例的转变而增加的对SoIC封装基础设施的投资,
扇出封装可实现小芯片和异构集成
展望未来五年,异构集成趋势将加剧,以支持5G,人工智能和物联网大趋势。扇出工艺和技术是高级后端集成的基础,并将成为未来小芯片类型异构集成的推动力。英特尔,台积电和三星将继续推动技术进步,以实现未来的各种3D IC异构集成封装设计。在实现高密度异构集成的竞赛中,OSAT还将在未来几年内提升其在这个利润丰厚的高端高级封装市场中竞争的能力。
-
半导体
+关注
关注
327文章
24466浏览量
201994 -
晶圆
+关注
关注
52文章
4519浏览量
126409 -
封装
+关注
关注
123文章
7262浏览量
141075
发布评论请先 登录
相关推荐






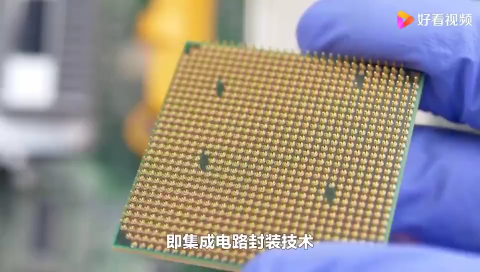
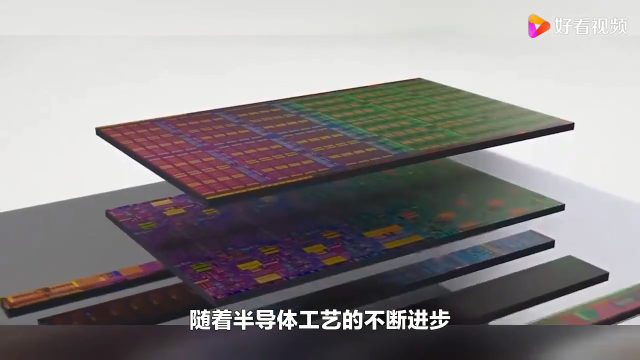






 晶圆级封装的未来增长方案
晶圆级封装的未来增长方案










评论