正确设计BGA封装
球栅数组封装(BGA)正在成为一种标准的封装形式。人们已经看到,采用0.05至0.06英寸间距的BGA,效果显著。封装发展的下一步很可能是芯片级封装(CSP),这种封装外形更小,更易于加工。
BGA设计规则
凸点塌落技术,即回流焊时锡铅球端点下沈到基板上形成焊点,可追溯到70年代中期。但直到现在,它才开始快速发展。目前,Motorola、IBM、Citizen、ASAT、LSI Logic、Hestia和Amkor等公司,除了在自己的产品中使用这种封装,还提供BGA商品。
BGA的另一个主要优势是成品率高。Motorola和Compaq等用户声称,在其包含160至225条I/O引线的0.05英寸间距封装中,没有缺陷产生。而其它的全自动工厂中,具有相同I/O引线数的细间距器件的失效率为500或1000PPM。目前正在进一步开发具有400到700条I/O引线的BGA封装,日本甚至报道了1000条I/O引线BGA封装的研发结果。目前,标准还没有完全制定好,JEDEC文件仅对1mm、1.27mm和1.5mm间距作了基本规定。基体的尺寸范围为7至50mm,共面性小于200μm。
BGA的局限性
许多用户抱怨BGA焊点可视性差。很明显,BGA的焊点不能藉由肉眼检测。实际上,由于零配件引线数不断增加,任何现代电子组装制程都会出现这种情况。采用低成本的X射线装置,以及良好的设计规则,可以进行相对简单的检测。
现在的布线设计(footprint)包括印制导线组合、通孔和0.02英寸的圆形表面焊盘。器件上焊球的大小必然会影响焊盘尺寸。最初,一些工程师在焊盘表面贴上阻焊膜,以此减小回流焊期间器件的移动和焊膏的流动。采用这种方法,在加热过程中焊点容易开裂,因此不可取。
如果铜焊盘与阻焊膜涂层之间为标准间隙,则应采用标准阻焊膜设计规则。需要时,这种简单的布局允许在印制板两个表面走线。甚至间距为1或1.27mm的、I/O数较多的器件,焊球之间都会出现走线问题。选择间距较小,但中心“空白”(即无焊球)的器件,可克服这种问题。中心空白的BGA外边缘可能只有四列焊球,减少了走线问题。
通孔贴装
一些公司使用传统的通孔,作为陶瓷BGA和更常用的塑料器件的贴装焊盘。这时,通孔成了贴装焊盘和穿过印制板的互连体。这对于回流焊设计是理想的,但对波峰焊产品却不然。切记:波峰焊作业会引起印制板顶部BGA的二次回流。
使用通孔贴装方法时,要确保通孔的体积与焊膏的印刷量相匹配。采用这种技术,焊膏将填满通孔,并在回流焊后仍提供相同的托高(standoff)。如果不考虑这个重要因素,焊球部份将会沈入焊点中。对于陶瓷BGA,高温焊球只能位于通孔的表面。当通孔尺寸减小时,问题就没有那么严重了。但是内部走线时,它确实会影响复杂的多层印制板的走线。
藉由与所选测试焊盘相连的通孔的顶部,可对印制板的底部填充物进行测试。一些情况下,零配件制造商在BGA封装基板的顶部设置测试点,以便对封装表面直接进行探测。如果在组装作业中使用通孔贴装,藉由直接探测通孔即可进行测试。
谨防翘曲
在回流焊期间,较大的塑料封装可能会产生翘曲。一些情况下,会看到覆层(over-moldingcompound)和基板产生了翘曲,这会导致外部连接点与焊盘的接触减至最小。一些工程师指出,小片(die)和玻璃环氧树脂基板均会产生翘曲。藉由改进零配件的球形端点的布局,并限制所用小片的尺寸,可在一定程度上克服这种问题。如果使用焊膏,而不只是助焊剂回流制程,发生这种特殊故障的可能性就会减少,这是因为焊膏对共面性的要求较低。
对于传统的玻璃/环氧树脂基板,使用无引线塑料BGA,就不会产生焊接故障。因为零配件基体也是由相似的环氧树脂制成的,并且热膨胀系数与大多数应用相匹配。在一些专门应用中,器件转角处的焊点会出现裂缝,这可能是因为此处产生了应力。
对于塑料BGA器件,则可能出现“爆米花”式的裂缝。因为在回流焊期间,潮气会在零配件内部扩张。此时,基板和覆层之间的器件边缘就会出现裂缝。如果在返修期间出现这种现象,就会听到器件发出“劈、啪”的爆裂声,因此称为“爆米花”。所以,必须选择适当的防潮封装,以减少爆裂的可能性。
-
pcb
+关注
关注
4215文章
22442浏览量
385226 -
BGA
+关注
关注
4文章
503浏览量
45995 -
华强pcb线路板打样
+关注
关注
5文章
14629浏览量
42567
发布评论请先 登录
相关推荐
浅谈BGA、CSP封装中的球窝缺陷
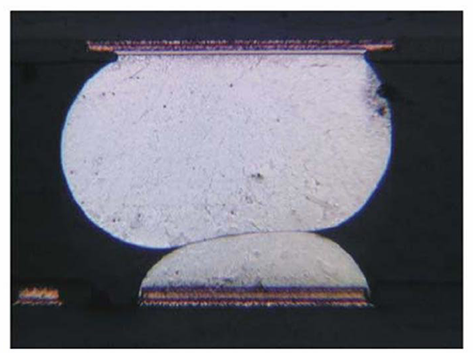
使用STM来测量出来的ADC0的转换时间抖动很大是为什么?
请问AD8138的负电压可以由哪一些负电压芯片提供?
BGA芯片封装和IC芯片封装在不同应用场景下的适用性
BGA封装设计与常见缺陷
必备的常见芯片封装
什么是bga封装 bga封装工艺流程

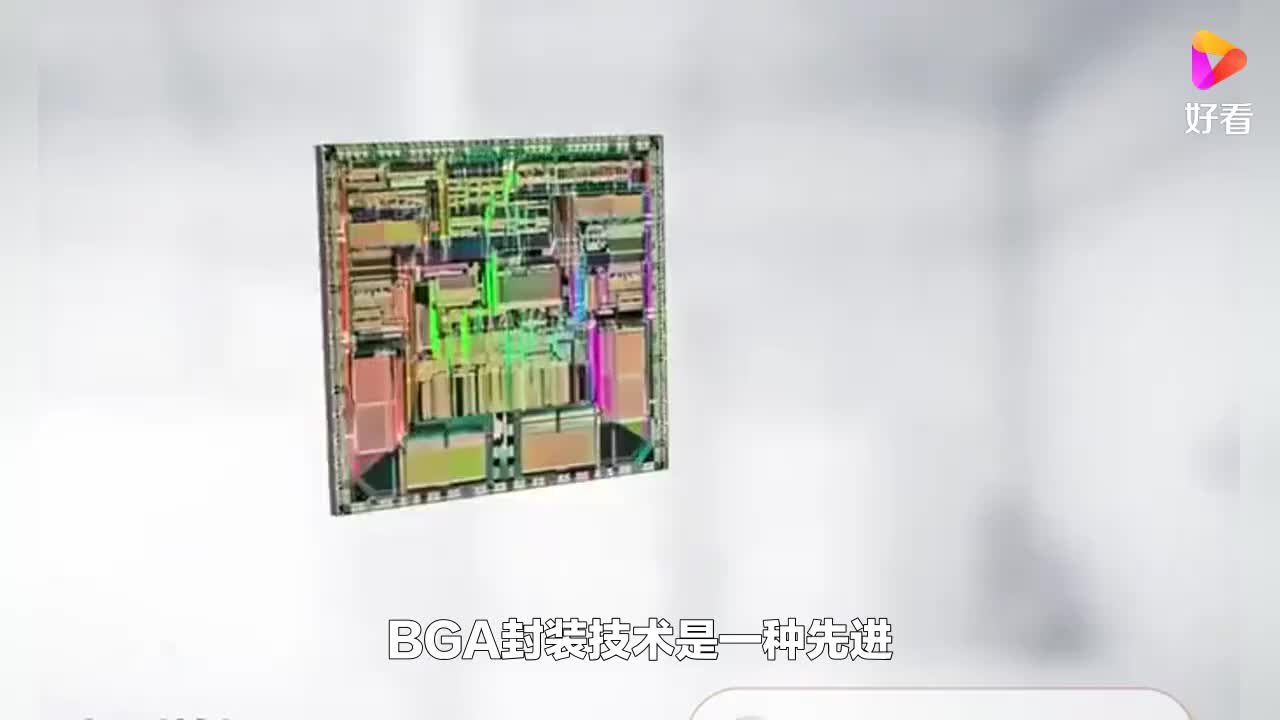




 BGA封装有哪一些常见的缺陷
BGA封装有哪一些常见的缺陷

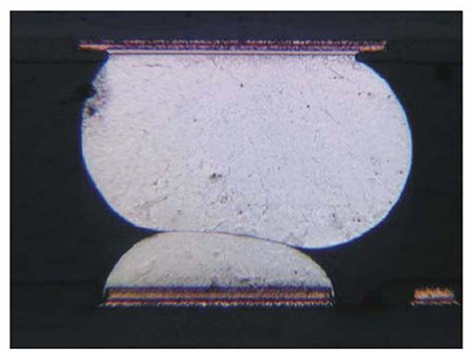


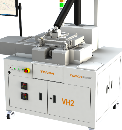










评论