不要让你忘记IC封装的重要性。以下是Microchip 2005产品选择器中的几个卡:


虽然大多数设计工程师都在使用表面贴装部件,但请注意,Microchip仍然会为业余爱好和传统市场销售DIP封装部件。
在我的办公桌上筛选时,我遇到了一些带有各种IC封装的物理卡。它们相当古老,但仍然是一个很好的参考。这是我从安森美半导体获得的一张卡片:
它永远不会让我惊讶于小型电子零件的变化。我已经老了,还记得引入表面贴装零件的时候。许多工程师都拒绝,特别是因为较小的部件更难以原型和焊接。一个问题是精确度;较小的部件在模塑过程中会对模具施加更大的压力。这意味着许多部件在较小的封装中对同一芯片的规格较差。还存在可靠性问题,其中水分会在销钉上蠕动并导致可怕的“紫色瘟疫”,即粘接线和垫的腐蚀:
很快,大多数工程师意识到小型封装比问题更有利,特别是在制造商用更好的塑料和先进的成型技术解决了可靠性和精度问题之后,结合后包装修剪。在工程师解决了原型设计难度后,我们学会了喜欢小尺寸。低安装高度意味着电路板可以在复杂系统中更紧密地嵌套在一起表面贴装封装更能抵抗振动问题。这使得工业设备设计师成为支持者。一旦我们的原型投入生产,我们看到我们可以放置多少更紧密的组件,因为没有通孔遮挡了电路板背面的迹线路径。
以下是MCC的另一个示例封装卡。很高兴看到公司认识到该软件包有时是系统设计工程师最关键的选择标准。通常情况下,IC设计师如此统治半导体公司,他们认为唯一重要的是芯片,而不同的封装模具几乎无关紧要。使用Cadence,Mentor Graphics,Synopsis和其他工具的优秀工具,IC设计变得更加容易。封装设计仍然非常复杂,使用较小的封装和更粗糙的无铅焊接温度曲线变得越来越难。
高速部件受到影响包裹。工程师们首先开始在离散逻辑数字IC中看到这种情况。当IC产生快速脉冲时,引线框架的电感导致接地参考电压“跳变”。这是爱表面贴装零件的另一个原因。较小的物理尺寸意味着引线中的电感较小,因此与早期精密模拟部件不同,表面贴装封装中的高速数字部件得到了改进。
德州仪器的这种封装卡是我见过的最好的封装卡。很抱歉,在拍摄好照片之前,我把它送走了。它有许多逻辑封装,对于理解更高引脚数部件的不同封装有很大帮助。如果有人有,请拍一些内部照片,然后邮寄给我,我会将照片添加到此博客中。 TI是封装设计的主要创新者,也是几十年前首次发现地面反弹问题的人。
随着半导体行业的成熟,我希望对IC设计师的崇拜有所消退,并且公司意识到团队中的所有工程师都是摇滚明星,将极其复杂和先进的产品推向市场。这包括设计包的ME,系统级应用工程师,测试工程师和制造工程师。确实需要一个村庄。如果您认为机械工程师没有IC设计师那么强硬,这里有一个关于在大型网络服务器/路由器公司工作的朋友的故事。
我的朋友安迪·马斯托(Andy Masto)现在是一名顾问,他的管理层告诉他,服务器中的巨型自定义CPU耗散了228W。这对他来说是一个关键的规范,因为他必须设计所有的冷却和气流。他知道他的管理层是,让我们称他们乐观,因为无能为力是一个粗鲁的词。因此,他没有相信马斯托认为太低的228W数字,而是走向电源设计小组。他告诉他们他们设计的CPU功率是多少。他们回答说,“318瓦特。”对于Masto知道新处理器的性能水平来说,这听起来更合理。他的问题是BGA(球栅阵列)封装非常庞大。他必须保持尽可能低的温度,否则BGA和PCB之间的热膨胀差异将导致IC从板上撕下来。 Masto感谢电源组给他小费,并告诉他们他的粉丝需要更多的电力。碰巧的是,CPU的功率大约为310W - 远高于最初的228W估计值。这是系统人员的重要技能之一,可以保持小组之间的沟通,使他们聚合在一个有效的设计上。
当我打电话给Masto以刷新我对这个事件的记忆时,他指出,“问题是现代BGA源于芯片越来越大以及需要更多焊球来处理这些大型芯片的I/O,电源和接地。模具现在一侧为20至25mm,通常需要2500个焊球。结果,BGA封装已经发展到55平方毫米,这会导致许多封装和散热问题。“焊球的这些问题使我意识到为什么英特尔将其商用CPU放入带引脚的封装中。插座中的插针提供了允许部件热膨胀所需的合规性。
Masto还告诉我另一个问题。他说,使用这些高功率部件,您需要在散热器上施加非常高的压力,以便从封装中获得可接受的热量传递。问题是这些高压会导致焊球随着时间的推移变平,Masto称之为“蠕变”现象。最终,相邻的焊球将会接触,这称为“焊料桥接”.Masto指出,“BGA焊球间距通常是1毫米(0.0394英寸),球约0.65毫米(0.0256英寸)。由于它们之间的间隙很小,因蠕变引起的焊接桥接是一个真正的问题并导致故障。更糟糕的是,在您将系统投入使用后可能会发生一年或更长时间。这很难诊断;你需要一台X光检查机才能看到它。“Masto使用非线性有限元分析来优化散热器安装,避免由于蠕变引起的焊接桥接。
只需将BGA正确安装在生产中就会很麻烦,尤其是无铅焊料需要更高的温度。 Dage Precision Industries的X射线系统产品经理David Bernard博士指出,随着水变成蒸汽,包装中的水分会导致“爆米花”。这种扩展会使封装失效,从而导致您在上面看到焊料桥接。而桥接只是一个极端。您还必须确保所有球接触并焊接PCB上的焊盘。这就是为什么平面性对于具有BGA的PCB而言非常重要的原因。 HAL(热空气调平)可能不够平坦,无法使大型BGA成功焊接。您可能需要指定浸金涂层,这样您就可以利用PCB层压板的自然平整度。像Ken Bahl团队在Proto Express上的专家可以引导您正确地进行高性能PCB设计。在进行PCB设计之前,您应该与您的工厂房子交谈,并确保您的组装厂有X射线检查。像Screaming Circuits这样的全方位快速装配车间将确保他们不仅可以安装BGA,还可以对其进行测试,然后重新加工。它们就在Sunstone的街道上,这是另一个可以处理复杂木板的工厂就像我说的那样,不要四处思考另一个人的工作很容易,只有你有困难。关于高科技的一切都很难。这就是为什么你必须确保团队中的每个人都知道设计的发展方向。
-
IC
+关注
关注
35文章
5526浏览量
173117 -
PCB打样
+关注
关注
17文章
2965浏览量
21371 -
华强PCB
+关注
关注
8文章
1831浏览量
27455 -
华强pcb线路板打样
+关注
关注
5文章
14629浏览量
42564
发布评论请先 登录
相关推荐
一文解析IC封装形式的散热改善方式及效果
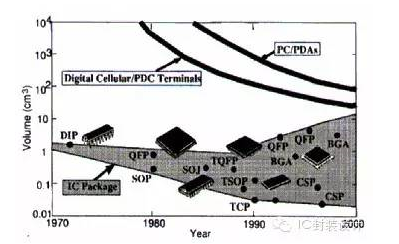
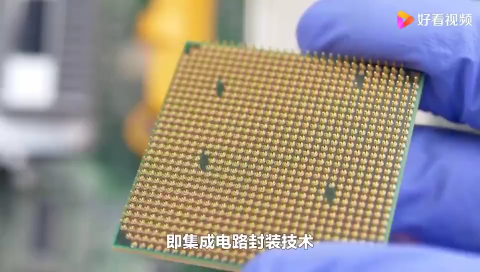
谈谈LED显示屏驱动IC的QFN封装
失效分析的重要性
IC封装/PC电路板设计进行散热完整性分析
IC封装的热特性





 IC封装和散热设计简介 IC封装的重要性依然不小
IC封装和散热设计简介 IC封装的重要性依然不小


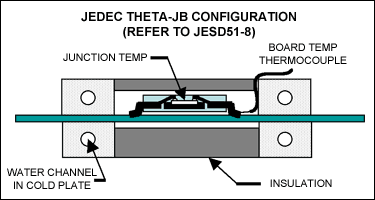
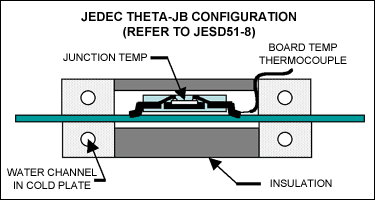










评论