QFN焊点的检测与返修
QFN焊点的检测与返修
(1)焊点的检测
由于QFN的焊点是在封装体的下方,并且厚度较薄,X-ray对QFN焊点少锡和开路无法检测,只能依靠外部的焊点情况尽可能地加以判断,但目前有关QFN焊点侧面部分缺陷的断定标准尚未在IPC标准中出现。在暂时没有更多方法的情况下,将会更多倚赖生产后段的测试工位来判断焊接的好坏。
从图6中的X-ray图像可见,侧面部分的差别是明显的,但真正影响到焊点性能的底面部分的图像则是相同的,所以这就给X-ray检测判断带来了问题。用电烙铁加锡,增加的只是侧面部分,对底面部分到底有多大影响,X-ray仍无法判断。就焊点外观局部放大的照片来看,侧面部分仍有明显的填充部分。
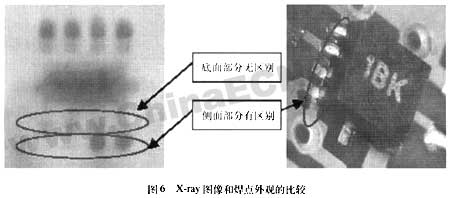

(2)返修
对QFN的返修,因焊接点完全处在元件封装的底部,桥接、开路、锡球等任何的缺陷都需要将元件移开,因此与BGA的返修多少有些相似。QFN体积小、重量轻、且它们又是被使用在高密度的装配板上,使得返修的难度又大于BGA。
当前,QFN返修仍旧是整个表面贴装工艺中急待发展和提高的一环,尤其须使用焊膏在QFN和印制板间形成可靠的电气和机械连接,确实有一些难度。目前比较可行的涂敷焊膏方法有三种:一是传统的在PCB上用维修小丝网印刷焊膏,二是在高密度装配板的焊盘上点焊膏(如图8);三是将焊膏直接印刷在元件的焊盘上。上述方法都需要非常熟练的返修工人来完成这项任务。返修设备的选择也是非常重要的,对QFN既要有非常好的焊接效果,又须防止因热风量太大将元件吹掉。
QFN的PCB焊盘设计应遵循IPC的总原则,热焊盘的设计是关键,它起着热传导的作用,不要用阻焊层覆盖,但过孔的设计最好阻焊。对热焊盘的网板设计时,一定考虑焊膏的释放量在50%~80%范围内,究竟多少为宜,与过孔的阻焊层有关,焊接时的过孔不可避免,调整好温度曲线,使气孔减至最小。QFN封装是一种新型封装,无论是从PCB设计、工艺还是检测返修等方面都需要我们做更深入的研究。
QFN封装(方形扁平无引脚封装)具有良好的电和热性能、体积小、重量轻、其应用正在快速增长,采用微型引线框架的QFN封装称为MLF封装(微引线框架)。QFN封装和CSP(芯片尺寸封装)有些相似,但元件底部没有焊球,与PCB的电气和机械连接是通过PCB焊盘上印刷焊膏、过回流焊形成的焊点来实现的。
非常好我支持^.^
(1) 50%
不好我反对
(1) 50%
相关阅读:
- [电子说] 怎样延长半导体元器件的寿命呢? 2023-10-24
- [电子说] QFN上锡不饱满的难点分析与解决方案 2023-10-18
- [电子说] QFN器件封装技术及焊点可靠性研究进展 2023-10-18
- [电子说] 艾为电子推出超低导通电阻的双通道单刀双掷模拟开关-AW35321QNR 2023-10-18
- [电子说] 常见的OTP语音芯片的封装形式列举 2023-10-14
- [电子说] PY32F071 系列单片机,QFN48封装只要1.85元 2023-10-14
- [电子说] 英飞凌推出先进的OptiMOS™功率MOSFET,进一步扩大采用PQFN 2x2 mm²封装的MOSFET器件 2023-10-13
- [电子说] 量产与客制化键盘的EMC差异有哪些? 2023-10-10
( 发表人:admin )
