CBGA(陶瓷焊球阵列)封装及其优/缺点
在BGA封装系列中,CBGA的历史最长。它的基板是多层陶瓷,金属盖板用密封焊料焊接在基板上,用以保护芯片、引线及焊盘。焊球材料为高温共晶焊料10Sn90Pb,焊球和封装体的连接需使用低温共晶焊料63Sn37Pb。其封装结构如图3,封装体尺寸为10-35mm,标准的焊球节距为1.5mm、1.27mm、1.0mm。
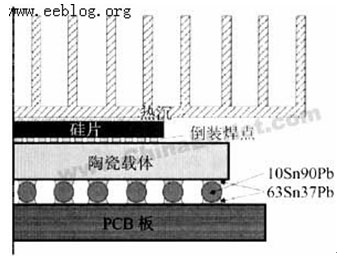
图3 CBGA的封装结构
CBGA(陶瓷焊球阵列)封装的优点:
1)气密性好,抗湿气性能高,因而封装组件的长期可靠性高。
2)与PBGA器件相比,电绝缘特性更好。
3)与PBGA器件相比,封装密度更高。
4)散热性能优于PBGA结构。
CBGA封装的缺点是:
1)由于陶瓷基板和PCB板的热膨胀系数(CTE)相差较大(A1203陶瓷基板的CTE约为7ppm/cC,PCB板的CTE约为17ppm/笔),因此热匹配性差,焊点疲劳是其主要的失效形式。
2)与PBGA器件相比,封装成本高。
3)在封装体边缘的焊球对准难度增加。
(3)CCGA(ceramiccolumnSddarray)陶瓷柱栅阵列
CCGA是CBGA的改进型。CCGA结构的三种类型如图4所示。二者的区别在于:CCGA采用直径为0.5mm、高度为1.25mm~2.2mm的焊料柱替代CBGA中的0.87mm直径的焊料球,以提高其焊点的抗疲劳能力。因此柱状结构更能缓解由热失配引起的陶瓷载体和PCB板之间的剪切应力。
图4 CCGA结构的三种类型
非常好我支持^.^
(0) 0%
不好我反对
(0) 0%
相关阅读:
( 发表人:admin )
