主板MOSFET的封装技术图解大全
主板MOSFET的封装技术图解大全
主板的供电一直是厂商和用户关注的焦点,视线从供电相数开始向MOSFET器件转移。这是因为随着MOSFET技术的进展,大电流、小封装、低功耗的单芯片MOSFET以及多芯片DrMOS开始用在主板上,新的功率器件吸引了主板用户的眼球。本文将对主板采用的MOSFET器件的封装规格和封装技术作简要介绍。
MOSFET芯片制作完成后,需要封装才可以使用。所谓封装就是给MOSFET芯片加一个外壳,这个外壳具有支撑、保护、冷却的作用,同时还为芯片提供电气连接和隔离,以便MOSFET器件与其它元件构成完整的电路。
芯片的材料、工艺是MOSFET性能品质的决定性因素,MOSFET厂商自然注重芯片内核结构、密度以及工艺的改进,以提高MOSFET的性能。这些技术改进将付出很高的成本。
封装技术也直接影响到芯片的性能和品质,对同样的芯片以不同形式的封装,也能提高芯片的性能。所以芯片的封装技术是非常重要的。
以安装在PCB的方式区分,功率MOSFET的封装形式有插入式(Through Hole)和表面贴装式(Surface Mount)二大类。插入式就是MOSFET的管脚穿过PCB的安装孔焊接在PCB上。表面贴裝则是MOSFET的管脚及散热法兰焊接在PCB表面的焊盘上。
常见的直插式封装如双列直插式封装(DIP),晶体管外形封装(TO),插针网格阵列封装(PGA)等。
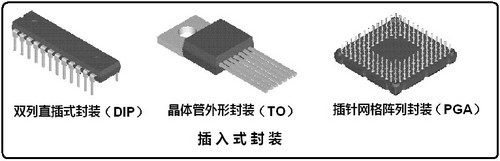
典型的表面贴装式如晶体管外形封装(D-PAK),小外形晶体管封装(SOT),小外形封装(SOP),方形扁平封装(QFP),塑封有引线芯片载体(PLCC)等等。
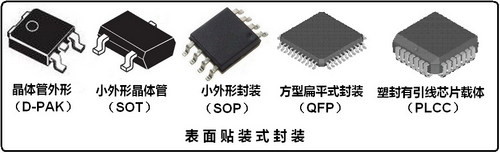
电脑主机板一般不采用直插式封装的MOSFET,本文不讨论直插式封装的MOSFET。
一般来说,“芯片封装”有2层含义,一个是封装外形规格,一个是封装技术。对于封装外形规格来说,国际上有芯片封装标准,规定了统一的封装形状和尺寸。封装技术是芯片厂商采用的封装材料和技术工艺,各芯片厂商都有各自的技术,并为自己的技术注册商标名称,所以有些封装技术的商标名称不同,但其技术形式基本相同。我们先从标准的封装外形规格说起。
一、标准封装规格
1、TO封装
TO(Transistor Out-line)的中文意思是“晶体管外形”。这是早期的封装规格,例如TO-92,TO-92L,TO-220,TO-252等等都是插入式封装设计。近年来表面贴装市场需求量增大,TO封装也进展到表面贴装式封装。

TO252和TO263就是表面贴装封装。其中TO-252又称之为D-PAK,TO-263又称之为D2PAK。
D-PAK封装的MOSFET有3个电极,栅极(G)、漏极(D)、源极(S)。其中漏极(D)的引脚被剪断不用,而是使用背面的散热板作漏极(D),直接焊接在PCB上,一方面用于输出大电流,一方面通过PCB散热。所以PCB的D-PAK焊盘有三处,漏极(D)焊盘较大。
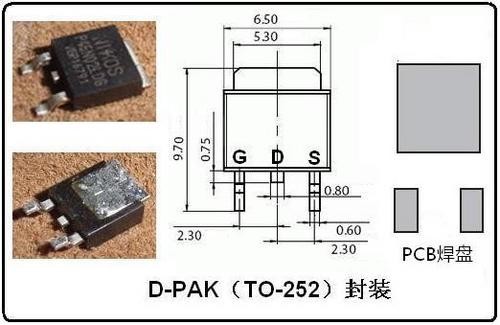
2、SOT封装
SOT(Small Out-Line Transistor)小外形晶体管封装。这种封装就是贴片型小功率晶体管封装,比TO封装体积小,一般用于小功率MOSFET。常见的规格有:
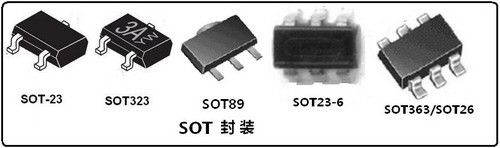
主板上常用四端引脚的SOT-89 MOSFET。
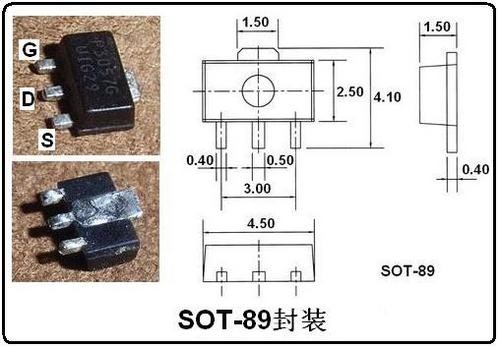
3、SOP封装
SOP(Small Out-Line Package)的中文意思是“小外形封装”。SOP是表面贴装型封装之一,引脚从封装两侧引出呈海鸥翼状(L 字形)。材料有塑料和陶瓷两种。SOP也叫SOL 和DFP。SOP封装标准有SOP-8、SOP-16、SOP-20、SOP-28等等,SOP后面的数字表示引脚数。MOSFET的SOP封装多数采用SOP-8规格,业界往往把“P”省略,叫SO(Small Out-Line )。

SO-8采用塑料封装,没有散热底板,散热不良,一般用于小功率MOSFET。
SO-8是PHILIP公司首先开发的,以后逐渐派生出TSOP(薄小外形封装)、VSOP(甚小外形封装)、 SSOP(缩小型SOP)、TSSOP(薄的缩小型SOP)等标准规格。
这些派生的几种封装规格中,TSOP和TSSOP常用于MOSFET封装。

5、QFN-56封装
QFN(Quad Flat Non-leaded package)是表面贴装型封装之一,中文叫做四边无引线扁平封装,是一种焊盘尺寸小、体积小、以塑料作为密封材料的新兴表面贴装芯片封装技术。现在多称为LCC。QFN是日本电子机械工业会规定的名称。封装四边配置有电极接点,由于无引线,贴装占有面积比QFP小,高度比QFP低。这种封装也称为LCC、PCLC、P-LCC等。QFN本来用于集成电路的封装,MOSFET不会采用的。Intel提出的整合驱动与MOSFET的DrMOS采用QFN-56封装,56是指在芯片背面有56个连接Pin。
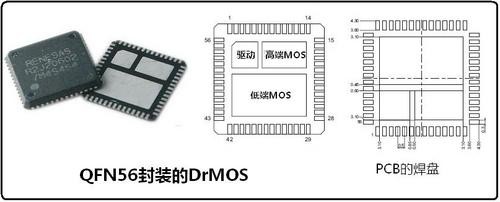
二、最新封装形式
由于CPU的低电压、大电流的发展趋势,对MOSFET提出输出电流大,导通电阻低,发热量低散热快,体积小的要求。MOSFET厂商除了改进芯片生产技术和工艺外,也不断改进封装技术,在与标准外形规格兼容的基础上,提出新的封装外形,并为自己研发的新封装注册商标名称。
下面分别介绍主要MOSFET厂商最新的封装形式。
1、瑞萨(RENESAS)的WPAK、LFPAK和LFPAK-I 封装
WPAK是瑞萨开发的一种高热辐射封装,通过仿D-PAK封装那样把芯片散热板焊接在主板上,通过主板散热,使小形封装的WPAK也可以达到D-PAK的输出电流。WPAK-D2封装了高/低2颗MOSFET,减小布线电感。
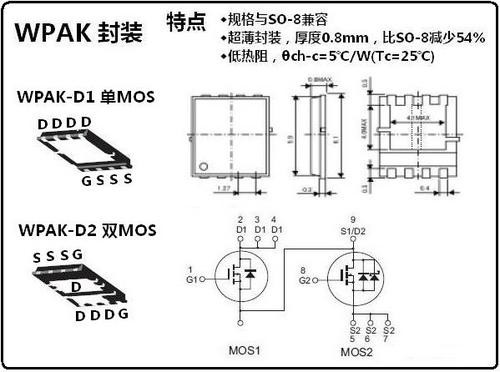
LFPAK和LFPAK-I是瑞萨开发的另外2种与SO-8兼容的小形封装。LFPAK类似D-PAK比D-PAK体积小。LFPAK-i是将散热板向上,通过散热片散热。
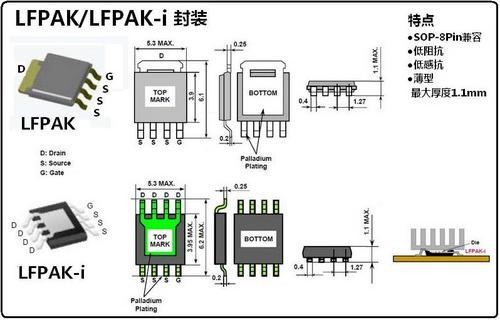
2、威世(Vishay)的Power-PAK和Polar-PAK封装
Power-PAK是威世公司注册的MOSFET封装名称。Power-PAK包括有Power-PAK1212-8、Power-PAK SO-8两种规格。Polar PAK是双面散热的小形封装。
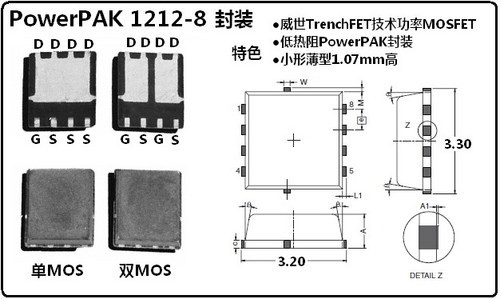
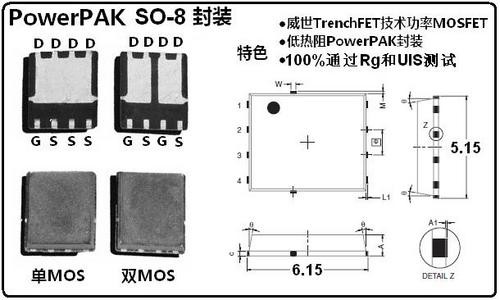
3、安森美(Onsemi)的SO-8和WDFN8扁平引脚( Flat Lead)封装
安美森半导体开发了2种扁平引脚的MOSFET,其中SO-8兼容的扁平引脚被很多主板采用。
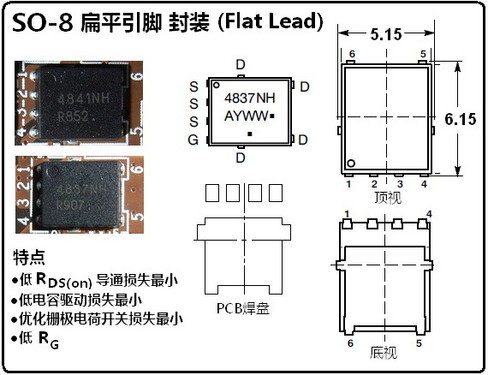
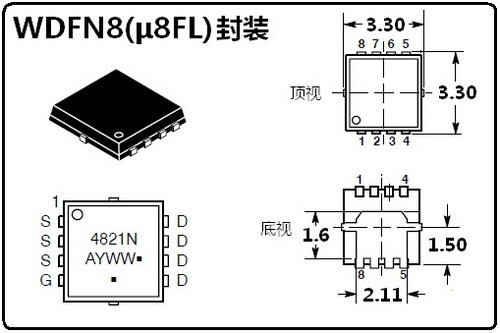
4、菲利普(Philps)的LFPAK和QLPAK封装
首先开发SO-8的菲利普也有改进SO-8的新封装技术,就是LFPAK和QLPAK。


5、意法(ST)半导体的PowerSO-8封装
法意半导体的SO-8改进技术叫做Power SO-8。

6、飞兆(Fairchild)半导体的Power 56封装
飞兆半导体的SO-8改进技术叫做Power 56。
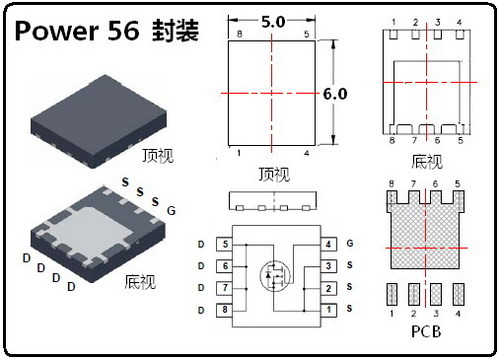
6、国际整流器(IR)的Direct FET封装
Direct FET封装属于反装型的,漏极(D)的散热板朝上,并覆盖金属外壳,通过金属外壳散热。
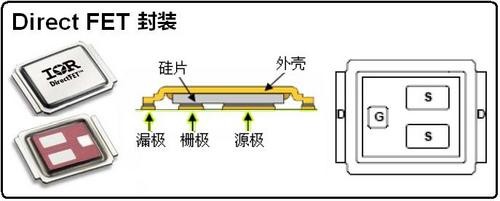
三、内部封装技术
前面介绍的最新封装形式都是MOSFET的外部封装。这些最新封装还包括内部封装技术的改进,尽管这些新封装技术的商标名称多种多样,其内部封装技术改进主要有三方面:一是改进封装内部的互连技术,二是增加漏极散热板,三是改变散热的热传导方向。
1、封装内部的互连技术
早期的标准封装,包括TO,D-PAK、SOT、SOP,多采用焊线式的内部互连,在CPU核心电压较高,电流较小时期,这种封装可以满足需求。当CPU供电进展到低电压、大电流时代,焊线式封装就难以满足了。以标准焊线式SO-8为例,作为小功率MOSFET封装,发热量很小,对芯片的散热设计没有特别要求。主板的局部小功率供电(风扇调速)多采用这种SO-8的MOSFET。但用于现代的CPU供电就不能胜任了。这是由于焊线式SO-8的性能受到封装电阻、封装电感、PN结到PCB和外壳的热阻等四个因素的限制。
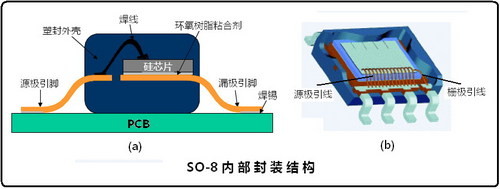
封装电阻
MOSFET在导通时存在电阻(RDS(on)),这个电阻包括芯片内PN结电阻和焊线电阻,其中焊线电阻占50%。RDS(on)是影响MOSFET性能的重要因素。
封装电感
内部焊线的引线框封装的栅极、源极和漏极连接处会引入寄生电感。源极电感在电路中将会以共源电感形式出现,对MOSFET的开关速度有着重大影响。
芯片PN结到PCB的热阻
芯片的漏极粘合在引线框上,引线框被塑封壳包围,塑料是热的不良导体。漏极的热传导路径是芯片→引线框→引脚→PCB,这么长的路径必然是高热阻。至于源极的热传导还要经过焊线到PCB,热阻更高。
芯片PN结到外壳(封装顶部)的热阻
由于标准的SO-8采用塑料包封,芯片到封装顶部的传热路径很差。
上述四种限制对其电学和热学性能有着极大的影响。随着电流密度要求的提高,MOSFET厂商采用SO-8的尺寸规格,同时对焊线互连形式进行改进,用金属带、或金属夹板代替焊线,降低封装电阻、电感和热阻。
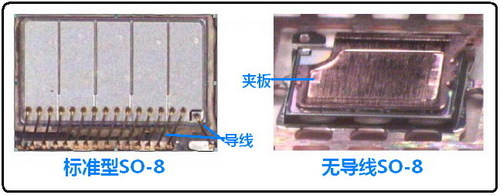
国际整流器(IR)称之为Copper Strap技术,威世(Vishay)称之为Power Connect 技术,还有称之为Wireless Package。
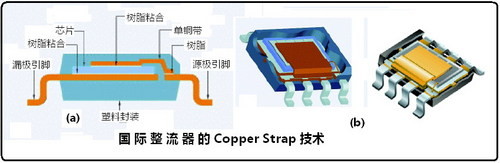
据国际半导体报道,用铜带取代焊线后,热阻降低了10-20%,源极至封装的电阻降低了61%。特别一提的是用铜带替换14根2-mil金线,芯片源极电阻从1.1 m降到 0.11 m。
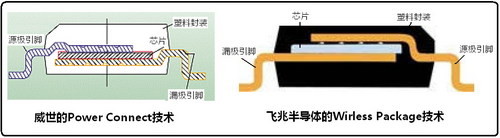
2、漏极散热板
标准SO-8封装采用塑料把芯片全部包围,低热阻的热传导通路只是芯片到PCB的引脚。底部紧贴PCB的是塑料外壳。塑料是热的不良导体,影响漏极的散热。封装的散热改进自然是除去引线框下方的塑封混合物,让引线框金属结构直接(或者加一层金属板)与PCB接触,并焊接到PCB焊盘上。它提供了大得多的接触面积,把热量从芯片上导走。这种结构还有一个附带的好处,即可以制成更薄的器件,因为塑封材料的消除降低了其厚度。
威世的Power-PAK,法意半导体的Power SO-8,安美森半导体的SO-8 Flat Lead,瑞萨的WPAK、LFPAK,飞兆半导体的Power 56和Bottomless Package都采用这种散热技术。
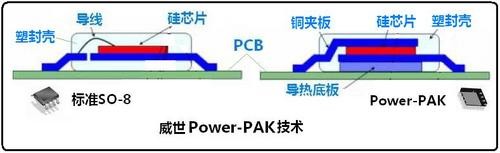
3、改变散热的热传导方向
Power-PAK封装显著减小了芯片到PCB的热阻,实现芯片到PCB的高效率传热。不过,当电流的需求继续增大时,PCB也将出现热饱和,因此散热技术的进一步改进是改变散热方向,让芯片的热量传导到散热器而不是PCB。
瑞萨的LFPAK-I 封装,国际整流器的Direct FET封装就是这种散热技术。
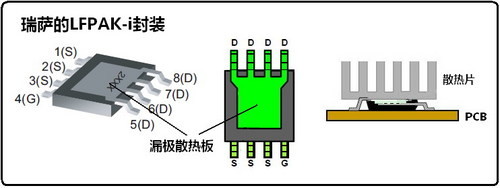
四、整合驱动IC的DrMOS
传统的主板供电电路采用分立式的DC/DC降压开关电源,分立式方案无法满足对更高功率密度的要求,也不能解决较高开关频率下的寄生参数影响问题。随着封装、硅技术和集成技术的进步,把驱动器和MOSFET整合在一起,构建多芯片模块(MCM)已经成为现实。。与分立式方案相比,多芯片模块可以节省相当可观的空间并提高功率密度,通过对驱动器和MOSFET的优化提高电能转换效率以及优质的DC电流。这就是称之为DrMOS的新一代供电器件。
DrMOS的主要特点是:
- 采用QFN56无脚封装,热阻抗很低。
- 采用内部引线键合以及铜夹带设计,尽量减少外部PCB布线,从而降低电感和电阻。
- 采用先进的深沟道硅(trench silicon)MOSFET工艺,显著降低传导、开关和栅极电荷损耗。
- 兼容多种控制器,可实现不同的工作模式,支持APS(Auto Phase Switching)。
- 针对目标应用进行设计的高度优化。
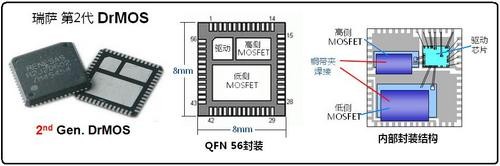
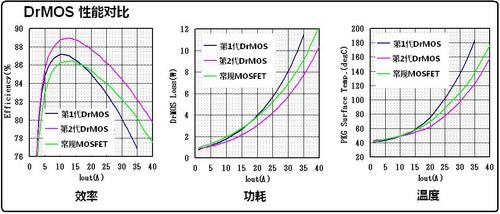
五、MOSFET发展趋势
伴随计算机技术发展对MOSFET的要求,MOSFET封装技术的发展趋势是性能方面高输出、高密度、高频率、高效率,体积方面是更趋向小形化。
下图是瑞萨提供的低压MOSFET封装发展趋势图。
非常好我支持^.^
(67) 100%
不好我反对
(0) 0%
相关阅读:
- [电子说] 国星光电SiC-MOSFET器件获得AEC-Q101车规级认证 2023-10-24
- [电子说] IGBT/FRD/MOSFET功率器件模块材料介绍 2023-10-24
- [电子说] 不同功率的充电桩设计方案总结 2023-10-24
- [电子说] 攻克汽车热管理挑战,安森美Top Cool MOSFET荣获“金辑奖2023中国汽车新供应链百 2023-10-24
- [模拟技术] 龙腾半导体MOSFET在便携储能上的应用 2023-10-23
- [电子说] 飞腾D2000国产核心板:引领传统产业数字化改造,激发无限潜能 2023-10-23
- [电子说] 安森德超结(SJ)MOSFET在LED光源中的应用 2023-10-23
- [电子说] MOSFET栅极电路电压对电流的影响?MOSFET栅极电路电阻的作用? 2023-10-22
( 发表人:admin )
