半导体封装技术及其应用知识
半导体封装技术及其应用知识
1 引言
半导体技术的进步大大提高了芯片晶体管数量和功能,这一集成规模在几年前是无法想象的。因此,如果没有IC封装技术快速的发展,不可能实现便携式电子产品的设计。在消费类产品小型化和更轻、更薄发展趋势的推动下,制造商开发出更小的封装类型。最小的封装当然是芯片本身,图1描述了IC从晶片到单个芯片的实现过程,图2为一个实际的晶片级封装(CSP)。
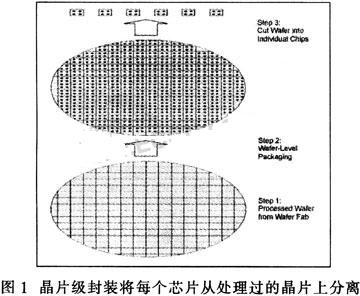
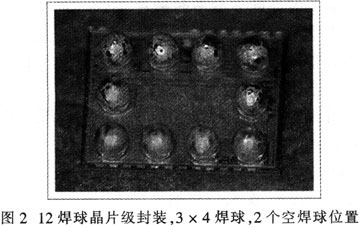
晶片级封装的概念起源于1990年,在1998年定义的CSP分类中。晶片级CSP是多种应用的一种低成本选择,这些应用包括EEPROM等引脚数量较少的器件,以及ASIC和微处理器。CSP采用晶片级封装(WLP)工艺加工,WLP的主要优点是所有装配和测试都在晶片上进行。随着晶片尺寸的增大、管芯的缩小,WLP的成本不断降低。作为最早采用该技术的公司,Dallas Semiconductor在1999年便开始销售晶片级封装产品。
2 命名规则
对于Maxim/Dallas Semiconductor,"倒装芯片"和"晶片级封装",最初是所有晶片级封装的同义词。过去几年中,封装也有了进一步地细分。在本文以及所有Maxim资料中,包括公司网站,"倒装芯片"是指焊球具有任意形状、可以放在任何位置的晶片级封装管芯(边沿有空隙)。"晶片级封装"是指在间隔规定好的栅格上有焊球的晶片级封装管芯。图3解释了这些区别,值得注意的是,并不是所有栅格位置都要有焊球。图3中的倒装芯片尺寸反映了第一代Dallas Semiconductor的WLP产品:晶片级封装尺寸来自各个供应商,包括Maxim。目前,Maxim和Dallas Semiconductor推出的新型晶片级封装产品的标称尺寸如表1所列。
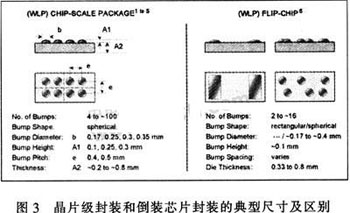
3 晶片级封装(WLP)技术
提供WLP器件的供应商要么拥有自己的WLP生产线,要么外包封装工艺。各种各样的生产工艺必须能够满足用户的要求。确保最终产品的可靠性。美国亚利桑那州凤凰城的FCI、美国北卡罗莱纳州的Unitive建立了WLP技术标准,产品名为UltraCSP(FCI)和Xtreme(Unitive)。Amkor在并购Umitive后,为全世界半导体行业提供WLP服务。
在电路/配线板上,将芯片和走线连接在一起的焊球最初采用锡铅共晶合金(Sn63Pb37)。为了减少电子产品中的有害物质(RoHS),半导体行业不得不采用替代材料,例如无铅焊球(Sn96.5Ag3Cu0.5)或者高铅焊球(Pb95Sn5)。每种合金都有其熔点,因此,在元器件组装回流焊工艺中,温度曲线比较特殊,在特定温度上需保持一段时间。
集成电路的目的在于提供系统所需的全部电子功能,并能够装配到特定封装中。芯片上的键合焊盘通过线键合连接至普通封装的引脚上。普通封装的设计原则要求键合焊盘位于芯片周界上。为避免同一芯片出现两种设计(一种是普通封装,另一种是CSP),需要重新分配层连接焊球和键合焊盘。
4 晶片级封装器件的可靠性
晶片级封装(倒装芯片和UCSP)代表一种独特的封装外形,不同于利用传统的机械可靠性测试的封装产品。封装的可靠性主要与用户的装配方法、电路板材料以及其使用环境有关。用户在考虑使用WLP型号之前,应认真考虑这些问题。首先必须进行工作寿命测试和抗潮湿性能测试,这些性能主要由晶片制造工艺决定。机械压力性能对WLP而言是比较大的问题,倒装芯片和UCSP直接焊接后,与用户的PCB连接,可以缓解封装产品铅结构的内部压力。因此,必须保证焊接触点的完整性。
5 结束语
目前的倒装芯片和CSP还属于新技术,处于发展阶段。正在研究改进的措施是将采用背面叠片覆层技术(BSL),保护管芯的无源侧,使其不受光和机械冲击的影响,同时提高激光标识在光照下的可读性。除了BSL,还具有更小的管芯厚度,保持装配总高度不变。Maxim UCSP尺寸(参见表1)说明了2007年2月产品的封装状况。依照业界一般的发展趋势,这些尺寸有可能进一步减小。因此,在完成电路布局之前,应该从各自的封装外形上确定设计的封装尺寸。
此外,了解焊球管芯WLP合金的组成也很重要,特别是器件没有声明或标记为无铅产品时。带有高铅焊球(Pb95S
非常好我支持^.^
(7) 100%
不好我反对
(0) 0%
相关阅读:
- [电子说] 金川兰新电子半导体封装新材料生产线项目主体封顶 2023-10-24
- [电子说] 国产车规级芯片发展现状、问题及建议 2023-10-21
- [电子说] 半导体封装工艺的四个等级 2023-10-09
- [制造/封装] 深度探讨2.5D/3D封装发展历程 2023-10-08
- [电子说] 半导体封装的功能和范围 2023-09-28
- [电子说] 深入解析集成电路的基本结构与分类 2023-09-27
- [电子说] 电子元器件如何做到高性能不掉链子 2023-09-26
- [电子说] 半导体制造背后的艺术:从硅块到芯片的旅程 2023-09-22
( 发表人:admin )
